МИКРОСТРУКТУРНЫЕ ИССЛЕДОВАНИЯ СПЛАВОВ СИСТЕМЫ CuInSe2-CuSbSe2
(реферат)
Введение
В современной фотоэлектронной энергетике особое значение придается поиску новых полупроводниковых соединений, которые дали бы возможность заменить монокристаллические кремниевые элементы. Одним из классов этих материалов являются соединения I-III-VI2, где I-Cu, Ag; III-Al, Ga, In; VI - S, Se, Te. Соединение со структурой халькопирита CuInSe2 принадлежит к этой группе и активно исследуется как материал для солнечных элементов в тонкопленочном исполнении, причем к настоящему времени для таких солнечных элементов достигнут кпд 18,8% [1]. Вместе с тем, для дальнейшего улучшения параметров устройств на основе многокомпонентных материалов необходима разработка способов изменения их свойств, в частности, с помощью контролируемого легирования или получения сплавов на их основе. В связи с этим важным является знание пределов растворимости, а в общем случае, фазовых диаграмм состояния таких систем.
Целью настоящей работы являлось изучение сплавов полупроводниковой системы CuInSe2-CuSbSe2 с помощью рентгенофазового анализа (РФА) и микроструктурных исследований.
Было получено 11 сплавов полупроводниковой системы (CuInSe2) x- (CuSbSe2) 1-x с x = 0, 0.05, 0.15, 0.25, 0.375, 0.50, 0.625, 0.75, 0.85, 0.95 и 1, где x - молярная доля CuInSe2. Для получения сплавов применяли непосредственное сплавление взятых в соответствующем соотношении элементов. Использовали компоненты марок B3 (медь), Ин000 (индий), “Экстра" (сурьма) и осч 17-4 (селен). Исходные компоненты общей массой 10 г загружали в кварцевые ампулы, которые вакуумировали до остаточного давления »1,3×10-5 гПа и запаивали. Осуществление синтеза проводили в печи сопротивления, первоначально производили нагрев со скоростью 3 К/мин до температур на 30-50 K, превышающих температуры плавления соответствующих сплавов, после чего осуществляли изотермическую выдержку в течение 2 ч. По завершении этой процедуры проводили охлаждение до комнатной температуры со скоростью 3-5 К/мин. Изотермический отжиг был проведен при 683 К в течение 550 ч.
Исследование микроструктуры проводили в отраженном свете на металлографическом микроскопе МИМ-7 с использованием цифровой камеры, а также с помощью электронно-зондового анализа. Микроструктуру изучали непосредственно после полировки и промывки микрошлифов.
На основании РФА было определено, что все полученные сплавы, за исключением исходных тройных соединений CuInSe2 и CuSbSe2, являются двухфазными, на основании чего можно сделать вывод, что взаимная растворимость соединений CuInSe2 и CuSbSe2 не превышает 0.05 мол. доли. Параметры решетки составили для a и c, соответственно, 5.782 и 11.62 Å (CuInSe2), для a, b и c, соответственно, 6.303, 3.976 и 15.008 Å (CuSbSe2).
Микроструктурные исследования сплавов (CuSbSe2) x- (CuInSe2) 1-x подтвердили, что все полученные сплавы с x = 0.05, 0.15, 0.25, 0.375.0.50, 0.625.0.75, 0.85 и 0.95, являются двухфазными (Рис.1). Выделяющиеся сначала первичные кристаллы на основе CuInSe2 растут свободно в жидкости и до тех пор, пока не срастаются друг с другом и имеют правильные кристаллические формы (Рис.1а). Правильность кристаллических форм для исследуемой системы проявляется в образовании разветвленных дендритов. В тех случаях, когда происходит сечение дендрита плоскостью шлифа, обнаруживаются правильные ряды овальных или граненых зерен. При еще большем возрастании концентрации более высокотемпературного компонента CuInSe2 происходит увеличение размеров и срастание дендритов, хотя, тем не менее, они по-прежнему проявляются (Рис.1б, 1в). При дальнейшем росте концентрации фазы на основе CuInSe2 осуществляется срастание зерен, а закристаллизовавшаяся жидкость на основе CuSbSe2 проявляется в виде прожилок более светлого цвета (Рис.1г).
|
|
|
| а | б |
|
|
|
| в | г |
| Рис.1. Микроструктура сплавов (CuInSe2) x- (CuSbSe2) 1-x для x = 0.15 (а), x = 0.50 (б), x = 0.75 (в) и x = 0.95 мол. доли CuInSe2 (г) | |
Процессы перемагничивания, межкристал-литное магнитное взаимодействие, представляющие значительный практический и научный интерес, в основном были изучены на пленках, полученных конденсацией в вакууме [1-3]. Значительно меньше изучены процессы перемагничивания в электрохимических пленках, имеющих существенные отличия в характере структуры [4].
В настоящей работе исследована взаимосвязь структурных характеристик с межкристаллитным магнитным взаимодействием и процессами перемагничивания в "сплошных" пленках сплавов Co-W и Со - содержащих металоксидных наноструктурах на поверхности алюминия [4,5].
В случае перемагничивания образцов, состоящих из изолированных кристаллитов, некогерентным вращением угловая зависимость коэрцитивной силы описывается формулой [6].
 (1)
(1)
где ![]() - приведенный радиус,
- приведенный радиус, ![]() -радиус частицы;
-радиус частицы; ![]() =A 1/2/ Ms - характеристический радиус, определяемый энергией обменного взаимодействия и намагниченностью насыщения.
=A 1/2/ Ms - характеристический радиус, определяемый энергией обменного взаимодействия и намагниченностью насыщения.
Дополнительную информацию о процессах перемагничивания пленок можно получить из анализа зависимости потерь на гистерезис от угла перемагничивания [3]:
Wh= ò MdH (2)
Тип магнитного взаимодействия между кристаллитами можно определить, в частности, по результатам измерения кривых ![]() [2], определяемых как:
[2], определяемых как:
dМ (Н) =Id (H) - (Iµ - 2Ir (H) (3)
где I¥-остаточная намагниченность после выключения насыщающего поля, Id (H) и![]() - также остаточные намагниченности после выключения поля Н, но в первом случае прикладывается отрицательное поле к образцу в состоянии I¥, а во втором - положительное поле к размагниченному образцу.
- также остаточные намагниченности после выключения поля Н, но в первом случае прикладывается отрицательное поле к образцу в состоянии I¥, а во втором - положительное поле к размагниченному образцу.
Измерения на Со-содержащих АОП, состоящих из отдельных кристаллитов (игольчатых частиц), пространственно изолированных друг от друга, подтверждают вывод о том, что покрытие в этом случае можно рассматривать как ансамбль изолированных однодоменных частиц: dM (H) »0, угловые зависимости коэрцитивной силы на начальном участке хорошо совпадают с расчетными [7]. Если же учесть конечные размеры частиц (в расчетах [6] рассматриваются бесконечно длинные цилиндры) и дисперсию осей легкого намагничивания и поля анизотропии, то можно получить более полное совпадение (такая коррекция проведена для одноосных пленок кобаль-хром с параметрами, близкими к параметрам исследованных нами пленок [8]). Отметим, что влияние отжига на характер зависимости Нс (j) можно сравнить с эффектом уменьшения плотности упаковки игольчатых частиц и может быть обусловлено совершенствованием их кристаллической структуры и увеличением их магнитного разделения за счет связывания избыточного кислорода, входящего в состав оксидной пленки преимущественно по границам ячеек.
Структуры кремний-на-изоляторе (КНИ) являются перспективным материалом для разработки новых микроэлектронных изделий с улучшенными характеристиками. В настоящее время на рынке уже имеется более десятка фирм, поставляющих КНИ структуры различного диаметра по цене от 55 до 900 долларов. Наибольшее распространение для производства КМОП БИС получили КНИ структуры SIMOX (имплантация кислорода в кремний), Smart Cut и Dele Cut (имплантация водорода и термокомпрессионное сплавление пластин), а также структуры КНС, получаемые эпитаксией кремния на сапфировых подложках. В Беларуси исследования по КНИ технологии ведутся по двум направлениям: разработка собственной технологии изготовления КНИ структур, удовлетворяющих требованиям современной микроэлектроники, и разработка элементной базы КНИ КМОП БИС. Одним из главных вопросов, который необходимо решить НПО “Интеграл”, является вопрос о том, какую технологию взять за основу для разработки собственной технологии производства КНИ структур [1].
В результате работы представлены результаты сравнительных исследований КМОП БИС СОЗУ 8К, изготовленных в различных КНИ структурах и в структурах КНС, с целью оценки их пригодности для изготовления современных БИС в условиях производства НПО “Интеграл".
Для проведения исследований использовались КНИ структуры, изготовленные по технологиям SIMOX, Smart-Cut, Dele-Cut и КНС. КНИ структуры были подобраны с одинаковой толщиной пленки кремния 0.23-0.29 мкм и толщиной изолирующего окисла 0.28-0.4 мкм и проведены по цеху серийного производства НПО “Интеграл" в составе одной партии пластин.
Для исследований была разработана специализированная тестовая матрица, содержащая набор тестовых элементов для контроля электрических параметров элементной базы КМОП БИС, контроля и оптимизации технологии их изготовления. В состав тестовой матрицы были включены две КМОП БИС статического оперативного запоминающего устройства емкостью 8К c организацией 1024х8 бит на базе 6-ти и 10-ти транзисторных ячеек памяти. Эти БИС были разработаны с проектными нормами 1,2 мкм под существующий на НПО “Интеграл" серийный КМОП процесс с одним уровнем поликристаллического кремния и двумя уровнями металлизации.
На всех образцах структур КНИ и КНС получены МОП транзисторы с широким набором размеров длин каналов и ширин транзисторов. Важно отметить, что такие параметры единичных МОП транзисторов как пороговое напряжение, напряжение пробоя исток-сток, ток стока практически не зависели от типа использованных КНИ структур, а определялись уровнями легирования карманов и приповерхностной области пленки кремния под затвором. В то же время, начальные участки и наклон допороговых характеристик сильно зависели от типа использованных КНИ структур. Лучшие результаты показали КНИ структуры Smart Cut, SIMOX и КНС. На КНИ структурах Dele Cut были получены МОП транзисторы с удовлетворительными характеристиками, но со значительным разбросом параметров по поверхности пластин.
С целью исследования уровня стойкости и характера изменения параметров проводились сравнительные радиационные испытания КМОП БИС СОЗУ 8К, изготовленных в КНИ и КНС структурах. В образцах, изготовленных в КНИ структурах, имелась возможность реализации двух вариантов подключения подложки - к шине с нулевым потенциалом и к шине, соединенной с источником питания. Радиационные испытания включали оценку стойкости БИС к импульсному воздействию и полной дозе с использованием лазерного и рентгеновского имитаторов. Максимальный эквивалентный уровень импульсного воздействия составил 2,5∙1012 условн. ед/с, эквивалентная мощность дозы рентгеновского излучения - 174 условн. ед/с. В процессе испытаний контролировалось наличие тиристорного эффекта и катастрофичеcких отказов, контроль функционирования (отсутствие сбоев и отказов), сохранность записанной информации (совпадение считанной и записанной информации), величины токов потребления. При функциональном контроле применялись алгоритмические тесты типа “запись-считывание": “поле 0”, “поле 1", “шахматы”, “инверсные шахматы”, “псевдослучайный код ”.
Прежде всего, отметим, что различий в радиационной стойкости образцов КМОП СОЗУ 8К, изготовленных в Smart Cut и SIMOX КНИ структурах, не установлено. Катастрофических отказов и тиристорного эффекта во всех исследованных образцах не обнаружено до уровня импульсного воздействия 2,5·1012 условн. ед/с. Уровень сохранности информации (УСИ) для образцов БИС СОЗУ на 10-ти транзисторных ячейках памяти на КНИ структурах составил 3,9·1011 условн. ед/с, что более чем в три раза больше УСИ для образцов на КНС структурах (1,2·1011 условн. ед/с). При увеличении уровня воздействия более УСИ количество ошибок в СОЗУ на 6-ти транзисторных ячейках резко увеличивалось от нуля до нескольких сотен ошибок, в отличие от СОЗУ на 10-ти транзисторных ячейках памяти, для которых количество ошибок возрастало от нуля до нескольких десятков ошибок. Механизм возникновения сбоев информации в СОЗУ на 6-ти транзисторных ячейках памяти предположительно связан со сбоями самих ячеек памяти, а в СОЗУ на 10-ти транзисторных ячейках памяти - с взаимовлиянием ячеек памяти. УСИ КНИ БИС на 6-ти транзисторных ячейках памяти составлял 1,2·1011 условн. ед/с. Уровень сохранности информации и характер изменения импульсной реакции тока потребления образцов на КНИ структурах не зависят от способа подключения подложки к нулевому потенциалу или к потенциалу источника питания.
Импульсная реакция тока потребления зависит от варианта выполнения КМОП СОЗУ. При уровнях воздействия до 1∙1011 условн. ед/с характер изменения импульсной реакции тока потребления КНС СОЗУ совпадает с характером изменения импульсной реакции тока потребления КНИ СОЗУ на 6-ти транзисторных ячейках памяти при подключении подложки к нулевому потенциалу. При уровнях воздействия от 1,2∙1011 до 7∙1011 условн. ед/с характеры изменения импульсной реакции тока потребления в КНС и КНИ СОЗУ на 6-ти транзисторных ячейках памяти совпадают и не зависят от способа подключения подложки. При уровнях воздействия от 7∙1011 условн. ед/с до максимально достигнутого 2,5∙1012 условн. ед/с характер изменения импульсной реакции тока потребления не зависит от способа подключения подложки, а средние значение амплитуд откликов импульсной реакции тока потребления КНС СОЗУ и КНИ СОЗУ на 10-ти транзисторных ячейках памяти составляли, соответственно, 865 мА и 850 мА, а для КНИ СОЗУ на 6-ти транзисторных ячейках памяти - 910 мА.
В результате исследований по влиянию полной дозы облучения установлено, что уровень отказа по функционированию (по способности записи и считывания информационного кода) составил 2∙104 условн. ед. для КНИ СОЗУ при подключении подложки к потенциалу питания для 6-ти и 10-ти транзисторных и 6∙104 условн. ед. для КНС и КНИ при подключении к нулевому потенциалу. Ток потребления КМОП БИС СОЗУ 8К в режиме хранения до уровня функционального отказа зависит от варианта реализации исследованных образцов БИС (КНИ или КНС структуры), от способа подключения подложек и от варианта реализации ячеек памяти.
Относительно причины повышенной стойкости к импульсному воздействию БИС на КНИ структурах по сравнению с КНС структурами мы полагаем, что это связано в основном с одним фактором, который принципиально отличает КНИ и КНС структуры - возможностью подключения подложки КНИ структур к нулевому потенциалу. Этот фактор оказывает существенное влияние на процессы накопления заряда в захороненном окисле КНИ структур.
Представленные в данной работе результаты свидетельствуют о том, что в настоящее время только КНИ структуры Smart Cut и SIMOX пригодны для производства современных КМОП БИС благодаря высокому структурному совершенству пленки кремния. Изготовленные в КНИ структурах Smart Cut и SIMOX образцы КМОП БИС СОЗУ 8К продемонстрировали более высокую радиационную стойкость по сравнению с образцами, изготовленными на КНС структурах. Получить данные о радиационной стойкости Dele Cut КНИ структур не удалось, поскольку не были получены годные образцы БИС.
Разработанные на НПО “Интеграл" конструкции КМОП БИС СОЗУ 8К и технология их изготовления в КНИ структурах позволяет получать годные образцы БИС. Очевидно, что для повышения стойкости к полной дозе облучения, выбранная комбинация технологических режимов формирования как самих КНИ структур, так и МОП транзисторов в КНИ структурах, не является достаточной и требует дальнейшей оптимизации. В заключение отметим, что представляется принципиально важной активизация и проведение дальнейших исследований по разработке отечественных технологий изготовления КНИ структур, поскольку массовое производство микроэлектронных изделий возможно только на основе постановки серийного производства КНИ структур по собственной отечественной технологии. При проведении этих работ НПО “Интеграл “ будет ориентироваться на Smart Cut технологию формирования КНИ структур, основанную на имплантации водорода и термокомпрессионного сплавления. Эта технология в отличие от технологии SIMOX, обеспечивает не только требуемый низкий уровень дефектности пленок кремния КНИ структур, но и более широкие возможности в управлении параметрами захороненного слоя двуокиси кремния. Это преимущество носит принципиальный характер, поскольку свойства захороненного окисла во время облучения во многом определяют стойкость КМОП БИС к радиационному воздействию. По нашему убеждению именно в этой возможности заложены резервы для повышения радиационной стойкости КМОП БИС в КНИ структурах.
Некогерентным вращением перемагничиваются также и пленки кобальт-вольфрам (25 вес.% W, табл), обладающие текстурой [001] ГПУ кобальта, столбчатой микроструктурой кристаллитов и перпендикулярной магнитной анизотропией (ПМА). Экспериментальная зависимость Нс (j) по крайней мере до углов 30-40о совпадает с расчетной, если принять S=1.30, однако при больших углах перемагничивания значительное расхождение экспериментальной и расчетной кривых указывает на существенный вклад иного механизма перемагничивания, а именно процессов смещения доменных границ [9].
Таблица
Условия получения, состав, отношение интенсивностей рентгеновских пиков I002/I100 и магнитные характеристики пленок Со-W (h=1 мкм)
| Параметр | Со-15 вес.%W | Со-25 вес.%W | ||||
| 1 | 2 | 3 | 4 | 5 * | 6 | |
| Т°С | 18 | 26 | 33 | 40 | 26 | 18 |
| I002/I100 | 25 | 10 | 15 | >50 ** | 11 | 28 |
| dMmax | 0,85 | 0,56 | 0,58 | 0,75 | 0,42 | 0,15 |
| S | 2,10 | 2,25 | _ | 2,15 | 2,49 | 1,3 |
* - горизонтальное осаждение; ** - II00/I002
Рассмотренные выше примеры показывают, что в пленках Со (АОП) и, в меньшей мере, в пленках Со-W (25 вес% W) c ПМА, осажденных при комнатной температуре (текстура [001]), процессы перемагничивания хорошо описываются моделью изолированных одноосных кристаллитов. Однако при снижении энергии магнитной одноосной анизотропии или росте намагниченности насыщения сильнее проявляется влияние магнитостатического взаимодействия. Такой случай реализуется в пленках Co-W с 15 вес% W, где несмотря на столбчатый тип структуры и текстуру [001], магнитный момент лежит в плоскости пленки. Это означает, что энергия размагничивающего поля превосходит магнитокристаллическую энергию, и поэтому представление о пленках, как об ансамбле невзаимодействующих частиц оказывается некорректным. Анализ экспериментальных результатов свидетельствует о наличии магнитостатического взаимодействия, поскольку в большинстве исследованных пленок dМ<0 (Табл).
Знак и величина dМ (Н) во многом определяются процессами перемагничивания реальных материалов (прежде всего преобладающим механизмом перемагничивания и величиной межкристаллитного взаимодействия), при этом сопоставление их изменения с изменением других магнитных характеристик (свойств) позволяет более детально исследовать процессы перемагничивания и тесно связанный с ними магнитный гистерезис. Так, анализ изменения |dМ|max и коэффициента прямоугольности петли гистерезиса образцов 1-4 (Табл) позволяет сделать вывод, что рост магнитостатического взаимодействия кристаллитов приводит к увеличению доли обратимых процессов при перемагничивании пленок Сo-W [7].
Представляет интерес сопоставление результатов исследования кривых dМ (Н) и кривых угловых зависимостей Нс, т. е исследования анизотропии магнитного гистерезиса. Так, анализ кривых Нс (j) образцов Co-15 вес.%W, полученных при различной геометрии осаждения, показывает возможность их аппроксимации кривыми, рассчитанными по модели закручивания (Рис), при этом образцу, полученному при вертикальном осаждении, соответствует кривая с меньшей величиной приведенного радиуса S, т.е. увеличение доли процессов вращения при перемагничивании. Различие в величине магнитостатического взаимодействия при перемагничивании данных образцов позволяет сделать вывод о том, что рост магнитостатического взаимодействия кристаллитов обуславливает увеличение доли процессов вращения при перемагничивании. Аналогичный вывод следует и из сопоставления результатов варьирования текстурой за счет изменения Т электролита (Табл).
Характер изменения потерь на гистерезис от угла перемагничивания Wh (j) исследованных пленок с различной структурой также указывает на изменение механизма их перемагничивания. Так, потери на гистерезис в пленках кобальт-вольфрам (25 вес.%W) со столбчатой структурой монотонно падают, но в диапазоне углов 40-90 о это падение заметно слабее: такое ход кривой можно объяснить усилением роли процессов смещения, доля которых возрастает в образцах с ориентацией оси "с" в плоскости пленок [3].
Выводы
В системе CuInSe2-CuSbSe2 для сплавов на основе соединения с более низкой температурой плавления (CuSbSe2) характерна кристаллизация в виде дендритов, что может быть объяснено высокой разностью температур плавления исходных тройных соединений. Установлено, что пределы растворимости тройных соединений с обеих сторон не превышают 0.05 мол. доли.
Литература
1. Moser A., Takano K., Margules D. et al. J. Phys. D.: Appl. Phys. 2002. V.35. P. R.157-167.
2. Mayo P. I.,O’Grady K., Chantrell R. W. et al. 1999. №2.С. .120-123
3. Lodder J. C.,Cheng-Zhang L. J. Magn. Magn. Mater. 1988. V74. P.74-86
4. Шадров В. Г, О¢Грэди К. ФТТ. 1997. Т.39. №5. С.894-897.
5. Шадров В.Г. и др. Металлы 1999№2. С.120-123
6. Shtrikman S.,Treves D. J. Phys. Rad. 1959. V20. P.286-289
7. Шадров.В. Г, Тагиров Р.И., Болтушкин А.В. ЖТФ 2002. Т.72. №4.36-40.
8. Nakamura J., Iwasaki S. IEEE Trans. Magn. 1987. V 23. P.153-157.
9. Ranjan R.,Gau J. S.,Amin N. J. Magn. Magn. Mater. 1990. V89. P.38-46
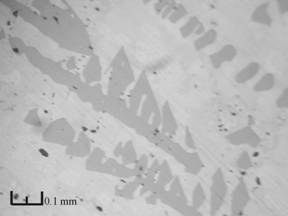

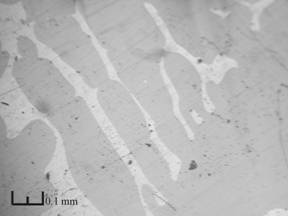

0 комментариев