Навигация
Министерство образования Российской Федерации
Марийский государственный технический университет
Кафедра конструирования и производства радиоаппаратуры
Вакуумное напыление
ПОЯСНИТЕЛЬНАЯ ЗАПИСКАк курсовой работе по дисциплине
Основы физики твёрдого тела и микроэлектроники
Разработал: студент группы ЭВС-31
Колесников
Консультировал: доцент
Игумнов В.Н
Йошкар-Ола 2003г.Содержание
Введение
1.Термическое вакуумное напыление
1.1 Резистивное напыление
1.2 Индукционное напыление
1.3 Электронно-лучевое напыление
1.4 Лазерное напыление
1.5 Электродуговое напыление
2. Распыление ионной бомбардировкой
2.1 Катодное распыление
2.2 Магнетронное распыление
2.3 Высокочастотное распыление.
2.4 Плазмоионное распыление в несамостоятельном газовом разряде
3. Технология тонких пленок на ориентирующих подложках
3.1 Механизмы эпитаксиального роста тонких пленок
3.2 Молекулярно-лучевая эпитаксия
Заключение
Литература
ВВЕДЕНИЕ
Тонкие пленки, наносимые в вакууме, широко применяются в производстве дискретных полупроводниковых приборов и интегральных микросхем (ИМС).
Получение высококачественных и воспроизводимых по электрофизическим параметрам тонкопленочных слоев является одним из важнейших технологических процессов формирования структур как дискретных диодов и транзисторов, так и активных и пассивных элементов ИМС.
Таким образом, от совершенства технологических процессов нанесения тонких пленок в значительной степени зависят надежность и качество изделий микроэлектроники, технический уровень и экономические показатели их производства.
Тонкопленочная технология базируется на сложных физико-химических процессах и применении различных металлов и диэлектриков. Так, тонкопленочные резисторы, электроды конденсаторов и межсоединения выполняют осаждением металлических пленок, а межслойную изоляцию и защитные покрытия – диэлектрических.
Важным этапом является контроль параметров тонких пленок (скорости их нанесения, толщины и ее равномерности, поверхностного сопротивления), который проводится с помощью специальных приборов, как при выполнении отдельных технологических операций, так и по завершении всего процесса.
Методы ионно-плазменного и магнетронного напыления находят широкое применение в современной микроэлектронике. Высокие скорости напыления и энергия падающих на подложку атомов в процессе напыления позволяют использовать эти методы для получения пленок различного состава и структуры, и, в частности, для низкотемпературной эпитаксии.
В настоящее время исследованиям в данной области уделяется значительный интерес.
Целью данной курсовой работы является рассмотрение основных методов напыления и распыления в вакууме, физико-химических процессов, а также описание и работа установок использующихся в данных методах.
Процесс нанесения тонких пленок в вакууме состоит в создании (генерации) потока частиц, направленного в сторону обрабатываемой подложки, и последующей их концентрации с образованием тонкопленочных слоев на покрываемой поверхности.
Для модификации свойств поверхности твердого тела используют различные режимы ионной обработки. Процесс взаимодействия ионного пучка с поверхностью сводится к протеканию взаимосвязанных физических процессов: конденсации, распыления и внедрения. Превалирование того или иного физического эффекта определяется главным образом энергией E1 бомбардирующих ионов. При Е1=10-100 эВ конденсация преобладает над распылением, поэтому имеет место осаждение покрытия. При повышении энергии ионов до 104 эВ начинает преобладать процесс распыления с одновременным внедрением ионов в металл. Дальнейшее повышение энергии бомбардирующих ионов (Е1 >104 эВ) приводит к снижению коэффициента распыления и установлению режима ионной имплантации (ионного легирования).
Технологический процесс нанесения тонкопленочных покрытий в вакууме включает 3 основных этапа:
- генерация потока частиц осаждаемого вещества;
- переноса частиц в разреженном пространстве от источника до подложки;
- осаждения частиц при достижении подложки.
Существуют 2 метода нанесения вакуумных покрытий, различающихся по механизму генерации потока осаждаемых частиц: термическое напыление и распыление материалов ионной бомбардировкой. Испаренные и распыленные частицы переносятся на подложку через вакуумную среду (или атмосферу реактивных газов, вступая при этом в плазмохимические реакции). Для повышения степени ионизации потока осаждаемого вещества в вакуумную камеру могут быть введены специальные источники заряженных частиц (например, термокатод) или электромагнитного излучения. Дополнительное ускорение движения ионов к обрабатываемой поверхности может достигаться за счет приложения к ней отрицательного напряжения.
Общими требованиями, предъявляемыми к каждому из этих методов, является воспроизводимость свойств и параметров получаемых пленок и обеспечения надежного сцепления (адгезии) пленок с подложками и другими пленками.
Для понимания физических явлений, происходящих при нанесении тонких пленок в вакууме, необходимо знать, что процесс роста пленки на подложке состоит из двух этапов: начального и завершающего. Рассмотрим, как взаимодействуют наносимые частицы в вакуумном пространстве и на подложке.
Покинувшие поверхность источника частицы вещества движутся через вакуумное (разреженное) пространство с большими скоростями (порядка сотен и даже тысяч метров в секунду) к подложке и достигают ее поверхности, отдавая ей при столкновении часть своей энергии. Доля передаваемой энергии тем меньше, чем выше температура подложки.
Сохранив при этом некоторый избыток энергии, частица вещества способна перемещаться (мигрировать) по поверхности подложки. При миграции по поверхности частица постепенно теряет избыток своей энергии, стремясь к тепловому равновесию с подложкой, и при этом может произойти следующее. Если на пути движения частица потеряет избыток, своей энергии, она фиксируется на подложке (конденсируется). Встретив же на пути движения другую мигрирующую частицу (или группу частиц), она вступит с ней в сильную связь (металлическую), создав адсорбированный дуплет. При достаточно крупном объединении такие частицы полностью теряют способность мигрировать и фиксируются на подложке, становясь центром кристаллизации.
Вокруг отдельных центров кристаллизации происходит рост кристаллитов, которые впоследствии срастаются и образуют сплошную пленку. Рост кристаллитов происходит как за счет мигрирующих по поверхности частиц, так и в результате непосредственного осаждения частиц на поверхность кристаллитов. Возможно также образование дуплетов в вакуумном пространстве при столкновении двух частиц, которые в конечном итоге адсорбируются на подложке.
Образованием сплошной пленки заканчивается начальный этап процесса. Так как с этого момента качество поверхности подложки перестает влиять на свойства наносимой пленки, начальный этап имеет решающее значение в их формировании. На завершающем этапе происходит рост пленки до необходимой толщины.
При прочих неизменных условиях рост температуры подложки увеличивает энергию, т.е. подвижность адсорбированных молекул, что повышает вероятность встречи мигрирующих молекул и приводит к формированию пленки крупнокристаллической структуры. Кроме того, при увеличении плотности падающего пучка повышается вероятность образования дуплетов и даже многоатомных групп. В то же время рост количества центров кристаллизации способствует образованию пленки мелкокристаллической структуры.
Разреженное состояние газа, т.е. состояние, при котором давление газа в некотором замкнутом герметичном объеме ниже атмосферного, называют вакуумом.
Вакуумная техника занимает важное место в производстве пленочных структур ИМС. Для создания вакуума в рабочей камере из нее должны быть откачаны газы. Идеальный вакуум не может быть достигнуть, и в откачанных рабочих камерах технологических установок всегда присутствует некоторое количество остаточных газов, чем и определяется давление в откачанной камере (глубина, или степень вакуума).
Похожие работы
... напыления двух различных металлов путем поочередного подключения испарителей к силовому блоку питания, а также была оснащена заслонкой с управлением электромагнитом. 2.1. Конструкция и принцип работы базовой лабораторной установки вакуумного напыления 2.1.1. Блок-схема Установка состоит из трех основных структурных единиц. Это, собственно, вакуумная камера, в которой производится нанесение ...
... даже по сравнению с ускорителем "Пуск-КуАИ" при существенном росте степени ионизации потока и кинетической энергии ионов. Рисунок 1.3 - Схема плазменного генератора с магнитной ловушкой электронов "Пуск-Мэл": 1 - катод; 2 - профилированный анод; 3.1 и 3.2 - соленоиды; 4 - фланец крепления генератора к вакуумной камере; 5 - электрод поджига дуги; 7 - канал подачи реакционных газов. Пунктиром ...
... большие размеры частиц (порядка 100 мкм). Разработана технология, которая позволяет получать порошки с зернами размером 20-50 мкм. От космических аппаратов до сеялок Новый способ напыления металлических покрытий может применяться в самых различных отраслях промышленности. Особенно эффективен он при ремонтных работах, когда необходимо восстановить участки изделий, например, заделать трещину или ...
... , технической и патентной литературы (пп.1.1-1.5, [90, 91, 190]) по опыту использования многокомпонентных конденсированных структур, а также используя результаты фундаментальных исследований в области получения различных конденсационных покрытий [27, 54, 60, 124, 125, 135, 142], можно предложить достаточно наглядную классификацию всех существующих и принципиально возможных методов получения ...



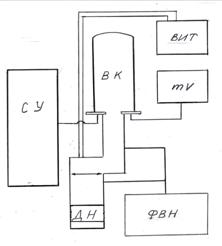


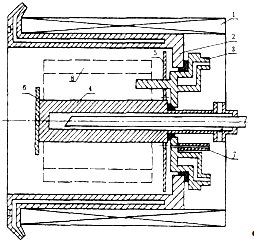

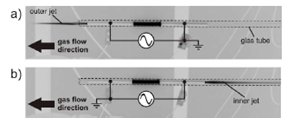
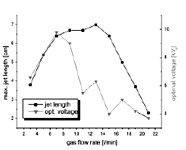




0 комментариев