Навигация
2.2 Методика розпилення
Системи для іонно-плазмового розпилення називають трьохелектродним або тріодним. На рис. 2.1а, показана схема установки для розпилення матеріалів в плазмі газового розряду низького тиску з штучним катодом. У верхній частині вакуумного ковпака поміщають анод 4, в нижній вольфрамовий катод 7. Третім електродом або зондом Ленгмюра служить мішень 5, яку використовують, як джерело розпилювального матеріалу. Підкладка 2 є електродом, на поверхні якого конденсується розпилений матеріал. Піч 3 служить для підігріву підкладки. Перед підкладкою закріплений нерухомий екран 1, а поряд з мішенню – рухомий екран 6. камеру відкачують за допомогою дифузійного насосу до тиску 1,3 . 10-4 Па, підігрівають підкладку і включають струм накалу на катод. Катод розігрівають до температури, достатньої для одержання термоелектричного струму високої частоти (густини) порядку декількох ампер на квадратний сантиметр); між накаленим катодом і анодом прикладають напругу. Після цього в камеру подають інертний газ при тискові 1,33 . (10-1-10-2) Па.
Запалювання розряду здійснюють за допомогою високочастотного трансформатора Тесла, а при досить великому термоелектронному струмі розряд виникає сам або треба лише невелике додаткове підвищення анодної напруги. Після виникнення розряду розрядний струм сягає декількох ампер, а напруга на аноді падає до 60 – 40 В, тобто для розряду характерна падаюча вольт-амперна характеристика.
Позитивні іони що виникають в розряді з низькою енергією бомбардують підкладку вибиваючи з її поверхні велику частину слабо зв’язаних забруднень шляхом нагріву та «іонного травлення». Після цього на джерело розпилювального матеріалу (мішень) подається від’ємний потенціал. Витягнуті з плазми додатні іони бомбардують мішень з енергією, достатньою для розпилення атомів матеріалу мішені. [3]
При великих енергіях бомбардуючи іонів вибиті з мішені атоми рухаються в напрямку, перпендикулярно до її поверхні і можуть бути скомпенсовані на поверхні підкладки, яка знаходиться навпроти мішені. Рухомий екран дозволяє одночасно або послідовно попередньо очищувати поверхні підкладки і мішені шляхом розпилення поверхневих забруднень. Якість очистки поверхні мішені і особливо підкладки є одним із важливих факторів в процесі плівки із конденсую чого розпиленого матеріалу.
Великою перевагою іонно-плазмового напилення є його універсальність, можна регулювати швидкість напилення з мішені. Розпилювати можна як чисті напівпровідникові матеріали (кремній та інші), так і напівпровідникові сполуки (наприклад, сульфід кадмію).
Для розпилення не провідникових матеріалів, феритів і діелектриків потрібно застосовувати високочастотні електричні поля. Напруга В4 в цьому випадку прикладається до металічної пластини, яка розміщена за нерухомою мішенню.
На рис. 2.1б показана схема основної частини установки для напилення діелектричних тонких плівок. На цій установці діелектрик бомбардується почергово іонами і електронами тліючого розряду, що виникає в газі при дії на нього високочастотного поля. Іони вибивають із діелектрика молекули, які потім осідають на підкладку. Електрони запобігають утворенню на підкладці позитивних зарядів. Електрони та іони створюються в аргоні, який оточує діелектрик, що є матеріалом для осадження.
Діелектрик закріплюють на електроді, який працює на частоті 13,6 мГц. Підкладку прикріплюють на відстані 25мм від електрода. Розрядний проміжок знаходиться в магнітному полі. В результаті електрони рухаються по спіральним траєкторіям навколо силових ліній магнітного поля в межах області тліючого розряду, що значно збільшує концентрацію іонів. Завдяки використання магнітного поля швидкість осадження виростає приблизно в два рази. Таким чином швидкість можна регулювати змінюючи потужність В4 – генератора, потужність магнітного поля і температуру підкладки.
2.3 Переваги іонно-плазмового розпилення
Одержані таким чином плівки мають велику міцність і хорошу однорідність і не кришаться при розрізанні підкладки на пластини. При високочастотному розпиленні немає необхідності нагрівати підкладку, так як найбільша швидкість осадження при цьому досягається при температурі підкладки 313 К.
Великою перевагою методу іонно-плазмового розпилення є його неінерційність. Неінерційність полягає в тому, що розпилення починається зразу при подачі напруги і після її відключенні розпилення припиняється повністю.
Метою іонно-плазмового напилення є найбільш поширеним у виробництві ІМС для осадження плівок із матеріалів з різними властивостями.
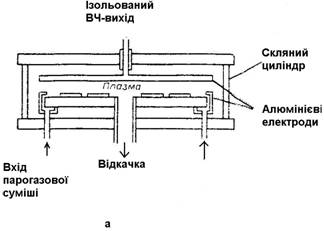
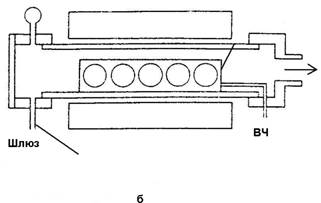
Рис. 2.1. Конструкції реакторів для іонно-плазмового напилення.
3. Термічне окислення
Метод термічного окислення при одержанні діелектричних плівок в основному застосовують в кремнієвій технології. В цьому випадку в атмосфері вологого або сухого окислення кремнієву пластину нагрівають до температури 1073 – 1473 К.
Похожие работы
... у провадженні судових експертиз та попередніх досліджень за завданнями слідчого або органу дізнання. Крім того, техніко-криміналістичні засоби та методи в залежності від мети поділяють на такі, які використовуються для: — збирання речових доказів (виявлення, фіксація, вилучення та упаковка); — дослідження доказів; — профілактики. Іноді у межах зазначеної класифікації виділяють і засоби та ...
... нестаціонарні мають одне істотне обмеження. У більшості випадків теорія цих методів припускає слабку залежність теплофізичних характеристик від температури. Тому їх застосування вимагає спеціального обґрунтування. 2. Методи дослідження електричних властивостей полімерів Електретно-термічний аналіз ЕТА називають метод вивчення полімерів, що полягає в одержанні електрета й наступному вим ...
... [16]. Методична база, створена в різних науках про працю, а також методична база проектування, що розуміється в самому широкому змісті слова, включаючи інженерне, являють собою великий простір методів. Технічні засоби, необхідні для ергономічних досліджень, часто являють собою стандартні пристрої і прилади, спеціально не орієнтовані на застосування в даній області. Тому потрібна адаптація цих ...
... 350 - 2000 ppm AS-MLC /AppliedSensor Inc. CO 0.5 - 500 ppm AS-MLK /AppliedSensor Inc. CH4 Від 0.01 до 4% 2. Сучасні датчики газів, та методи їх отримання 2.1 Нові матеріали та наноструктури – перспективна база елементів для датчиків газів В зв’язку з інтенсивним розвитком виробництва поверхневих датчиків газів, досліджуються придатні для їх побудови сучасні напівпрові ...

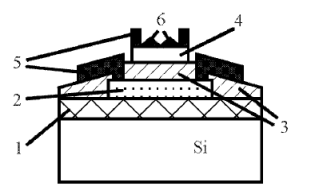



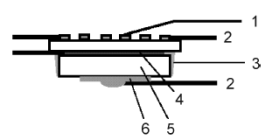
0 комментариев