Навигация
Нанотехнология в электротехнических и радиоэлектронных материалах
Министерство Образования Российской Федерации
Московский Энергетический Институт (ТУ)
Реферат на тему:
«Нанотехнология в электротехнических и радиоэлектронных материалах»
Выполнил:
Леонтьев А.В.
Гр.Эл-15-05
Проверил:
Колчин
Москва 2009
Введение
В нынешнее время трудно переоценить значение нанотехнологий. Нанотехнология – ключевое понятие начала XXI века. В настоящее время существует множество методов исследования нанообъектов.
1. Просвечивающая электронная микроскопия высокого разрешения:
- электронная микроскопия атомного разрешения;
- электронная голография;
- электронные микроскопы с коррекцией сферической абберации;
- электронная микроскопия с фильтрацией энергии для химического анализа;
- отражательная электронная микроскопия медленных электронов.
2. Сканирующая электронная микроскопия :
- энергетический анализ рассеянных электронов и рентгеновских лучей;
- катодолюминесценция;
- метод наведенного тока;
- электронная томография и др.
3. Сканирующая туннельная и атомно-силовая микроскопия :
- проведение спектроскопического анализа;
- измерение молекулярных сил;
- проведение экспериментов при пониженных и повышенных температурах;
- манипулирование отдельными атомами.
4. Рентгенодифракционные методы анализа тонкой структуры нанообъектов и наноструктурированных материалов, в том числе и при использовании синхротронного излучения.
5. Электронная спектроскопия для химического анализа:
Оже-электронная спектроскопия; фотоэлектронная спектроскопия; Рамановская и ИК-спектроскопия;
6. Методы исследования фотолюминесценции и др.
Наиболее распространенным и информативным методом является сканирующая туннельная микроскопия. С момента изобретения Г. Биннингом и Г. Рорером первого варианта сканирующего туннельного зондового микроскопа в 1982 году прошло всего 20 лет, но за это время из остроумной игрушки он превратился в одно из мощнейших средств нанотехнологии.
Рассмотрим сканирующие зондовые методы исследования и атомного дизайна.
1. Сканирующие зондовые методы исследования и атомного дизайна
Зондовые методы становятся одним из ведущих средств нанотехнологии молекулярного дизайна, реализующего новую технологическую парадигму «снизу -вверх» взамен или в дополнение развивавшейся веками парадигме «сверху - вниз».
Ключевая идея зондовой микроскопии относительно проста. Как видно из названия (SPM) общим у этих методов является наличие зонда (чаше всего это хорошо заостренная игла с радиусом при вершине, равным 10 нм) и сканирующего механизма, способного перемещать его над поверхностью образца в трех измерениях (рис. 1).
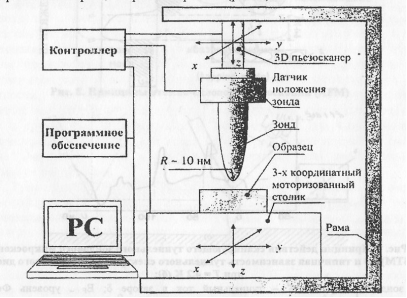
Рис. 1. Типовая схема осуществления сканирующих зондовых методов (SPM) исследования и модификации поверхности в нанотехнологии.
Обычно сканер имеет несколько ступеней регулирования положения зонда относительно образца с различной точностью и скоростью. Грубое позиционирование осуществляют трехкоординатными моторизированными столами. Типичный диапазон перемещений по координатам X и Y составляет десятки, иногда сотни мм, по Z - 10-20 мм. а точность позиционирования ~ 0,1-1 мкм. Тонкое сканирование реализуют с помощью трехкоординатных пьезоактуаторов, позволяющих перемещать иглу или образец с точностью до долей ангстрема на десятки микрон по Хи У и на единицы мкм - по Z. Все известные в настоящее время методы SPM можно разбить (весьма условно) на три большие группы.
Сканирующая туннельная микроскопия (Scanning Tunneling Microscopy - STM). При использовании этого метода между электропроводящим острием и образцом приложено небольшое напряжение (0,01 - 10 В) и регистрируется туннельный ток в зазоре, зависящий от свойств и конфигурации атомов на исследуемой поверхности образца (рис. 2).

Рис. 2. Принцип действия сканирующего туннельного зондового микроскопа (STM) (а) и типичная зависимость туннельного спектра для кремниевого диода При Т=4,2К (б): 1- зонд; 2- образец; It - туннельный ток в зазоре δ; ЕF - уровень Ферми; U - напряжение, приложенное к зазору (0,01-10 В); W - энергия; е - заряд электрона; Z - ось, перпендикулярная к поверхности образца
Будучи прямым потомком ионного проектора, созданного Мюллером в 30-е годы XX века STM также быстро достигла атомного разрешения. Но в отличие от проектора Мюллера методами STM можно получить неискаженное изображение макроскопически плоской поверхности образца на любом ее участке (см. рис.7), а не проекцию изображения кончика иглы неизвестной кривизны на люминесцентный экран проектора. Это позволило от чисто качественной картинки атомарного строения кончика острия (в виде которого и надо сначала изготовить образец для проектора Мюллера) перейти к количественным исследованиям не только топологии поверхности, но и многих других характеристик отдельных атомов на ней.
Как следует из названия, STM использует туннельный эффект -квантовый переход электрона через область, запрещенную классической механикой. В туннельном микроскопе этой областью является зазор между кончиком иглы и ближайшей точкой на поверхности образца. В рабочих режимах STM величина зазора 8 составляет единицы А (обычно 2-10 А), так что даже на воздухе при атмосферном давлении его в первом приближении можно считать вакуумированным. Коэффициент прозрачности барьера D (вероятность просачивания электрона через барьер) экспоненциально быстро падает с ростом δ.
В связи с этим гораздо удобнее режим, в котором туннельный ток поддерживается постоянным (~ 1-10 нА) за счет работы цепей обратной связи, меняющей положение зонда вдоль координаты Z. Именно сигнал в цепях обратной связи и используют затем для построения изображения на мониторе компьютера. Небольшая сила тока и энергия туннелирующих электронов (~ 1 эВ) обеспечивает высокую сохранность структуры образца в процессе изучения (в отличие от электронных микроскопов высокого разрешения, где используются пучки с энергией электронов в сотни кэВ).
В наиболее благоприятных условиях разрешение по х и у составляет около 1 А, а по с достигает 0,01 А и выше.
Дополнительные возможности представляет сканирующая туннельная спектроскопия (STS). В основном используются два метода: анализ вольтамперных характеристик в разных точках поверхности и получение изображения поверхности при разных напряжениях смешения. В первом случае строят зависимость второй производной туннельного тока от напряжения на игле, которая имеет вид спектра с характерными пиками (см. рис. 2, б). Их положение позволяет определять тип атома, над которыми остановлена игла (т.е. делать химический анализ на одном атоме!), или определять параметры зонной структуры (в сверхпроводниках или полупроводниках).
Существует множество модификаций STM, основанных на измерении термоЭДС от протекающего туннельного тока, спин-поляризованная STM и др. Особенно интересны попытки зарегистрировать спин-зависимые явления, определяющие величину туннельного тока в функции от поляризации одного единственного электрона в атоме на исследуемой поверхности. Это прямой путь к созданию «одноэлектроники» и «спинтроники».
Поскольку в основе принципа действия STM лежит измерение туннельного тока между иголкой и поверхностью образца, образец должен быть обязательно проводящим (хотя бы на уровне полупроводникового кристалла). Это, конечно, ограничивает область применения STM.
Следует также заметить, что истинно атомное разрешение в STM достигается лишь при низких температурах (несколько десятков К) и высоком или ультравысоком вакууме. Тепловой шум, адсорбирование влаги, втягивание молекул воздуха в туннельный промежуток и другие эффекты существенно понижают разрешение при работе в обычных условиях, но и в этом случае можно легко добиться нанометрового разрешения.
Атомно-силовая микроскопия (Atomic Force Microscopy - AFM). При этом методе регистрируют вариации силы взаимодействия кончика иглы с исследуемой поверхностью от точки к точке (рис. 3). Игла расположена на конце консольной балочки (кантилевера) с известной жесткостью (рис. 4), способной изгибаться пол действием небольших Ван дер Ваальсовых сил, возникающих между исследуемой поверхностью и вершиной острия. Деформацию кантилевера регистрируют по отклонению лазерного луча, падающего на его тыльную поверхность, или с помощью пьезорезистивного эффекта, возникающего в самом кантилевере при изгибе.
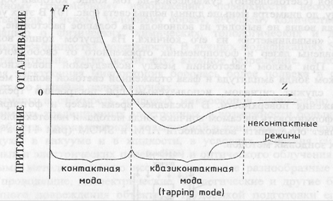
Рис. 3 Принципы атомно-силовой микроскопии (AFM)

Рис. 4 Контактная (а) и квазиконтактная (б) моды AFM
Несмотря на то, что STM имеет несколько большую историю, чем атомно-силовая микроскопия (AFM), которая была изобретена все тем же Г. Биннингом с соавторами в 1986 году, последняя явно теснит первую вследствие большей универсальности, гибкости, возможности применения на любых материалах (включая биологические), а не только на проводящих. В любой из многочисленных модификаций AFM используются силы той или иной природы, возникающие между кончиком зонда и локальной областью на поверхности образца. Это могут быть молекулярные (Ван дер Ваальсовы) силы как на рис. 3, электростатические или магнитные.
В отличие от STM зонд в AFM установлен на одном из концов миниатюрной консольной балки - кантилевере, другой конец которого закреплен на пьезоманипуляторе. Жесткость кантилевера известна, так что, регистрируя его прогиб, можно измерить силу, с которой поверхность образца действует на зонд. Деформацию кантилевера измеряют обычно фотоприемником (см. рис. 4), на который падает свет лазера, отраженный от тыльной (нерабочей) поверхности кантилевера или пьезодатчиком.
Первоначально был реализован контактный метод, в котором кончик зонда (обычно алмазный или кремниевый с упрочняющим покрытием) непрерывно находился в контакте с исследуемой поверхностью. При всей кажущейся простоте реализации, этот способ обладает серьезным недостатком: в нем велика вероятность повреждения поверхности образца и кончика иглы.
В 1995 году был предложен «неконтактный» режим, позволивший достичь истинно атомного разрешения и снизить нагрузку на кончик зонда и исследуемую поверхность. Этот метод реализуется путем измерения параметров собственных колебаний кантилевера (резонансной частоты, затухания, сдвига фазы между приложенной возбуждающей силой и смещением), игла которого находится достаточно далеко от поверхности (десятки или сотни ангстрем) и взаимодействует с ней посредством дальнодействующих сил Ван дер Ваальса (см. рис. 3). Промежуточный режим «квазиконтакта» (tapping mode в англоязычной литературе), а также регистрация латеральных сил (Friction Force Microscopy - FFM) еще более повышают пространственное разрешение.
Типичные размеры кантилеверов лежат в диапазоне 10-100 мкм (длина) х 3-10 мкм (ширина) х 0,1-1 мкм (толщина). Обычно коэффициент жесткости кантилевера (~ 0,01-1 Н/м) как минимум на порядок меньше величины характерных упругих констант межатомного взаимодействия в исследуемом материале (~ 10 Н/м). При таких габаритах собственная частота изгибных колебаний кантилевера колеблется от 100 кГц до единиц МГц, добротность (в вакууме) достигает порядка сотен тысяч, а чувствительность -фемтоньютонов (10 ,5 Н). Ультратонкие монокристаллические кремниевые кантилеверы, изготовленные в IBM (толщиной всего в 60 нм!), способны детектировать силы величиной в несколько аттоньютонов (10"18 Н). Критичным местом для AFM является материал и геометрия кончика иглы, определяющие ее стойкость и пространственное разрешение метода. Эквивалентный радиус закругления современных игл из алмаза или кремния, покрытого алмазной пленкой, имеет типичное значение 10 - 30 нм, что в благоприятных условиях достаточно для достижения атомного разрешения. Однако в процессах модифицирования поверхности или AFM-литографии стойкость иглы пока является серьезной проблемой.
Ближнепольная оптическая микроскопия (Scanning Near-field Optic Microscopy - SNOM). Зондом в этом случае является оптический волновод (световолокно), сужающейся на том конце, который обращен к образцу, до диаметра меньше длины волны света (рис. 5). В этих условиях световая волна не выходит из волновода на большое расстояние, а лишь слегка «вываливается» из его кончика. На другом конце волновода установлены лазер и фотоприемник отраженного от свободного торца света. При малом расстоянии между исследуемой поверхностью и кончиком зонда амплитуда и фаза отраженной световой волны меняются, что и служит сигналом, используемым при построении трехмерного изображения поверхности. В последнее время лазер и фотоприемники стали формировать на самом кончике зонда методами нанотехнологии, что позволяет объединить возможности АРМ и SNOM (рис. 6), а также и других зондовых методов.

Рис. 5. Ближнепольная оптическая микроскопия (SNOM):
1- волновод, сужающийся к нижнему концу; 2- фотоприемник; 3- световое поле открытого конца волновода с диаметром меньше длины волны света
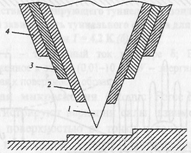
Рис. 6. Схема комбинированного зонда:
1- острие; 2-4- напыленные гетерослои, образующие лазер, фотоприемник, термопару и т.д.
Следует заметить, что описанные способы SPM и их многочисленные модификации строят изображение исследуемой поверхности на мониторе компьютера при поддержке мощных специализированных программ, фильтрующих, обрабатывающих и корректирующих сигнал с зонда в соответствии с поставленными задачами исследования. Так что к полученному трехмерному изображению поверхности необходимо относиться как к некому условному образу, несущему количественную информацию о физических, химических, топологических и других локальных особенностях поверхности. В лучших модификациях STM и AFM относительно легко достигается атомное разрешение, за которое пучковая электронная микроскопия боролась более полвека и сейчас достигает его в крайне редких случаях.
Размеры и стоимость зондовых микроскопов значительно ниже, чем стоимость традиционных электронных, а возможности больше: они могут работать при комнатной, повышенной и криогенной температурах, на воздухе, в вакууме и в жидкости, в условиях действия сильных магнитных и электрических полей, СВЧ и оптического облучения и т.п. Зондовыми методами можно исследовать самые разнообразные материалы: проводящие, диэлектрические, биологические и другие без существенного повреждения объекта и трудоемкой подготовки его поверхности. Они могут использоваться для локального определения атомных конфигураций, магнитных, электрических, тепловых, химических и других свойств поверхности. Поэтому SPM получила широкое распространение в последние годы.
Похожие работы
... проблемы: неразвитость собственных запасов сырья; территориальная удаленность, разрыв хозяйственных связей; высокие транспортные тарифы энергодефицит; диверсификация развития территорий. Основные термины: экономический район, экономический потенциал, таможенная территория, территориальная структура национальной экономики. Потенциал интеграционных процессов. Свободные экономические зоны в РФ. ...
... с применением полиграфических компьютерных технологий? 10. Охарактеризуйте преступные деяния, предусмотренные главой 28 УК РФ «Преступления в сфере компьютерной информации». РАЗДЕЛ 2. БОРЬБА С ПРЕСТУПЛЕНИЯМИ В СФЕРЕ КОМПЬЮТЕРНОЙ ИНФОРМАЦИИ ГЛАВА 5. КОНТРОЛЬ НАД ПРЕСТУПНОСТЬЮВ СФЕРЕ ВЫСОКИХ ТЕХНОЛОГИЙ 5.1 Контроль над компьютерной преступностью в России Меры контроля над ...
... без Тюменской области – соответственно 89 и 76%. В макрорегионе резко обозначена дифференциация между богатым севером и бедным югом. Чрезмерные различия в доходах населения двух зон федерального округа обусловлены не только высокой производительностью и благоприятной внешнеторговой конъюнктурой тюменской нефтегазовой промышленности, в значительной мере работающей на экспорт, но и действием ...
... . На 1 января 2001 года только в сфере, подчиненной Госпромполитики, насчитывалось около 6 тыс. крупных и средних и свыше 27 тыс. малых предприятий. Промышленность Украины имеет довольно полную отраслевую структуру, охватывает базовые отрасли: машиностроение, приборостроение, оборонную, легкую, перерабатывающую промышленность и прочие. Среди наукоемких отраслей — авиакосмическая, ...

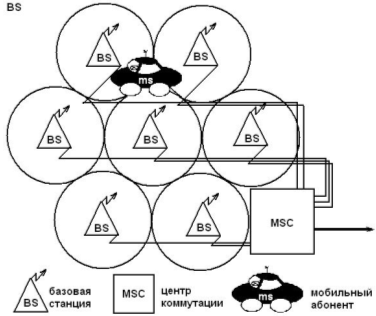


0 комментариев