Навигация
Лекции по твердотельной электронике
Московский энергетический институт
(технический университет)
ТВЕРДОТЕЛЬНАЯ ЭЛЕКТРОНИКА
Конспект лекций
Москва, 2002 г.
Содержание
Лекция 1 5
1. ОСНОВНЫЕ ПОНЯТИЯ ФИЗИКИ ПОЛУПРОВОДНИКОВЫХ МАТЕРИАЛОВ 5
1.1. Электропроводность полупроводников 5
Лекция 2 10
1.2. Электроны в кристалле 10
1.2.1. Энергетические зоны. Свободные носители зарядов: электроны и дырки. 10
1.2.3. Легирование кристаллов донорной или акцепторной примесью, полупроводники "n" и "p" типа . 23
Лекция 3 28
1.2.4. Расчет концентрации носителей заряда в кристалле. 28
Лекция 4 40
1.2.5. Зависимость скорости электрона от напряженности электрического поля. Понятия эффективной массы и подвижности. 40
1.2.6. Расчет электропроводности полупроводниковых кристаллов на основе рассмотренных моделей. 49
Лекция 5 56
1.2.7. Неравновесные электроны и дырки. Рекомбинация неравновесных носителей заряда. 56
Диффузионный и дрейфовый токи. 59
1.2.8. Уравнение непрерывности. 61
ВВЕДЕНИЕ
Современная научно-техническая революция и переход от индустриального к информационному обществу в значительной степени обусловлены повышением производительности интеллектуального труда за счет информационных технологий, материальную основу которых составляют твердотельные полупроводниковые приборы и устройства на их основе. Полупроводниковые приборы широко используются и в силовой электронике предоставляя эффективные способы преобразования и генерации электроэнергетических потоков. Поэтому курс полупроводниковой электроники стал одним из базовых курсов практически для всех специальностей электротехнического профиля и начинает изучаться сравнительно рано - на втором курсе. При этом имеется тенденция к его дальнейшему "омоложению" - к более раннему изучению разделов, связанных непосредственно с физикой электронных процессов в твердом теле, что предъявляет особые требования к доступности изложения сравнительно сложных электронных взаимодействий, позволяющих осуществлять управление электронными потоками в твердых телах и создавать современные устройства информационной и силовой электроники.
Основное содержание дисциплины составляет изучение принципов работы и характеристик основных приборов, являющихся базовыми для любых полупроводниковых приборов. Поскольку курс предназначен для подготовки инженеров, рассмотрение любых процессов в приборе, заканчивается составлением некоторой модели и выводом расчетных соотношений. Безусловно использованные модели являются упрощенными, однако тем не менее они позволяют связать параметры материалов и конструкции прибора с его характеристиками и позволяют оценить реакцию прибора на то или иное воздействие окружающей среды и, что особенно важно, способствуют установлению связи между разрозненными процессами и их свойствами и созданию некоторого обобщенного образа твердотельной электронной среды и сформированных на ее основе устройств. Именно последнее является наиболее важной и наиболее трудной задачей курса достижению которой способствует лабораторный практикум и расчетный проект.
Лекция 1 1. ОСНОВНЫЕ ПОНЯТИЯ ФИЗИКИ ПОЛУПРОВОДНИКОВЫХ МАТЕРИАЛОВ 1.1. Электропроводность полупроводниковПо способности проводить электрический ток все твердотельные материалы принято делить на проводники, полупроводники и диэлектрики или изоляторы. К группе проводников относят материалы с проводимостью σ > 106 Ом-1см-1, к ним относятся металлы, в которых высокая проводимость обеспечивается высокой концентрацией электронов проводимости. Напротив в диэлектриках, как правило при комнатной температуре электронов очень мало и их проводимость, в основном носит ионный характер, поэтому она мала σ < 10-10 Ом-1см-1. В промежуточную группу попадают полупроводники, которые в зависимости от их состава и концентрации примесей могут иметь концентрацию электронов близкую к нулю (тогда они являются изоляторами) и близкую к концентрации электронов в металле (тогда они являются проводниками). Возможность изменять в широких пределах электропроводность не только технологическими методами, но и используя внешние воздействия, позволила создать на основе полупроводников твердотельные электронные приборы. Именно изучение этих приборов и используемых в них методов управления электронными потоками и составляет основное содержание данного курса.
Металлы и полупроводники помимо величины электропроводности отличаются так же и зависимостью электропроводности от температуры. В металлах электропроводность с температурой, как правило, падает почти по линейному закону .
, (1.1)
где T и T0 – температуры измерения (T > T0), α – температурный коэффициент.
В полупроводниках, в которых отсутствуют дефекты и примеси (их принято называть собственными) с ростом температуры проводимость растет примерно по экспоненциальному закону:
(1.2)
где σ0 – некоторая слабо изменяющаяся величина (часто ее температурной зависимостью пренебрегают), ΔE – энергия температурной активации проводимости (ее принято измерять в эВ), k – постоянная Больцмана (8.614210-5 эВ.К-1), T - абсолютная температура (в градусах К). Если прологарифмировать (1.2), то получим:
(1.3)
Рис. 1.1. Зависимость электропроводности не легированных материалов от температуры
Из (1.3) видно - логарифм проводимости линейно зависит от 1/T, причем наклон прямой линии определяется величиной ΔE, поэтому для полупроводников графики электропроводности очень удобно строить откладывая по вертикальной оси проводимость в логарифмическом масштабе, а по горизонтальной оси величину пропорциональную обратной температуре (для удобства используют масштабный множитель 1000), см. рис. 1.1.
На следующем рисунке показана зависимость электропроводности собственного кремния от температуры при освещении его солнечным светом, подтверждающая сильное влияние внешних воздействий на свойства полупроводников.
Рис. 1.2. Влияние освещения на температурную зависимость электропроводности: 1 – зависимость измеренная в темное, 2 – на свету.
Изменение электропроводности может быть связано изменением концентрации носителей заряда и их скорости. Как показали эксперименты в большинстве случаев в полупроводниках основным фактором является изменение концентрации носителей заряда. Особенно сильно концентрация носителей заряда зависит от концентрации введенной примеси (обычно говорят от степени легирования). На рис. 1.3 показана измеренная на образцах кремния, легированных примесью фосфора или бора, зависимость удельного сопротивления кремния ρ = 1/σ от концентрации примеси. Из графика видно, что путем введения примеси проводимость полупроводника действительно можно изменять вплоть до проводимости близкой к металлической σ ≈ 104 (ρ ≈ 10-4).
Рис. 1.3. Влияние легирования на электропроводность кремния (пунктиром показана линейная зависимость).
Следует обратить внимание на тот факт, что при увеличении концентрации примеси на 9 порядков, проводимость образца возрастает на 8 порядков, т.е. существует почти линейная зависимость между проводимостью и концентрацией примеси.
Легирование влияет не только на величину электропроводности, но и на ее температурную зависимость, что демонстрируют кривые, приведенные на рис. 3.4. Как видно из графиков в области высоких температур электропроводность легированного материала стремится к электропроводности нелегированного. В области низких температур проводимость изменяется незначительно, имея слабо выраженный максимум. Для сильно легированных кристаллов проводимость изменяется с температурой подобно проводимости металлов.
Рис. 1.4. Температурная зависимость электропроводности легированных кристаллов, степень легирования в см-3 проставлена около соответствующих кривых, пунктирная линия соответствует нелегированному материалу.
Поскольку для создания полупроводниковых приборов с заданными характеристиками необходимо объяснить наблюдаемые особенности полупроводниковых материалов, научиться ими управлять и заранее прогнозировать поведение материала в тех или иных условиях, то необходимо создать модель описывающую процессы электропроводности полупроводников. Эта модель в первом приближении должна объяснять:
экспоненциальный рост проводимости с температурой для нелегированных материалов;
изменение проводимости и ее температурной зависимости при легировании полупроводников;
изменение проводимости и ее температурной зависимости при облучении полупроводников светом, бомбардировке высокоэнергетическими частицами и т.п.
По определению электропроводность характеризует изменение протекающего через образец тока при изменении приложенного к нему напряжения. В свою очередь величина электрического тока характеризуется количеством заряда переносимого через поверхность в единицу времени, т.е. для его характеристики необходимо знать концентрацию и скорость способных перемещаться зарядов. Таким образом приступая к изучению твердотельной электроники прежде всего необходимо рассмотреть процессы, которые приводят к появлению в однородном образце свободных носителей заряда и то как внешнее электрическое поле влияет на скорость их перемещения.
Контрольные вопросы.
Каково соотношение значений проводимости для проводников, полупроводников и диэлектриков?
Каково соотношение значений удельного сопротивления для проводников, полупроводников и диэлектриков?
Как экспериментально определить к какому классу материалов относится образец: к полупроводникам или металлам?
По какому закону изменяется с температурой электропроводность чистых (собственных полупроводников)?
Как влияет введение примесей на величину и температурную зависимость электропроводности полупроводников?
Лекция 2 1.2. Электроны в кристалле 1.2.1. Энергетические зоны. Свободные носители зарядов: электроны и дырки.Известно, что первичными и единственными носителями заряда являются электроны и протоны. В вакууме и газах электроны и протоны могут быть свободными, в твердых телах и жидкостях электроны и протоны связаны с атомами и их заряды нейтрализуют друг друга.
Полупроводниковые кристаллы образуются из атомов, расположенных в определенном порядке. Естественно возникает вопрос, если в атоме электроны связаны с ядром, то откуда в состоящем из атомов кристалле берутся свободные заряды, способные перемещаться по кристаллу создавая электрический ток. Действительно, если представить атом как изолированный шарик, то тело полученное из миллиардов уложенных в правильном порядке шариков все равно останется изолятором, поскольку в нем способные переносить заряд не появятся. Для того, чтобы объяснить как в металлах и полупроводниках появляются свободные электроны необходимо использовать закономерности микромира. Впервые эти закономерности были использованы Бором для объяснения электронной структуры атома. Работы бора стимулировали работы по квантовой механике, которая в настоящее время используется для объяснения поведения электронов в атомах, молекулах и твердых телах.
Согласно современным представлениям атомы состоят из положительно заряженных ядер вокруг которых распложены заполненные электронами оболочки. При этом каждому электрону соответствует строго определенный уровень, на котором не может находиться более двух электронов с разными значениями спина, характеризующего вращение электрона. В магнитном поле этот уровень расщепляется на два близко расположенных уровня.
Согласно законам квантовой механики, электроны могут находиться только в строго определенных энергетических состояниях. Изменение энергии электрона возможно при поглощении или испускании кванта электромагнитного излучения с энергией, равной разности значений энергий на начальном и конечном уровне. Поэтому оптические спектры поглощения (или излучения) атомов, соответствующие электронным переходам на свободные дискретные уровни, так же должны быть дискретны, что и наблюдается в экспериментах (рис. 1.5.)
Рис. 1.5. Диаграмма, иллюстрирующая энергетический спектр электронов в атоме (модель Бора) и ожидаемый спектр поглощения.
Электронные оболочки принято обозначать буквами и числами (N). Число N называют главным квантовым. Отсчет его значения осуществляется от уровня, ближайшей к ядру N = 1, 2, 3, 4 и т.д., оболочки имеют соответствующие буквенные обозначения: K, L, M, N, и т.д.
На каждой оболочке может находиться несколько электронов, причем каждому из них соответствует свой энергетический уровень, со своим пространственным распределением заряда, который часто называют орбиталью. Энергетические уровни электронов (орбитали) внутри оболочки (с одним числом N) принято обозначать буквами: s (нижний уровень), p, d, f и т.д. Причем чем выше энергия оболочки (больше N), тем большее число электронов может на ней находиться, или другими словами ей соответствует большее число орбиталей. Так первой оболочке соответствует один уровень - орбиталь 1s, т.е. на этой оболочке могут находиться только два электрона с разными спинами. Соответственно конфигурацию с одной оболочкой имеют только два атома – водорода и гелия.
Второй оболочке соответствуют три уровня: одна орбиталь 2s и три орбитали 2p, т.е. в этой оболочке могут находиться шесть электронов.
Третей оболочке соответствуют девять уровней: одна орбиталь 3s, три орбитали 3p, пять орбиталей 3d, т.е. в этой оболочке могут находиться до 18 электронов.
При увеличении числа электронов в атоме, заполнение оболочек происходит по определенным правилам:
первыми заполняются низшие по энергии орбитали ;
на любой орбитали может находиться не более двух электронов с противоположными значениями спина (принцип запрета Паули);
заполнение орбиталей одной оболочки начинается одиночными электронами с параллельными спинами, пары начинают образовываться только после того как каждая орбиталь имеет по одному электрону (правило Гунда).
Именно на основе правил заполнения оболочек построена периодическая таблица элементов Д.И. Менделеева. Один ряд таблицы соответствует элементам, в которых происходит заполнение внешней (валентной) оболочки, переход от одной ячейке к другой в пределах ряда соответствует добавлению одного электрона.
При сближении двух атомов , например водорода, их орбитали начинают перекрываться и возможно возникновение связи между ними. Существует правило, согласно которому число орбиталей у молекулы равно сумме чисел орбиталей у атомов, при этом взаимодействие атомов приводит к тому, что уровни у молекулы расщепляются, при этом чем меньше расстояние между атомами, тем сильнее это расщепление.
На рис. 1.6. показана схема расщепления уровней для пяти атомов при уменьшении расстояния между ними. Как видно из графиков при образовании между атомами связей валентные электроны формируют разрешенные для электронов зоны, причем число состояний в этих зонах тем больше, чем больше взаимодействующих атомов. В кристаллах число атомов более чем 1022 см-3, примерно такое же количество уровней в зонах. При этом расстояние между уровнями становится чрезвычайно малым, что позволяет считать, что энергия в разрешенной зоне изменяется непрерывно. Тогда электрон, попавший в незанятую зону можно рассматривать как классический, считая, что под действием электрического поля он набирает непрерывно энергию, а не квантами, т.е. ведет себя как классическая частица.
Рис. 1.6. Энергетическое расщепление 1s и 2s уровней для пяти атомов в зависимости от расстояния между ними
При образовании кристаллов образуемые валентными электронами зоны могут быть частично заполненными, свободными или полностью заполненными электронами. При этом если между заполненными и свободными состояниями запрещенная зона отсутствует, то материал является проводником, если существует небольшая запрещенная зона, то это полупроводник, если запрещенная зона большая и электроны за счет тепловой энергии в нее не попадают, то это изолятор. Рисунок 1.7. иллюстрирует возможные конфигурации зон.
Для проводников разрешенная зона частично заполнена электронами, поэтому даже при приложении внешнего напряжения они способны набирать энергию и перемещаться по кристаллу. Такая структура зон характерна для металлов. Уровень F, разделяющий заполненную электронами и незаполненную часть зоны называют уровнем Ферми. Формально его определяют как уровень вероятность заполнения которого электронами равна 1/2.
Рис. 1.7. Возможная структура энергетических зон, создаваемых валентными электронами в кристаллах
Для полупроводников и диэлектриков структура зон такова, что нижняя разрешенная зона полностью заполнена валентными электронами, поэтому ее называют валентной. Потолок валентной зоны обозначают Ev. В ней электроны перемещаться под действием поля (и соответственно набирать энергию) не могут, поскольку все энергетические уровни заняты, а согласно принципу Паули электрон не может переходить с занятого состояния на занятое. Поэтому электроны в полностью заполненной валентной зоны не участвуют в создании электропроводности. Верхняя зона в полупроводниках и диэлектриках в отсутствии внешнего возбуждения свободна от электронов и если каким либо образом туда забросить электрон, то под действием электрического поля он может создавать электропроводность, поэтому эту зону называют зоной проводимости. Дно зоны проводимости принято обозначать Ec. Между зоной проводимости и валентной зоной находится запрещенная зона Eg, в которой согласно законам квантовой механики электроны находиться не могут (подобно тому как электроны в атоме не могут иметь энергии не соответствующие энергиям электронных оболочек). Для ширины запрещенной зоны можно записать:
Eg = Ec – Ev (1.4.)
В полупроводниках в отличие от изоляторов ширина запрещенной зоны меньше, это сказывается в том что при нагреве материала в зону проводимости полупроводника попадает за счет тепловой энергии значительно больше электронов, чем в зону проводимости изолятора и проводимость полупроводника может быть на несколько порядков выше чем проводимость изолятора, однако граница между полупроводником и изолятором условная.
Поскольку в отсутствии внешнего возбуждения валентная зона полностью заполнена (вероятность нахождения электрона на Ev = 1), зона проводимости полностью свободна (вероятность нахождения электрона на Eс = 0), то формально уровень Ферми с вероятностью заполнения Ѕ должен был бы находиться в запрещенной зоне. Расчеты показывают, что действительно в беспримесных бездефектных полупроводниках и диэлектриках (их принято называть собственными) он лежит вблизи середины запрещенной зоны. Однако электроны там находится не могут, поскольку там нет разрешенных энергетических уровней.
Рис. 1.7. Схематическое представление бездефектного кристалла кремния.
Основные элементарные полупроводники относятся к четвертой группе таблицы Менделеева, они имеют на внешней оболочке 4 электрона. Соответственно эти электроны находятся в S (1 электрон) и p (3 электрона). При образовании кристалла внешние электроны взаимодействуют и образуются полностью заполненная оболочка с восьмью электронами, как это показано на диаграмме рис. 1.7.
Элементы четвертой групп используют четыре электрона находящихся в s и p орбиталях, но в разных электронных оболочках (N изменяется от 2 для С до 6 для Pb). При взаимодействии образуется гибридная sp3 орбиталь) в ее образовании участвует одна s орбиталь и 3p – орбитали). Эта орбиталь состоит из гибридизированных четырех орбиталей каждая из которых с учетом спина может принять четыре электрона и таким образом образуется заполненная внешняя оболочка с восьмью электронами. При этом атом может образовывать химические связи с четырьмя соседями, т.е. является четырежды координированными. Все связи эквивалентны и образуют тетраэдрическую решетку (тетраэдр – фигура с четырьмя одинаковыми поверхностями). Схема образования гибридной sp3 орбитали показана на рис. 1.8.
Тетраэдрическая структура свойственна кристаллам алмаза. Такие известные полупроводники как Si и Ge имеют структуру типа алмаза, это и понятно, поскольку у них внешние электроны находятся на sp3 орбиталях.
Рис. 1.8. Схема образования гибридной sp3 орбитали и соответственно тетраэдрической структуры кристалла (типа алмаза).
На рис. 1.9 показана схема образования энергетических зон и sp3 орбиталей для кристаллов других элементов четвертой группы периодической системы элементов Д.И. Менделеева. Как видно из рисунка все зоны формируются на основе s и p состояний, но принадлежащих к разным оболочкам (различно значение главного квантового числа N). Так для углерода валентная оболочка формируется из 2s и 2p состояний соответственно структура алмаза определяется гибридными 2sp3 состояниями. Для Si валентная оболочка формируется из 3s и 3p состояний атома Si, соответственно структура кристаллической решетки создается 3sp3 орбиталями, является тетраэдрической и аналогична структуре алмаза. В Ge в образовании химических связей участвую 4s и 4p электроны, Sn 5s и 5p электроны и т.д. При этом для образовавшаяся sp3 оказывается полностью заполненной, верхняя полностью свободной, т.е. имеет место энергетическая структура соответствующая полупроводникам и диэлектрикам с валентной зоной и зоной проводимости. Следует обратить внимание на тот факт, что по мере роста числа N , движении по группе таблицы Менделеева сверху вниз, ширина запрещенной зоны уменьшается и для свинца обе зоны перекрываются, т.е. для этого материала реализуется зонная структура, характерная для проводника.
Рис. 1.9. Схема образования зон элементарных полупроводников четвертой группы периодической системы элементов.
Следует отметить, что sp3 гибридизация может происходить не только для кристаллов элементарных полупроводников, но и для полупроводниковых соединения. Необходимым для этого условием является то, чтобы электроны внешней оболочки исходных компонентов принадлежали к s и p оболочкам и чтобы суммарное число на внешней оболочки соединения равнялось 8 (тогда нижняя зона оказывается полностью заполненной). Последнее условие будет выполняться для соединений элементов первой и седьмой групп, второй и шестой, третьей и пятой, т.е. для соединений A1B7, A2B6 , A3B5. Действительно большинство из этих соединений является полупроводниками, причем для них так же выполняется правило, что с увеличением номера электронной оболочки атомов из которых образуется соединение ширина запрещенной зоны уменьшается.
В качестве примера рассмотрим такое несколько полупроводниковых соединений. Примеры из группы A3B5: GaAs: Eg = 1.43эВ (при Т=300К), атомы компонентов имеют электронную конфигурацию внешних оболочек – 3s24p1 (Ga), 4p3 (As); InSb: Eg=0.18 эВ (при Т=300К), электронная конфигурация валентной оболочки – 4s24p1 (In), 5p3 (Sb).
При уходе электрона в зону проводимости он делокализуется и может перемещаться по зоне от одного атома к другому. Он становится электроном проводимости и может создавать электрический ток. Обычно говорят: появился свободный носитель заряда, хотя на самом деле электрон не покидал кристалл, у него только появилась возможность перемещаться из одного места кристалла в другое.
На месте откуда ушел электрон условие электронейтральности нарушается и возникает положительно заряженная вакансия электрона, которую принято называть дыркой (положительный заряд обусловлен не скомпенсированным зарядом ядра).
На место откуда ушел электрон может переместиться соседний электрон, что приведет к перемещению положительно заряженной дырки. Таким образом перемещение валентных электронов заполняющих свободное электронное состояние (запрет Паули снят) приводит к перемещению вакансии в которой нарушено условие компенсации заряда, т.е. дырки. Вместо того, чтобы рассматривать движение валентных электронов, которых в валентной зоне чрезвычайно много рассматривают перемещение положительно заряженных дырок, которых мало и которые так же как электроны могут переносить заряд. Этот процесс поясняет рис. 1.10.
На рисунке 1.10 показан кристалл, в котором каким либо внешним возбуждением, например квантом света с hν > Eg один из электронов переброшен в зону проводимости (стал свободным), т.е. у одного из атомов была разорвана одна из валентных связей. Тогда в кристалле помимо не связанного с атомом электрона возник положительно заряженный ион. Способность под действием поля перемещаться самого иона очень мала, поэтому ее учитывать не следует. Поскольку в кристалле атомы расположены близко друг от друга к этому иону может притянуться электрон от соседнего атома. В этом случае положительная дырка возникает у соседнего атома откуда ушел валентный электрон и т.д. Для совершенного, не имеющего примесей и дефектов, кристалла концентрация электронов будет равна концентрации дырок. Это собственная концентрация носителей заряда ni = pi, значок i означает концентрацию носителей для собственного полупроводника (intrinsic –собственный). Для произведения концентраций электронов и дырок можно записать:
np = ni2 (1.5)
Следует отметить, то это соотношение выполняется не только для полупроводников с собственной проводимостью, но и для легированных кристаллов, в которых концентрация электронов не равна концентрации дырок.
Рис. 1.10. Схематическое изображение возникновения электрона и дырки при поглощении света
Направление движения дырки отложено направлению движения электрона. Каждый электрон находящийся в валентной связи характеризуется своим уровнем. Все уровни валентных электронов расположены очень близко и образуют валентную зону, поэтому перемещение дырки можно рассматривать как непрерывный процесс, аналогичный движению классической свободной частицы. Аналогично поскольку в зоне проводимости энергетические уровни расположены очень близко, зависимость энергии от импульса можно считать непрерывной и соответственно движение электрона можно в первом приближении рассматривать как движение классической свободной частицы. Таким образом разгоняемый (говорят разогреваемый) электрическим полем электрон в твердом теле на энергетической диаграмме перемещается от дна зоны проводимости к ее потолку. Аналогично дырка разогреваемая полем перемещается от потолка валентной зоны к ее дну (для нее отсчет энергии идет относительно электрона в другую сторону). Поведение электрона и дырки, как квазиклассических частиц нарушается в тот момент когда они достигают высокоэнергетической границы энергетической зоны. Для свободного классического электрона таких границ нет и теоретически его можно разгонять вплоть до скорости свет. Электрон в твердом теле достигший потолка зоны проводимости должен упруго от нее отразится и пойти в обратном направлении, достигнув дна зоны проводимости он отражается от него и идет вверх и т.д. Таким образом если бы удавалось разогреть электронный (или дырочный) газ в твердом теле до энергий порядка ширины разрешенной зоны, то должны были бы возникнуть мощные высокочастотные колебания. Однако осуществить такой разогрев не удается, поскольку горячие носители начинают взаимодействовать с решеткой, отдавая ей часть своей энергии, поэтому как для электронов, так и для дырок существует некоторое предельное значение скорости (насыщение скорости в электрическом поле) близкое к тепловой скорости электронов в твердом теле (106 – 107 см/c)
Рис. 1.11. Энергетическая диаграмма , поясняющая возникновение электрона и дырки в совершенном кристалле.
Таким образом в качестве носителей заряда в любой среде могут выступать способные перемещаться под действием электрического поля электроны - n, дырки - p, положительно и отрицательно заряженные ионы- ip и in . Для концентрации заряда в единице объема можно записать:
N = n + p + in + ip, (1.6)
Если (in + ip ) >> (n + p), то это материалы с ионной проводимостью, что типично для диэлектриков.
Если (n + p ) >> (in + ip), то это материалы с электронной проводимостью, это типично для полупроводников и металлов.
1.2.3. Легирование кристаллов донорной или акцепторной примесью, полупроводники "n" и "p" типа .Наличие в кристалле примесей и дефектов приводит к появлению в запрещенной зоне энергетических уровней, положение которых зависит от типа примеси или дефекта. Для управления электрическими свойствами полупроводников в них специально вводят примеси (легируют). Так введение в элементарный полупроводник IV группы периодической системы элементов, например Si, примеси элементов V группы (доноров) приводит к появлению дополнительных электронов и соответственно преобладанию электронной проводимости (n - тип), введение элементов III группы приводит к появлению дополнительных дырок (p-тип).
Рис. 1.12. Схема образования свободного электрона и заряженного донорного атома при легировании Si элементами V группы периодической системы
На рис. 1.12 показана схема кристалла Si, в который введен фосфор (V группа). Элемент V группы (донор) имеет 5 валентных электронов, четыре из них образуют связи с соседними атомами Si, пятый электрон связан только с атомом примеси и эта связь слабее остальных, поэтому при нагреве кристалла этот электрон отрывается первым, при этом атом фосфора приобретает положительный заряд, становясь ионом.
(1.7)
где Ed - энергия ионизации (активации) донорного атома.
Энергия ионизации доноров, как правило не велика (0.005 - 0.01 эВ) и при комнатной температуре они практически все отдают свои электроны. При этом концентрация электронов, появившихся за счет ионизации доноров примерно равна концентрации введенных атомов примеси и значительно превосходит собственную концентрацию электронов и дырок n>>ni, поэтому такие материалы и называют электронными материалами (n-тип).
Введение донорной примеси приводит к увеличению концентрации электронов, поскольку энергия связи электронов с примесным атомом меньше, чем с основным атомом решетки, то ему легче оторваться.
При некоторой температуре (ее называют температурой истощения примеси) почти все примесные атомы будут термически ионизованы, тогда концентрация электронов в зоне проводимости будет примерно равна концентрации донорных атомов:
n ~ Nd+ ~ Nd (1.8)
При этом концентрация электронов становится значительно больше концентрации дырок, которые могут возникнуть только за счет тепловой активации валентных электронов. Такие материалы будут обладать электронной проводимостью. Из называют материалами n – типа. Будем называть электроны в них основными носителями и обозначать nn, соответственно дырки будем называть неосновными носителями заряда и обозначать pn.
Используя (1.5) и (1.7) получим для области истощения примеси:
(1.7)
Согласно (1.7) чем больше концентрация основных носителей, тем меньше концентрация неосновных, это хорошо подтверждается в экспериментах.
Рассмотрим, что происходит при введении в тот же Si элемента III группы, например B. Элемент III группы имеет 3 валентных электрона, которые образуют связи с соседними атомами Si, четвертая связь может образовываться, если к атому B перейдет еще один электрон от одного из его ближайших соседей, см. рис. 10. Энергия такого перехода не велика, поэтому соответствующий принимающий (акцепторный) электрон энергетический уровень расположен вблизи валентной зоны. При этом атом бора ионизуется заряжаясь отрицательно, а в том месте откуда ушел электрон образуется положительно заряженная дырка, которая может участвовать в переносе заряда.
где ev - электрон из валентной зоны, Ea - энергия акцепторного уровня относительно потолка валентной зоны.
Рис. 1.13. Схема образования свободной дырки и заряженного акцепторного атома при легировании Si элементами III группы периодической системы
Количество дополнительно появившихся дырок примерно соответствует количеству введенных акцепторных атомов и, как правило, значительно превосходит количество электронов, возникающих за счет переходов из валентной зоны, поэтому материал легированный акцепторной примесью является дырочным (p тип).
Введение акцепторной примеси приводит к увеличению концентрации дырок и соответственно смещению уровня Ферми к валентной зоне (чем он ближе к ней, тем больше концентрация дырок). При этом в соответствии с (18) концентрация дырок уменьшается. Действительно используя (17) и (20) получим для области истощения примеси:
(1.9)
Согласно (1.90 чем больше концентрация акцепторных примесей Na, тем выше концентрация основных носителей дырок заряда и ниже концентрация неосновных носителей электронов.
Контрольные вопросы.
Каковы отличия электронного спектра атомов от электронного спектра кристаллов?
Каковы будут отличия электронного системы состоящей из невзаимодействующих атомов (разреженный газ) от системы состоящей из взаимодействующих атомов (кристалл)?
Почему электроны в полупроводниковом кристалле могут переносить заряд, если он находятся в зоне проводимости и не могут переносить заряд, если они находятся в заполненной валентной зоне?
Объясните, почему кристаллы состоящие из элементов первой группы являются хорошими проводниками?
Как вы считаете, если бы удалось получить кристаллический водород, то он был бы проводником или полупроводником?
Почему в элементарных полупроводниках (четвертая группа периодической системы элементов Д.И. Менделеева) при увеличении атомарного веса ширина запрещенной зоны уменьшается?
Почему введение в кремний (германий) примесных атомов, принадлежащих к пятой группе периодической системы элементов приводит к появлению свободных электронов в зоне проводимости?
Почему введение в кремний (германий) примесных атомов, принадлежащих к третьей группе периодической системы элементов приводит к появлению свободных дырок в зоне проводимости?
Почему дырки в полупроводнике часто называют квазичастицами?
Лекция 3
1.2.4. Расчет концентрации носителей заряда в кристалле.
Приводимость любых твердых тел определяется прежде всего концентрацией в них электронов и дырок способных переносить заряд. Концентрация носителей заряда (этим термином будем обозначать только свободные электроны и дырки) должна зависеть от температуры, поскольку с увеличением температуры возрастает тепловая энергия решетки и следовательно вероятность того, что какая то часть валентных связей будет нарушена и соответственно возникнут электроны и дырки.
Перечислим основные положения модели, которая используется для расчета концентрации носителей заряда в кристаллах:
кристалл является квантовой системой, поэтому поведение всех находящихся в нем электронов (и дырок) подчиняется закономерностям квантовой механики, т.е. как локализованные (привязанные к атомам), так и “свободные” (способные перемещаться по кристаллу) электроны находятся в определенных квантовых состояниях, характеризуемых соответствующими энергетическими уровнями;
в кристалле имеются состоящие из большого количества (1022 эВ-1см-3) близко расположенных уровней зоны (расстояние между уровнями порядка 10-22 эВ);
на одном энергетическом уровне в соответствии с принципом запрета Паули не может находиться более двух электронов с разным значением спина, т.е. электроны не могут перемещаться по состояниям занятым другими электронами;
в термодинамическом равновесии электроны распределяются по энергетическим состояниям в соответствии с функцией распределения Ферми - Дирака:
(1.10)
где f(E,T) – вероятность нахождения электрона в состоянии с энергией E, T –температура системы (в градусах К), k – постоянная Больцмана, F – энергия уровня Ферми (это характеристическая энергия системы ниже которой при T = 0K все состояния заполнены выше пустые );
поскольку энергетические уровни в разрешенных зонах очень близко расположены друг друга можно дискретное распределение состояний по энергиям заменить непрерывным N(E).
На рис. 1.13 показан вид функции Ферми-Дирака при различных значениях температуры.
Рис. 1.13. Вид функции вероятности распределения по состояниям для различных температур
Как видно из (1.10) и рис. 1.13 вероятность нахождения частицы на уровне с элегией F всегда равна Ѕ при всех температурах. В то же время по мере роста температуры вероятность появления частиц выше уровня Ферми возрастает. При температурах отличных от нуля, если E - F > kT, то функция Ферми-Дирака хорошо представляется экспоненциальной зависимостью (область в квадрате на рис. 1.13). Соответствующее распределение называется распределением Больцмана:
(1.11)
Используя сделанные допущения возможно рассчитать количество электронов находящихся в заданном энергетическом интервале ΔE = E2 -E1:
(1.12)
где N(E) – распределение плотности энергетических состояний по энергиям, f(E) – вероятность нахождения электрона на уровне с энергией E.
В качестве примера на рис. 1.12 показано как используя функцию распределения f(E) и функцию плотности состояния (N(E)~E1/2) определить распределение электронов по энергиям в металле.
Рис. 1.12. Схема расчета распределения электронов по энергиям в металле (или вырожденном полупроводнике) при использовании зависимостей N(E), f(E)? n(E)=N(E)f(E)
На рис. 1.12 (нижний график) показано распределение электронов характерное для металлов или вырожденных полупроводников, т.е полупроводников имеющих настолько высокую концентрацию примесей, что в них уровень Ферми попадает в разрешенную зону и их проводимость становится близкой к металлической. Из распределения рис. 1.12 можно сделать один важный вывод, то в проводимости металлов могут участвовать не все электроны, а только те энергия которых лежат вблизи уровня Ферми (в объемном случае вблизи поверхности Ферми). Действительно в электрическом поле электрон приобретает энергию, следовательно он должен перемещаться на уровень расположенный выше его начального состояния, а сделать это возможно только в том случае, если лежащий над ним уровень не занят (запрет Паули), такая ситуация имеет место только для электронов расположенных в энергетической области непосредственно примыкающей к уровню Ферми.
В собственных полупроводниках и не вырожденных легированных полупроводниках вероятность нахождения электронов в зоне проводимости мала (много меньше 0,5), вероятность нахождения электрона в валентной зоне велика (много больше 0,5), следовательно уровень вероятность нахождения электрона на котором равна 0,5 (уровень Ферми) должен находиться между зоной проводимости и валентной зоной, т.е. лежать в запрещенной зоне. Действительно для невырожденных полупроводников уровень Ферми всегда находится в запрещенной зоне и для расчета концентрации электронов находящихся в зоне проводимости и дырок находящихся в валентной зоне можно вместо уровня Ферми воспользоваться распределением Больцмана.
Рассчитаем концентрацию электронов проводимости:
(1.13)
где Nc – эффективная плотность состояний в зоне проводимости, она зависит от форма зоны - Е(p) и температуры (слабо).
, (1.14)
где mn* - эффективная масса электронов в зоне проводимости, m – масса о электрона, k- постоянная Больцмана, h- постоянная Планка [1].
Для того, чтобы рассчитать количество дырок в зоне проводимости учтем, что вероятность заполнения энергетического уровня дыркой равна:
(1.14)
Рассчитаем концентрацию дырок в валентной зоне:
(1.15)
где Nv – эффективная плотность состояний в валентной зоне.
(1.16)
Рассчитаем концентрацию электронов и дырок в собственном полупроводнике. Для этого мы должны определить для него положение уровня Ферми. Положение уровня Ферми в полупроводниках определяется из условия электронейтральности.
(1.17)
Откуда получим:
(1.18)
Поскольку (Ec+Ev)/2 >>(kT/2)ln(Nv/Nc), то мы получили, что в собственном полупроводнике уровень Ферми лежит примерно посередине запрещенной зоны и его положение слабо зависит от температуры.
Обозначим концентрацию носителей в собственном полупроводнике через ni2 и рассчитаем чему равно произведение концентрации электронов и дырок, а так же значение ni2:
(1.19)
Т.е. концентрация электронов и дырок растет с температурой по экспоненциальному закону с показателем равным половине ширины запрещенной зоны. Эту зависимость удобно представлять на графиках откладывая по вертикальной оси концентрацию в логарифмическом масштабе, а по горизонтальной обратную температуру 1/T (обычно откладывают 1000/T). Действительно прологарифмировав первое выражение (1.17) получим:
(1.20)
Соответствующие зависимости для Ge, Si и GaAs показаны на рис. 1.13.
Рис. 1.14. Зависимость концентрации носителей от температуры
Поскольку ni является некоторой характеристической величиной для полупроводникового материла из соотношения np = ni2 следует, что увеличение концентрации электронов за счет легирования материла будет приводить к уменьшению концентрации дырок и наоборот увеличение концентрации дырок при введении акцепторной примеси будет приводить к уменьшению концентрации электронов. Таким образом это соотношение позволяет по известной концентрации основных носителей заряда рассчитать значения концентрации неосновных.
Рассмотрим как влияет легирование на концентрацию носителей заряда и их температурную зависимость. Соотношения (1.13) и (1.15) показывают, что между концентрацией носителей заряда и положением уровня Ферми в образце существует однозначное соответствие:
Зная концентрацию носителей мы можем определить положение уровня Ферми (из 1.15 и 1.16 ):
(1.21)
Рассмотрим как изменяется концентрация носителей заряда и положение уровня Ферми в легированном полупроводнике. Вначале рассмотрим электронный полупроводник (n - тип), который получен легированием донорной примесью, c соответствующим энергетическим уровнем Ed. На рис. 1.15 показано ожидаемое изменение с температурой положения уровня Ферми (изменением с температурой ширины запрещенной зоны и положения донорного уровня в виду малости этих величин можно пренебречь).
Поскольку при температурах близки к 0К все донорные уровни заполнены электронами (f = 1), а зона проводимости свободна от электронов (f = 0), то уровень Ферми (f = 1/2) должен находиться между этими двумя уровнями (функция Ферми-Дирака непрерывна), т.е. в запрещенной зоне. При повышении температуры электроны начинают переходить с донорного уровня зоны в зону проводимости, переходами из валентной зоны для температурной области 1 можно пренебречь. Энергетическая конфигурация для этого случай такая же как для собственного полупроводника с шириной запрещенной зоны Ec-Ed, в котором вместо эффективная плотность состояний в валентной зоне равна Ed, поэтому для расчета концентрации электронов и уровня Ферми в этой области мы можем воспользоваться формулой (1.13), сделав соответствующие замены:
(1.22)
Из (1.22) видно, что при температурах близких к 0K уровень Ферми находится посередине между Eси Ed и затем по мере ухода электронов с примесного уровня (переходы 1 на рис. 1.15) приближается к уровню Ed. При некоторой температуре Ts уровень Ферми достигнет уровня Ed концентрация электронов в зоне проводимости будет равна Nd/2 (f=1/2). При дальнейшем увеличении температуры почти все электроны с донорного уровня оказываются в зоне проводимости и донорный уровень больше не может поставлять электроны в зону проводимости, поэтому эту температурную область (2 на рис. 1.15) называют областью истощения примеси. В области 2 концентрация электронов с ростом температуры увеличивается только за счет электронных переходов из валентной зоны (как в собственном полупроводнике):
n (T) = Nd + ni(T) (1.23)
Соответственно для уровня Ферми в этой области мы можем записать см. (1.21):
(1.24)
Начиная с некоторой температуры Ti начинает выполняться условие ni>Nd, с этого момента имеет место переход от примесной проводимости к собственной. При дальнейшем увеличении температуры будет выполняться условие ni>>Nd (область 3) и членом Nd в (1.24) можно пренебречь. Тогда (1.24) преобразуется к виду:
Эту формулу мы уже получали для собственного полупроводника см. (1.18). Таким образом в области высоких температур концентрация носителей заряда для легированных материалов стремится к концентрации носителей в собственном материале, т.е. легирование перестает оказывать влияние на концентрацию носителей, поскольку число электронов и дырок, генерируемых в результате переходов из зоны проводимости становится значительно больше концентрации введенной примеси (и соответственно концентрации носителей заряда полученных при ее ионизации).
Рис. 1.15. Диаграмма, поясняющая изменение положения уровня Ферми с температурой, и возникновения трех различных областей изменения с температурой концентрации носителей в донорном полупроводнике.
Из рис. 1.15 видно, что по характеру поведения уровня Ферми температурой можно выделить три основные области: область собственной проводимости (1), область истощения примеси (2) и область вымораживания примеси.
Рис. 1.16. Температурные зависимости концентрации электронов в кремнии при различной степени легирования донорной примесью. Концентрация доноров в см-3 проставлена около соответствующих кривых.
Областям с различным поведением уровня Ферми должно соответствовать и различное поведение концентрации носителей заряда см. (1.13) и (1.15) –основные формулы для расчета концентрации носителей заряда. На рис. 1.16 схематически показано как будет изменяться с температурой концентрация носителей заряда в легированных полупроводниках (зависимости будут аналогичны для материала легированного электронами и дырками). Представленные на рисунке графики отличаются степенью легирования, при увеличении степени легирования изменяются не только значения концентрации в примесной области, но и значение температуры перехода к области истощения Ts и к собственной проводимости Ti. Следует отметить, что поскольку в большинстве полупроводниковых приборов используются легированные полупроводники, то как правило их температурный диапазон определяется областью истощения примеси Ts < T < Ti , в которой концентрация основных носителей заряда слабо зависит от температуры (к сожалению это не справедливо для неосновных носителей).
Рис. 1.17. Диаграмма, поясняющая способ определения положения уровня Ферми по температурной зависимости концентрации примеси в образце кремния.
Контрольные вопросы.
Каковы основные положения положены в основу статистики Ферми-Дирака (Больцмана), используемой для расчета зависимости концентрации электронов и дырок от температуры?
Почему в полупроводниках чрезвычайно важно учитывать температурную зависимость концентрации носителей заряда (в металлах ее часто не учитывают, полагая постоянной )?
Какова вероятность заполнения электронами энергетического уровня с энергией соответствующей энергии Ферми (уровня Ферми)?
В какой зоне расположен уровень Ферми в металлах?
Где распложен уровень Ферми в чистых бездефектных (собственных полупроводниках)?
Перечислите основные отличия температурной зависимости концентрации носителей заряда в легированных и нелегированных полупроводниках.
В какой области температур концентрации свободных носителей заряда для легированных и нелегированных полупроводников будут мало различаться?
Как можно, имея экспериментальную зависимость концентрации электронов от температуры определить степень легирования материала донорной примесью?
Как можно, имея экспериментальную зависимость концентрации электронов от температуры определить положение уровня Ферми для любой температурной точки?
Постройте зависимость концентрации носителей заряда от положения уровня Ферми в германии, легированным донорной примесью (например P) до концентрации 1015 см-3.
Постройте зависимость концентрации носителей заряда от положения уровня Ферми в германии, легированным акцепторной примесью (например In) до концентрации 1015 см-3.
Лекция 4 1.2.5. Зависимость скорости электрона от напряженности электрического поля. Понятия эффективной массы и подвижности.
электрический ток в образце зависит не только от концентрации носителей заряда, но и от скорости с которой они переносятся под действием электрического поля. После того как мы научились рассчитывать концентрацию свободных носителей в твердом теле рассмотрим как ведут себя носители заряда в кристалле при наложении на него электрического поля.
Рассмотрение начнем с поведения единичного свободного заряда в нейтральной не взаимодействующей с зарядом среде (допустим в вакууме) при наличии электрического поля E, которое накладывается на среду в момент t=0. Электрическое поле приводит к возникновению силы электростатического взаимодействия F, под действием которой электрон начнет ускоряться.
, (1.25)
где q, m – заряд и масса электрона, v и a его скорость и ускорение. Таким образом в электрическом поле заряженная частица разгоняется с постоянным ускорением пропорциональным напряженности электрического поля и обратно пропорциональным ее массе. При этом энергия частицы будет изменяться со временем по квадратичному закону относительно импульса частиц или ее волнового вектора k (p= ћ k, где ћ = h/(2π), h – постоянная Планка).
(1.26)
Поскольку приобретаемая заряженной частицей энергия не зависит от направления электрического поля зависимость (1.5) симметрична относительно импульса и волнового вектора (это параболоид выпуклость которого определяется массой частицы).
Измерив зависимость энергии частицы от импульса (или волнового числа мы можем ) используя (1.5) определить эффективную массу. Действительно дважды продифференцировав (1.5) получим.
(1.27)
Предположим, что на частицу действует некоторая тормозящая сила F* о существовании которой мы не знаем. Тогда уравнение (1.4) можно переписать в следующем виде:
(1.28)
Соответственно, если для определения массы электрона (или любой другой заряженной частицы) в некоторой взаимодействующей с частицей среде воспользуемся формулой (1.6), то вместо массы электрона будет рассчитана некоторая другая величина, которую будем назвать эффективной массой электрона в данной среде.
(1.29)
Поскольку при движении электронов (или других заряженных частиц) в твердом теле внутренние поля неизвестны, то их характеристики используют понятие эффективной массы.
Рис. 1.18. Изменение скорости заряженной частицы в электрическом поле, при отсутствии взаимодействия со средой(1) и при торможении частицы средой.
На рис. 1.5 показано как будет со временем изменяться скорость свободной частицы в электрическом поле, в соответствии с (1.4) и (1.7 ). Эти формулы справедливы для случая, когда заряженная частица не испытывает столкновений и в соответствии с ними частицу можно разогнать электрическим полем до бесконечной энергии. Именно этот принцип был использован в первых линейных ускорителях элементарных частиц.
По мере разгона частицы возрастает ее импульс и соответствующее ему волновое число (величина, характеризующая величину волнового вектора). На рис. 1.6. показаны соответствующие зависимости изменения энергии частицы от величины волнового числа (импульса).
Рис. 1.19. Зависимости энергии свободных зарядов от величины их волнового числа (импульса).
Как видно из рис. 1.18. и рис. 1.19 набираемая в электрическом поле энергия частицы зависит от скорости частицы (волнового числа) и массы. Поскольку выпуклость кривой характеризуется ее второй производной можно сделать вывод, что чем меньше эффективная масса частицы, тем больше выпуклость, см. (1.27) и (1.29).
В кристалле энергия электрона (дырки) в разрешенной зоне не может превысить значение потолка разрешенной зоны, следовательно импульс и волновой вектор так же имеют ограничения, причем максимальное значение волнового числа должно быть кратно постоянной решетки. На рис. 1.20 показана рассчитанное изменение энергии электрона от величины волнового числа (значения) импульса для кубического кристалла.
Рис. 1.20. Зависимость энергии от волнового числа (импульса) в кристалле (a – постоянная решетки вдоль заданного направления)
Из рисунка видно, что в электронном представлении у потолка валентной зоны знак эффективной массы изменяется (должно происходить отражение частицы). Следует отметить, что у дна зоны проводимости энергия имеет параболическую зависимость от импульса (волнового числа):
(1.31)
Если вести отсчет от дна зоны проводимости Ec = 0, то зависимость энергии электрона от импульса (волнового вектора) будет такая же как для свободного электрона см. (1.26). Это дает нам основание рассматривать электроны в зоне проводимости, находящиеся вблизи дна зоны проводимости как свободные частицы (иногда говорят квазисвободные или квазичастицы), считая что они подчиняются тем же закономерностям, что и свободные частицы, но отличаются от них величиной эффективной массы, которую вблизи дна зоны можно считать постоянной (пока выполняется параболическое приближение).
Аналогичный подход справедлив и для дырки. Вводя дырку мы переходим от электронного представления к дырочному, т.е. мы принимаем, то масса дырки положительная, а заряд отрицательный и энергия ее отсчитывается от потолка валентной зоны к ее дну, тогда дырка будет вести себя так же как электрон у потолка валентной зоны. При этом энергия дырки у потолка валентной зоны так же изменяется по параболическому закону как и для электрона:
(1.32)
Таким образом дырку, находящуюся потолка валентной зоны так же можно рассматривать как свободную частицу.
В реальной жизни электрон в электрическом поле не может набирать энергию до бесконечности, рано или поздно он столкнется с другой частицей и отдаст ей накопленную энергию. Вероятность столкновений частиц в газах и твердых телах характеризуется временем или длиной их свободного пробега. Эти же величины характеризуют движение носителей заряда в твердом теле.
Схема, приведенная на рис. 1.21 показывает изменение скорости электрона в образце, к которому приложено напряжение и поясняет физический смысл подвижности. Электрон участвует в хаотическом тепловом движении, причем в различные моменты времени его скорость имеет случайное направление так что смещение его в любом направлении равновероятно. В электрическом поле электрон приобретает дополнительную скорость под действием поля, так что продолжая участвовать в тепловом движении он постепенно смещается под действием поля. Средняя скорость тем выше, чем больше длина свободного пробега и чем меньше эффективная масса частицы.
Рис. 1. 21. Диаграмма, поясняющая движение электрона в твердом теле
Поскольку электрон набирает энергию в поле за время свободного пробега и отдает ее при столкновении с решеткой или другими носителями заряда, то средняя скорость, которую приобретают носители в направлении поля, будем называть ее скоростью дрейфа зарядов vдр должна зависеть от средней длины свободного пробега τ.
(1.36)
Коэффициент пропорциональности между дрейфовой скоростью и напряженностью электрического поля обычно называют подвижностью носителей зарядаи обозначают μ:
μ=qτ/m* (1.37)
Как видно из (1.36) и (1.37) подвижность имеет размерность в системе СИ м2/(Вс) , широко так же используются значения подвижности с размерностью см2/(Вс).
Предположим, что ток через ток образце создается электронами концентрация которых n см-3 и средняя дрейфовая скорость vдр.Поскольку величина тока равна заряду, проходящему через сечение образца в единицу времени можем записать:
I=Sqnvдр=SqnμE (1.38)
Для единичной площади из (1.35) получится уравнение для плотности тока:
J = qμnE(1.39)
Поскольку в дифференциальной форме закон Ома имеет вид:
J = σE, (1.40)
где σ – электропроводность образца (Ом.м или Ом.см )
Сравнив (1.39) и (1.40) получим формулу для электропроводности:
σ = qμn (1.41)
Если электрический ток создается различными носителями (всего N типов) с концентрацией каждого типа ni, то:
(1.42)
таким борзом мы видим, что проводимость материала определяется двумя основными параметрами: подвижностью носителей заряда и их концентрацией.
Величина подвижности пропорциональна длине свободного пробега, которая зависит от частоты столкновений носителей заряда с решеткой или атомами примеси. Поскольку при столкновениях носители отдают энергию, а затем вновь набирают, т.е. энергия носителя релаксирует, то принято говорить о механизмах ее релаксации. За время релаксации принимают среднее время в течение которого электрон полностью отдает свою энергию.
Существует множество механизмов рассеяния (релаксации ) энергии свободных носителей заряда. Однако, для полупроводников, наиболее существенные два: рассеяние на решетки и рассеяние на ионизованной примеси.
Для рассеяния на решетке справедливо :
μr = μr0T-3/2, (1.43)
т.е. μr ~ T-3/2 и с ростом температуры подвижность носителей падает. Действительно длина свободного пробега носителей заряда тем меньше, чем сильнее колеблется решетка l ~ 1/T , для скорости носителей справедливо v ~ T1/2 (mv2=3kT), μr ~ τ = l/v ~ 1/T3/2. Таким образом рост, в случае если доминирует рассеяние на решетке (примесей мало), то с ростом температуры подвижность падает и следовательно падает проводимость ( как это имеет место в металлах).
При рассеянии на заряженной примеси μi ~ τ ~ T3/2 .
μi = μi0T3/2 (1.44)
Таким образом, если в образце доминирует рассеяние на примесях, то с ростом температуры подвижность возрастает и соответственно возрастает проводимость.
Значения множителей μr0 и μi0 зависят от химического состава материала, наличия в нем дефектов и примесей, степени их ионизации (для разных образцов одного материала эти значения могут быть различными).
При одновременном действии нескольких механизмов рассеяния для расчета подвижности можно воспользоваться понятием эффективной подвижности носителей, которая будет определяться всеми, имеющими место механизмами рассеяния. Для случая, когда доминирует рассеяние на колебаниях решетки и ионизованной примеси для эффективной подвижности можно записать (считая, что акты рассеяния - независимые события):
(1.45)
На рис. 1.21 схематически показана зависимость эффективной подвижности от температуры в полупроводниковом материале с разной концентрацией примеси. Графики построены в соответствии с формулами (1.43) и (1.45). Кривая 1 соответствует образцу без примесей. Кривые 2, 3, 4 образцам с разным содержанием примеси (большему номеру соответствует большее содержание примеси). На этом же график приведены соответствующие кривые для чисто решеточного μr и примесного рассеяния: μr2 , μr3, μr4.
Характер изменения электропроводности полупроводников с температурой, в том случае, если не изменяется концентрация носителей заряда будет определяться температурной зависимостью подвижности и зависимости будут аналогичны показанным на рис. 2 (это может быть в примесной области температурной зависимости проводимости).
Рис. 1.21. Диаграмма, поясняющая температурную зависимость подвижности μef, при рассеянии на решетке μr и ионизированной примеси μiK.
1.2.6. Расчет электропроводности полупроводниковых кристаллов на основе рассмотренных моделей.
Электропроводность полупроводникового кристалла определяется электропроводностью электронов и дырок, поэтому для нее, используя (1.42) можно записать:
σ = σn+σp = qμnn + qμpp = q(μnn + μpp) (1.46)
Как видно из (1.46) электропроводность полупроводника зависит от концентрации носителей заряда и подвижности, значения которых зависят как от технологии так и температуры.
Собственный полупроводник.
Для чистого бездефектного кристалла с проводимостью близкой к собственной справедливо n = p = ni см. (1.19), тогда для электропроводности собственного полупроводника можно записать:
(1.50)
Поскольку σ0(T) слабо зависит от температуры в оценочных расчетах принимают предэкспонциальный множитель постоянным равным значению электропроводности при T→∞. Формула (1.50) хорошо описывает экспериментальную кривую электропроводности для чистых кристаллов с совершенной структурой (см. рис. 1.1. ) и из экспериментальной зависимости используя соотношение (1.50) можно определить такие характеристические параметры материала как Eg и σ0.
Легированный полупроводник.
Для легированного кристалла можно выделить несколько температурных областей как для изменения с температурой концентрации (см. п.п. 1.2.4 рис. 1.16 ), так и для изменения с температурой подвижности носителей заряда (см п.п. 1.2.5 рис. 1.21). При этом в области, где доминирует примесная приводимость ni(T)n и соответственно будут иметь место следующие уравнения.
(1.68)
Каждое из приведенных уравнений является частным случаем более общего уравнения (1.66) и используется для анализа процессов в полупроводниковых материалах и приборах именно для частных случаев, что значительно упрощает поиск возможного решения. Решение уравнения (1.66) достаточно в общем виде весьма сложно и, если это требуется по условиям задачи, то обычно выполняется численными методами с использованием соответствующих компьютерных программ.
Аналогично для n типа n>>p Для p соответственно будут иметь место
следующие уравнения:
(1.69)
Воронков Э.Н. Твердотельная электроника. 2002г.
Содержание
Лекция 6 67
2. ДИОДЫ. 67
2.1. Полупроводниковые диоды с электронно-дырочным переходом (pn - переходом). 67
2.2. Электронно-дырочный переход (pn – переход). Возникновение потенциального барьера. Контактная разность потенциалов. 71
Лекция 7 79
2.3. Вольтамперная характеристика pn перехода 79
2.4. Влияние генерационно-рекомбинационных процессов на ВАХ pn перехода. 92
Лекция 8 93
2.5. Барьерная емкость pn перехода 93
2.6. Диффузионная емкость pn перехода 97
Лекция 9 101
2.7. Переходные процессы 101
2.6. Пробой pn перехода 109
Лекция 6 2. ДИОДЫ.
2.1. Полупроводниковые диоды с электронно-дырочным переходом (pn - переходом).
Простейшим полупроводниковым прибором является диод, представляющий полупроводниковый кристалл с электронно-дырочным (pn) переходом. На рис. 2.1. приведены обозначение диода, его конструкция и диаграмма распределения примеси. Вблизи контактов, как правило, концентрация примеси и соответственно основных носителей заряда повышена. Это сделано для того, чтобы снизить сопротивление между металлическим контактом и полупроводниковой областью. Основным элементом диода является электронно-дырочный переход (pn-переход) .
Рис. 2.1. Полупроводниковый диод с pn-переходом: обозначение, конструкция, распределение примеси
Электронно-дырочный переход - основной элемент не только диодов, но и других биполярных приборов, поскольку именно электронно-дырочный переход позволяет управлять потоками носителей заряда в биполярных приборах. Электронно-дырочный переход создают в кристалле изменением типа проводимости, путем введения соответственно акцепторной и донорной примеси.
Существует большое количество способов создания pn перехода. На рис. 3.2. представлены схемы сплавной, диффузионной и эпитаксиально-диффузионной технологий.
Рис. 2.2. Схемы изготовления pn перехода различными технологическими способами.
При сплавной технологии электронно-дырочный переход образуется на границе раздела исходного кристалла и рекристаллизованной полупроводниковой области , в которую происходило вплавление (рис. 2.2а). На рис. 2.2б показан способ изготовления pn перехода диффузией акцепторной примеси в кристалл n-типа. Особенность технологии показанной на рис. 2.2.в в том, что диффузия осуществляется в кристалл с полупроводниковой пленкой n типа, выращенной на кристалле n+ типа специальной эпитаксиальной технологией, позволяющей сохранить структуру кристалла в пленке.
Особенность электрических характеристик диода в том, что он обладает низким сопротивлением при одной полярности приложенного к нему напряжения (плюс на аноде - прямое включение) и высоким сопротивлением при другой полярности (минус на аноде - обратное включение). Это свойство диода обеспечило ему широкое применение в выпрямителях - схемах преобразования переменного напряжения в постоянное.
На рис. 2.3. показана вольтамперная характеристика полупроводникового диода средней мощности – зависимость I(U), кривая 1.
Рис. 2.3. Вольтамперные характеристики полупроводникового диода (1) и идеального выпрямителя (2).
На том же рис. 2.3 приведена характеристика "идеального" ключа, который пропускает ток при положительном напряжении и не пропускает при отрицательном. Как видно из сравнения графиков, свойства полупроводникового диода близки к свойствам идеального выпрямителя, поскольку для него ток в прямом направлении может в миллионы раз быть больше тока в обратном направлении.
К основным недостаткам полупроводникового диода следует отнести: при прямом смещении - наличие области малых токов на начальном участке ("пятка") и конечного сопротивления толщи rs ; при обратном - наличие пробоя и небольшого (однако сильно возрастающего с температурой) обратного тока.
Следует обратить внимание на то, что прямая и обратная ветви вольтамперной характеристики представлены на рис. 2.3 в разном масштабе.
Рассмотрим работу диода на активную нагрузку (рис. 1.4). Соответствующая схема показана на рис. 2.4 а. Ток через диод описывается его вольтамперной характеристикой Iдиод = f(Uдиод) , ток через нагрузочное сопротивление будет равен току через диод Iдиод = Iнагр = I , поскольку соединение последовательное, и для него справедливо соотношение Iнагр = (U(t) - Uдиод)/Rн.
На рис. 2.4 показаны линии, описывающие эти функциональные зависимости: ВАХ диода и нагрузочную характеристику.
Рис. 2.4. Диаграмма, поясняющая работу диода на активную нагрузку.
Как видно из рисунка, чем круче характеристика диода и чем меньше зона малых токов ("пятка"), тем лучше выпрямительные свойства диода. Заход рабочей точки в предпробойную область приводит не только к выделению в диоде большой мощности и возможному его разрушению, но и к потере выпрямительных свойств.
При электротехническом анализе схем с диодами отдельные ветви ВАХ представляют в виде прямых линий, что позволяет представить диод в виде различных эквивалентных схем, см. рис. 2.5. Выбор той или иной схемы замещения диода определяется конкретными условиями анализа и расчета устройства, в котором он применяется.
Рис. 2.5. Эквивалентные схемы диода при прямом и обратном включении.
Выпрямительные свойства полупроводникового диода обусловлены асимметрией электрических свойств его основного элемента pn - перехода.
Диоды с pn переходом относят к биполярным приборам, поскольку в процессах переноса заряда через контактную область участвуют как электроны так и дырки.
Рассмотрим основные явления, которые приводят к возникновению на границе между p и n областями потенциального барьера (запирающего слоя), определяющего нелинейность вольтамперной характеристики (ВАХ) диода.
2.2. Электронно-дырочный переход (pn – переход). Возникновение потенциального барьера. Контактная разность потенциалов.
На рис. 2.6 представлены энергетические диаграммы для легированных акцепторной примесью (p тип) и донорной примесью (n тип) двух полупроводниковых кристаллов одного и того же материала, находящихся на близком расстоянии, но не взаимодействующих друг с другом.
Как это иллюстрирует диаграмма рис. 2.6 материал p и n типа отличается положением уровней Ферми - Fp и Fn, и соответственно работой выхода Фp и Фn. За работу выхода электронов в полупроводниках принимают энергетическое расстояние от уровня Ферми до энергетического уровня соответствующего энергии электрона находящегося в вакууме с нулевой кинетическое энергией (нулевой уровень). Эту работу выхода иногда называют термодинамической, поскольку в отличие от металла, на уровне Ферми в полупроводнике в том случае, если нет соответствующих этому уровню энергетических состояний, электроны никогда не будут находиться.
Электроны могут находиться в зоне проводимости и энергию χ необходимую для того, чтобы вывести электрон со дна зоны проводимости в вакуум называют сродство к электрону.
Рис. 2.6. Энергетическая диаграмма: (а) изолированные p и n области,
(б) pn - переход.
При создании pn перехода - тесного между p и n областями тесного физического контакта (с единой кристаллической решеткой), между областями устанавливается обмен электронами, причем из материала n типа выходят преимущественно электроны, а из материала p типа преимущественно дырки (выход из кристалла дырки соответствует входу в кристалл электрона).
Не эквивалентность потоков электронов из n в p область и из p в n область приводит к тому, что на границе раздела появляется пространственный заряд. В n области заряд будет положительный , поскольку из нее уходят “примесные” электроны и остается не скомпенсированный положительный заряд ионов донорной примеси. В p области заряд будет отрицательный, поскольку из нее уходят “примесные” дырки и остается не скомпенсированный отрицательный заряд ионов акцепторной примеси. Таким образом на границе раздела (в pn переходе) возникает двойной заряженный слой, что иллюстрирует диаграмма рис. 2.7. При этом положительный заряд в p области равен отрицательному заряду в n области, так что образец в целом остается электронейтральным. Действительно общее число положительных и отрицательных зарядов в образце при возникновении области пространственного заряда (ОПЗ) не изменяется, однако происходит их перераспределение в локальной области pn перехода, внутри которой электронейтральность нарушается.
Р
ис.
2.7. Диаграмма,
поясняющая
возникновение
области пространственного
заряда (двойного
заряженного
слоя) в pn переходе
Возникшее контактное электрическое поле направлено от области с донорной примесью к области с акцепторной примесью, поэтому оно препятствует переходу электронов из n области и дырок из p. При некотором значении поля установится равновесие, когда количество зарядов переходящих навстречу друг другу одинаково. Этому электрическому полю соответствует равновесное значение контактной разности потенциалов.
Для нахождения контактной разности потенциалов, можно воспользоваться тем условием, что в неоднородных системах находящихся в равновесии уровень Ферми (химический потенциал) один и тот же для всех частей системы, как это показано на рис. 2.6 б для pn перехода, выполненного в едином кристалле.
Области, находящиеся на удалении от места контакта p и n областей не подвержены влиянию pn перехода, поэтому их должна характеризовать энергетическая диаграмма показанная для изолированных областей рис. 2.6а. Как видно из рис. 2.6б потенциальная энергия электронов в зонах относительно нулевого уровня в вакууме изменяется только за счет возникновения в области pn перехода пространственного заряда и соответствующего ему потенциального барьера. Как видно из диаграмм рис 2.6а и рис 2.6б величина контактной разности потенциалов равна:
, (2.1)
где Uк выражена в вольтах, а Fn и Fp в электронвольтах.
Возникновение двойного слоя пространственного заряда и соответствующего ему обусловленного контактным полем потенциального барьера нарушает симметрию транспорта через pn переход дырок и электронов. Действительно барьер существует только для основных носителей (nn и pp), поскольку в соседнюю область они перемещаются против сил электростатического взаимодействия с полем. Соответственно барьер смогут преодолеть только те носители nn и pp, тепловая энергия которых выше энергии потенциального барьера, т.е. носители попадающие в высокоэнергетический хвост распределения Больцмана (аналог распределения Максвелла в газах).
Чем выше высота потенциального барьера тем, меньше основных носителей сможет его преодолеть. Поскольку основные носители перемещаются через границу диффузионным механизмом их ток часто называют диффузионным, при этом следует обратить внимание (см. рис 2.7), что направления диффузионных токов, создаваемого nn и ppсовпадают: Jдиф = Jnдиф + Jpдиф.
Для неосновных носителей (np и pn) потенциального барьера нет, поскольку направление сил их электростатического взаимодействия с контактным полем совпадает с направлением их перехода в соседнюю область, см. рис. 2.7 и рис. 2.6. Поэтому поток неосновных носителей зависит только от их концентрации в приконтактной области и не зависит от высоты барьера. Все неосновные носители, попавшие в область пространственного заряда pn перехода будут подхвачены электрическим полем и переброшены в соседнюю область. Следует обратить внимание (см. рис 2.7), что направление тока Js , создаваемого неосновными носителями np и pn, дрейфующими в электрическом поле pn перехода совпадают: Js = Jsn + Jsp. Поскольку суммарный ток через pn переход в отсутствии внешнего напряжения должен быть равен нулю, то Jдиф = -Js.
Рассмотрев основные явления, связанные с возникновением в pn переходе потенциального барьера и его влияния на транспорт носителей заряда, приступим к количественному описанию цель которого заключается в построении математической модели, которая могла бы связать электрические характеристики перехода с технологическими параметрами областей и температурой окружающий среды.
Используя соотношения, полученные в предыдущем разделе запишем соотношения для расчета основных и неосновных носителей заряда в p и n областях через значения уровня Ферми в соответствующих областях (рис. 2.6). Обозначим равновесные концентрации индексом 0.
(2.2)
Используя (2.2) возьмем отношения nn0/np0 и pp0/pn0, после логарифмирования получим:
Откуда рассчитаем разность уровней Ферми и используя (2.1) получим:
(2.3)
Эта формула однозначно связывает высоту потенциального барьера (при отсутствии внешнего напряжения) с концентрациями носителей в прилегающих к переходу областях, и наоборот концентрации носителей вблизи pn перехода с напряжением на нем:
, (2.4)
где ut=kT/q. Уравнение (2.4) можно рассматривать как граничные условия при нулевом внешнем напряжении U = 0.
Поскольку концентрация основных носителей примерно равна концентрации легирующей примеси (pp0 = Na, nn0 = Nd), и произведение равновесных концентраций электронов и дырок в одной области при заданной температуре равно квадрату концентрации собственных носителей заряда nn0pn0=pp0np0=ni2 (11/19) , то из (2.3) получим:
(2.4)
Таким образом потенциальный барьер в pn переходе тем выше, чем сильнее легированы p и n области. Соответствующая зависимость Uк от степени легирования областей показана на рис. 2.8.
Рис. 2.8. Зависимость контактной разности pn перехода уровня легирования областей pn перехода (Si, Т=300 К)
Из формулы (2.4) следует, что чем сильнее легированы области pn перехода, тем больше контактная разность потенциалов. С физической точки зрения это понятно: с увеличением степени легирования p области уровень Ферми приближается к валентной зоне, с увеличением степени легирования n области уровень Ферми приближается к зоне проводимости, в то же время как следует из диаграммы рис. 2.6 контактная разность равна разности уровней Ферми в изолированных p и n областях.
Диаграмма рис. 2.8 показывает, что при увеличении степени легирования областей контактная разность в пределе стремится к ширине запрещенной зоны Eg.
По мере роста температуры величина ni2 в (2.4) должно достигнуть постоянной величины NdNa. Таким образом выражение под знаком логарифма стремится к нулю, т.е. контактная разность потенциалов с ростом температуры уменьшается.
Этот результат понятен с физической точки зрения, поскольку с увеличением температуры возрастает вероятность межзонного возбуждения электронов, т.е. при высоких температурах начинает доминировать собственная проводимость как в p, так и в n области. Поскольку в собственных полупроводниках уровень Ферми лежит вблизи середине запрещенной зоны qUк = Fn – Fp в конечном счете стремится к нулю, как это иллюстрирует рис. 2.9, рассчитанный по (2.4) с учетом того, что ni = √NcNv exp(-Eg/kT).
Зависимость контактной разности потенциалов pn переходов от температуры часто используют для создания датчиков температуры. По чувствительности эти датчики будут уступать датчикам, использующим температурную зависимость электропроводности полупроводников (термисторы), однако к их достоинствам можно отнести близкую к линейной зависимость контактной разности потенциалов от температуры, что значительно облегчает их калибровку.
Рис. 2.9. Зависимость контактной разности pn перехода от температуры при разном уровне легирования областей (Si - кривая 1: NdNa=1032 , кривая 2: NdNa=1028)
Еще раз остановимся на физической природе явлений, приводящих к возникновению на границе между p и n областями потенциального барьера. Если бы между p и n областями не было контакта, то каждая из них была бы электронейтральна, при этом соблюдались бы следующие условия: pp = Na-, nn = Nd+. При наличии между p и n областями контакта свободные электроны будут уходить из n области в соседнюю, оставляя вблизи границы в n области нескомпенсированный заряд положительных доноров - Nd+. Свободные дырки будут уходить из p области в соседнюю, оставляя вблизи гранцы в p области нескомпенсированный заряд отрицательных акцепторов - Na-. Поскольку доноры и акцепторы связаны с решеткой возникший двойной слой заряда так же встроен в решетку и не может перемещаться. При этом в области пространственного заряда (ОПЗ) возникает электрическое поле, направленное от n области к p области, препятствующее переходу основных носителей через границу областей. Чем больше переходит основных носителей, тем больше в нескомпенсированный заряд в ОПЗ, тем выше энергетический барьер, препятствующий переходу. Равновесие наступает при некотором соотношении между высотой барьера и концентрацией носителей заряда, которое описывается (2.3). При этом следует отметить, что в самой барьерной области (области пространственного заряда) концентрация носителей мала (она близка к собственной), поскольку все попадающие в ОПЗ носители выбрасываются из этой области электрически полем. Поэтому область пространственного заряда обладает проводимостью на несколько порядков меньшей, чем легированные p и n области. В дальнейшем будем считать, что сопротивление областей вне ОПЗ на несколько порядков меньше, чем сопротивление ОПЗ и если к полупроводниковой структуре с pn переходом приложено внешнее напряжение, то оно падает, в основном на ОПЗ, а в прилегающих к переходу p и n областях электрического поля практически нет (при построении модели происходящих процессов мы будем им пренебрегать).
Внимательно проанализировав диаграммы рис. 2.1 и 2.2 можно еще раз убедиться, что направление контактного электрического поля (Еконт) таково, что оно препятствует диффузии в соседнюю область основных носителей заряда и способствует переходу неосновных. Именно эта асимметрия потенциального барьера по отношению к носителям различного типа в конечном счете и приводит к асимметрии вольтамперной характеристики электронно-дырочного перехода относительно полярности внешнего напряжения. Поскольку при одной полярности внешнего напряжения поле внешней батареи будет складываться с внутренним полем Еконт, увеличивая барьер, при другом вычитаться, уменьшая барьер.
Лекция 7 2.3. Вольтамперная характеристика pn переходаЕсли области pn перехода находятся при одной и той же температуре, при отсутствии приложенного к приложенного напряжения ток через него равен нулю, т.е. все потоки основных и неосновных носителей заряда компенсируют друг друга и встречные токи взаимно уравновешиваются. Однако, равновесие нарушается, если к диоду с pn переходом приложено внешнее напряжение. В этом случае обусловленное внешним источником напряжения электрическое поле складывается с внутренним контактным полем в переходе и, в зависимости от полярности внешнего источника, потенциальный барьере либо увеличивается либо уменьшается. При прямой полярности внешнего источника потенциальный барьер увеличивается и ток основных носителей заряда диффундирующих против электростатических сил поля pn перехода возрастает. При обратном включении внутреннее поле pn перехода складывается с внешним и величина потенциального барьера между p и n областями возрастает. Количество основных носителей способных преодолеть барьер уменьшается по мере роста высоты барьера и в конце концов становится равным нулю. Встречный ток Js создаваемый неосновными носителями, которые идут в направлении сил электростатического взаимодействия с полем pn перехода и для которых не существует потенциального барьера, при изменении высоты барьера остается постоянным, он не зависит от высоты барьера и его величина определяется только числом неосновных носителей попадающих в область пространственного заряда (np и pn).
Для того, чтобы на феноменологическом уровне описать вольтамперные характеристики диода с pn переходом допустим, что все приложенное к диоду внешнее напряжение падает на pn переходе. Поскольку сопротивление ОПЗ на несколько порядков выше, чем сопротивление толщи материала p и n областей и омических контактов к ним это допущение вполне оправдано. Тогда изменение величины барьера будет соответствовать величине приложенного напряжения. В соответствии с принятым ранее соглашением напряжение считается положительным, если плюс приложен к p области а минус к n, и отрицательны при обратной полярности внешнего напряжения относительно p и n областей. Тогда высоты барьера:
, (2.5)
где Uк- контактная разность потенциалов, U – внешнее напряжение.
Баланс токов через переход можно записать в виде:
(2.6)
где ut = kT/q, иногда эту величину называют тепловым потенциалом, поскольку kT – соответствует максимуму кинетической энергии электронов при температуре T. При T = 300К ut~ 26 мВ. Значение предэкспоненциального множителя в выражении для Jдиф принято равным Js, чтобы обеспечить при отсутствии напряжения на pn переходе равенство нулю общего тока.
Формула (2.6) удовлетворительно описывает ВАХ pn перехода и характеристики диода при малых токах, когда падение напряжения на прилегающих к переходу областях значительно меньше, чем падение напряжения на самом переходе. На рис. 2.10. показаны вольтамперные характеристики (слева в линейном масштабе, справа в логарифмическом), построенные по (2.6) при значении Js = 2 10-4 A .
При U>0 и U>utединицей в (2.6) можно пренебречь ипрямая ветвь pn перехода хорошо описывается экспоненциальной зависимостью J = Jsexp(U/ut).
Рис. 2.10. Вольтамперная характеристика pn перехода
Уравнение (2.6), описывающее вольтамперную характеристику pn перехода является феноменологическим, т.е. оно получено на основе рассмотрения явлений (явление – phenomena англ.) происходящих в диоде с pn переходом, но оно не дает нам возможности связать характеристику диода с электрофизическими параметрами его областей. К электрофизическим параметрам материала относятся те параметры, которые рассматривались в разделе 1, т.е. концентрация носителей заряда (примесей), время их жизни, подвижность и т.д. Уравнение (2.6) так же не дает ответ на вопрос о температурной зависимости тока, поскольку нам неизвестна температурная зависимость тока Js.
Для того, чтобы решать задачи устанавливающие количественную связь между характеристики полупроводникового прибора, его конструктивно-технлогическими параметрами и влиянием окружающей среды, необходимо создать количественную модель прибора. Для создания физико-математической модели необходимо записать уравнения связывающие между собой концентрации заряда, электрические токи (потоки) и электрический потенциал (или поле). Можно использовать три уравнения. Уравнение для тока как суммы диффузионного и дрейфового см. (1.57, 1.61):
(2.7)
Уравнение непрерывности см (1.66) , в дальнейшем будем рассматривать только одномерные модели, т.е. считать что концентрация носителей заряда, потенциала и всех параметров по сечению образца постоянны, тогда:
(2.8)
И уравнение Пуассона:
, (2.9)
где ρ(x) – распределение зарядов.
Как правило при создании моделей эти уравнения значительно упрощаются за счет принимаемых допущений.
Поскольку исходные уравнения носят дифференциальную форму для их решения необходимо задать начальные условия. Для биполярных приборов с pn переходом в качестве граничных условий задаются либо концентрация неосновных носителей заряда на границе, либо значение инжекционного тока (тока неосновных носителей заряда) на границе при напряжении на заданном электронно-дырочном переходе:
(2.10)
Граничные условия можно задать и в таком виде:
, (2.11)
т.е. задаются граничные концентрации, а напряжение на переходе определяется функциональной связью между концентрацией и высотой барьера.
Для того, чтобы записать граничные условия – зависимость концентраций неосновных носителей заряда от внешнего напряжения вернемся еще раз к вопросу о распределении носителей заряда в разрешенных зонах по энергиям.
Распределение электронов (дырок) по энергиям в разрешенных зонах определяется произведением плотности состояний на функцию распределения nn(E) = N(E)f(E) см. п.п. 1.2.4. Для невырожденных полупроводников c хорошей степенью точности можно считать, что в разрешенной зоне вероятность нахождения свободных носителей заряда в разрешенной зоне на высоких энергетических уровнях убывает с увеличением их энергии по экспоненте (в соответствии с распределением Больцмана), поэтому зависимость концентрации носителей от энергии имеет максимум вблизи дна зоны (он обусловлен произведением N(e)f(E) см. п.п. 1.2.4) и экспоненциальный спад в области высоких энергий. Потенциальный барьер pn перехода могут преодолеть только те основные носители (электроны nn или дырки pp) энергия которых равна или больше энергии потенциального барьера.
Будем считать что все приложенное внешнее напряжение U падает на pn переходе, тогда высота барьера Uбар = Uк – U см. (2.5). Связь граничной концентрации с высотой барьера должна иметь тот же вид, что и (2.4), поскольку при наложении напряжения Fn – Fp = qUбар = q(Uк - U):
(2.12)
Из (2.12) видно, что при приложении к переходу (диоду) прямого напряжения U>0 (часто говорят смещения, т.е смещения уровней Ферми пропорционального приложенному напряжению) концентрация неосновных носителей на границе возрастает экспоненциально с напряжением (происходит их инжекция из соседней области).
При приложении к переходу (диоду) обратного смещения U0 (рис. 2.13). При этом создаваемое внешней батареей электрическое поле уменьшает электрическое поле, создаваемое контактной разностью потенциалов и высота барьера уменьшается на величину напряжения батареи. Квазиуровни Ферми расходятся друг относительно друга на величину qU, но в другую сторону.
Как видно из (2.12) и рис. 2.13 прямое смещение в пределе ведет к исчезновению потенциального барьера, поэтому в пределе оно не может быть больше величины контактной разности потенциалов Uк. Действительно, в рассмотренной модели идеального pn перехода сопротивление примыкающих к переходу легированных областей полагалось равным нулю и ток через переход определялся только свойствами барьера, поэтому когда барьер исчезает (его сопротивление стремится к нулю), то ток через переход должен стремиться к бесконечности. Для реальных диодов он будет ограничиваться сопротивлением легированных областей на которых будет дополнительное падение напряжения и в результате прямое падение напряжения на диоде может превышать контактную разность потенциалов.
Рис. 2.13. Энергетическая диаграмма pn перехода, к которому приложено прямое (уменьшающее высоту барьера) напряжение батареи Uб.
При создании расчетной модели pn перехода примем ряд допущений (эту модель иногда называют моделью Шокли). Будем считать:
полагается, что концентрации носителей заряда и значения электрических полей по любому сечению образца постоянные, т.е. возможно применить одномерное рассмотрение задачи;
полагается, что приложенное к pn переходу внешнее напряжение падает в основном на области пространственного заряда и электрическое поле в примыкающих к переходу мало и им можно пренебречь;
полагается, что носители заряда проходят область пространственного заряда без рекомбинации, т.е. мы пренебрегаем генерационно-рекомбинационными процессами в области пространственного заряда, считая что токи создаваемые носителями заряда рекомбинирующими и возникающими за счет тепла в ОПЗ значительно меньше токов создаваемых переносом заряда через барьер как при прямом так и обратном включении перехода;
допускается, сто pn переход резкий, т.е. концентрация доноров и акцепторов на границе изменяется скачком (рис. 2.7);
допускается, что параметры материала как время жизни носителей заряда и их подвижность постоянные и не зависят от концентрации инжектированных носителей заряда. Поскольку постоянство параметров материала соблюдается при небольших уровнях инжекции будем считать, что в рассматриваемой модели соблюдаются условия: ∆pUT) граничная концентрация примерно равна нулю, все подходящие к ОПЗ неосновные носители перебрасываются в соседнюю область, а из соседней области носители не поступают, поскольку высота барьера много больше их тепловой энергии см. рис. 2.12.
Как видно из (1.67) уравнение непрерывности свелось к диффузионному уравнению и следовательно ток вблизи барьера в n-области будет, в основном диффузионным.
Из рис. 2.14 видно, что при положительном и отрицательном смещении градиент концентрации вблизи перехода имеет разный знак и соответственно при положительном смещении диффузионный ток направлен от перехода вглубь n - (имеет место инжекция неосновных носителей заряда), при отрицательном смещении направление тока изменяется на противоположное и происходит вытягивание неосновных носителей заряда
Рис. 2.14. Распределение носителей заряда в приконтактной области при положительном (кривая 1) и отрицательном (кривая 2) включениях pn перехода.
Рассчитаем плотность дырочного тока, проходящего через барьер при x = 0:
(2.72)
Аналогично, решая диффузионное уравнение для n области, можно получить плотность электронного тока (при этом все значки "p" изменяются на "n", значки "n" изменяются на "p"):
(2.73)
Поскольку через барьер перенос тока осуществляется только электронами и дырками и должно сохраняться условие постоянства тока по всей длине образца, то полный ток получим взяв его значение в любом сечении. Рассчитаем ток положив x=0:
(2.74)
Формула (2.74) описывает зависимость тока через pn переход от приложенного к нему напряжения, т.е. статическую вольтамперную характеристику pn перехода. Соответствующие ей графики в линейном и логарифмическом масштабах были показаны на рис. (при феноменологическом выводе этой же формулы)
Экспоненциальная зависимость, как неоднократно отмечалось, следует из больцмановского распределения электронов по энергиям. Действительно, чем выше барьер, тем меньшее количество электронов может его преодолеть. Инжекционный ток состоит из электронной и дырочной компонент, соотношение между которыми зависит от соотношения между токами Jsp и Jsn и определяется электропроводностью и временем жизни неосновных носителей заряда в соответствующих областях. Действительно использовав переход от коэффициента диффузии к подвижности Dn=(kTμn)/q, Dp=(kTμp)/q) (соотношение Эйнштейна) и (2.72) и (2.73) получим:
(2.75)
Таким образом, если p область легирована значительно сильнее донорной Na>>Nd и соответственно σp>>σn, то при близких значения времен жизни Jsp>>Jsn и ток через переход будет создаваться преимущественно дырками, причем величина этого тока зависит от величины прямого смещения.
Таким образом создав в кристалле pn переход мы формируем потенциальный барьер, который дает средство для управления током. Причем изменяя степень легирования областей мы можем задавать условия для преимущественного протекания через барьера электронных или дырочных потоков. Именно эти свойства избирательного управления потоками носителей заряда легли в основу большей части биполярных приборов.
При значительном обратном смещении высота барьера настолько велика, что тепловой энергии для преодоления барьера становится недостаточно и тогда в уравнении (2.74) начинает доминировать второй член: Js = Jsn + Jsp. Этот член соответствует потоку неосновных носителей заряда, встречному по отношению к только что рассмотренному диффузионному потоку основных носителей заряда. Для, создающих обратный ток перехода неосновных носителей, нет барьера и поэтому те из них, которые дошли до перехода подхватываются электрическим полем и перебрасываются в соседнюю область. Именно отсутствием для этих носителей барьера объясняется то, что в рассмотренной модели обратный ток не зависит от приложенного напряжения. Обратный ток пропорционален концентрации неосновных носителей заряда, темп генерации неосновных носителей определяется температурой, поэтому его часто называют тепловым:
(2.76)
Как следует из (2.76) обратный ток экспоненциально зависит от температуры. Наличие обратного тока ухудшает вентильные свойства pn перехода, поэтому его стремятся уменьшить взяв материал с большей запрещенной зоной. Так, например, в переходах на основе Si обратный ток примерно в тысячу раз меньше, чем в переходах на основе Ge. Однако, как следует из (2.76) сам ток с увеличением Eg уменьшается, однако его зависимость от температуры становится сильнее (см. аналогичные температурные зависимости для σi на рис. 1.1).
2.4. Влияние генерационно-рекомбинационных процессов на ВАХ pn перехода.
Из (1.74) для обратных токов электронов и дырок мы можем написать:
(2.77)
Физический смысл правой части уравнения (2.77) заключается в том, что обратный ток создается неосновными носителями, генерируемыми в примыкающих к области пространственного перехода области n и p баз диода на расстоянии диффузионных для от него. Предполагалось, что генерацией неосновных носителей заряда в обедненной области длиной d можно пренебречь. Это условие действительно справедливо для случай когда Lp>>d или Ln>>d или когда высока концентрация pn0, np0, т.е. ширина запрещенной зоны не очень велика (например в Ge). Однако для таких материалов как Si и GaAs генерационно-рекомбинационный ток в ОПЗ может быть сравним с током насыщения диода, создаваемым np и pn.
Для обратного тока, возникающего за счет генерационно-рекомбинационных процессов в области пространственного заряда можно записать:
(2.78)
где ni - концентрация носителей заряда в ОПЗ (допускается, что его проводимость близка к собственной), τeff - эффективное время жизни электронно-дырочных пар в ОПЗ, w(U) - ширина ОПЗ.
Для оценки эффективного времени жизни носителей в ОПЗ можно воспользоваться следующей формулой:
Ширина ОПЗ рассчитывается следующим образом:
При включении pn перехода в прямом направлении рекомбинация носителей так же может иметь существенное значение в широкозонных полупроводниках.
Обычно влияние генерационно-рекомбинационного тока на ВАХ описывают соотношением:
(2.79)
Общий ток равен сумме диффузионной (2.74) и генерационно-рекомбинационной компонент (2.79).
Лекция 82.5. Барьерная емкость pn перехода
Двойной пространственный слой pn перехода напоминает обкладки конденсатора с разнополярным зарядом на них (см. рис. 2.7, рис. 2.15). Увеличение обратного напряжения на диоде будет приводить к увеличению высоты барьера и соответственно к увеличению создающего барьер заряда ОПЗ, т.е. pn переход обладает емкостью, которую принято называть барьерной:
(2.80)
Поскольку сопротивление области пространственного заряда велико, структура pn перехода с легированным и поэтому хорошо проводящими прилегающими областям аналогична структуре плоского конденсатор, в котором в качестве изолятора выступает ОПЗ, поэтому для емкости такой структуры можно записать:
(2.81)
где ε0 - диэлектрическая постоянная, ε - диэлектрическая проницаемость полупроводникового материала, d - ширина ОПЗ.
Рис. 2.15. Схема распределение заряда в области ОПЗ
Величина емкости pn перехода зависит от приложенного к переходу напряжения. Из (2.81) следует, что зависимость емкости от напряжения будет иметь место только в том случае, если от приложенного напряжения будет зависеть толщина перехода d(U). Рассмотрим какие явления приводят к зависимости d(U).
Допустим, что у нас имеется резкий pn переход и при отсутствии внешнего напряжения имеется некоторая ширина ОПЗ границы которой на рис. 2.15 обозначены значком “0”. При этом ширина ОПЗ такова, чтобы величина нескомпенсированного заряда доноров (справа) и акцепторов (слева) создавали контактное поле обеспечивающее высоту потенциального барьера равную Uк. Если приложить прямое смещение (U>0) высота барьера уменьшится, следовательно должно уменьшиться барьерная разность потенциалов до величины Uк-U, для этого должно уменьшиться контактное поле и соответственно величина заряда в ОПЗ. Поскольку концентрации примесей постоянны величина заряда может уменьшиться только за счет уменьшения ширины ОПЗ, новая граница на рис. 2.15 обозначена штриховой линией (U>0). Таким образом d уменьшится и в соответствии с (2.81) емкость перехода возрастет. Таким образом можно сделать вывод, что увеличение прямого смещения приводит к уменьшению ширины ОПЗ и росту барьерной емкости.
Обратное смещение должно приводить к росту поля и соответственно к росту барьерной разности потенциалов до Uк+U, росту заряда и соответственно расширению ОПЗ. См. пунктирную границу Uк 0 плотность заряда ρ(x) = qNd, при x < 0 плотность заряда ρ(x) = qNa.
(2.82)
За ширину ОПЗ будем считать область от -dp до dn на границах которой напряженность электрического поля принимает нулевое значение, потенциал левой (p) области примем равным нулю, тогда потенциал правой области будет Uк - U, где U - внешнее напряжение, смещающее переход в прямом направлении (U > 0). Таким образом для граничных условий можем записать:
(2.83)
Интегрируя (2.82) при условии (2.83) в n области (x >0) получим:
(2.84)
Интегрируя (2.84) при условии (2.83) в p области (x UT, то с хорошей степенью точности можно считать, что соблюдается условие:
(2.93)
Тогда, учитывая, что для инжектированных в p область электронов можно записать аналогичное соотношение, получим:
(2.94)
Если соблюдалось условие τp = τn = τ, то:
Cдиф = J τ/UT (2.95)
Таким образом, как видно из (2.94) и (2.95) диффузионная емкость зависит от величины прямого тока через pn переход и времени жизни (диффузионной длины Cдиф = JL/(DUT) носителей заряда, т.е. от глубины проникновения носителей заряда в соседнюю область. Действительно, чем больше время жизни инжектированных носителей заряда тем на большую глубину они проникают и тем больше величина инжектированного заряда (см. рис. 2.17).
Рис. 2.18. Зависимость емкости включенного в прямом направлении pn перехода от частоты: 1 - общая емкость, 2 - диффузионная емкость, 3 - барьерная емкость
То. что в формулу для диффузионной емкости входит время жизни инжектированных носителей свидетельствует о том, что диффузионная емкость имеет частотную зависимость. Действительно на частотах для которых период меньше времени жизни носители не будут успевать проникать вглубь материала и соответственно диффузионная емкость будет падать. На рис. 30 приведен график, характеризующий частотную зависимость емкости pn перехода, включенного в прямом направлении. Как видно из графика частотная зависимость емкости перехода определяется частотной зависимости двух составляющих диффузионной и барьерной. Частотная зависимость барьерной емкости проявляется на частотах значительно более высоких по сравнению с диффузионной. То какая из емкостей больше зависит от технологических параметров диода (значений времен жизни) и величины прямого тока.
Уменьшение с частотой глубины проникновения носителей заряда формально можно описать введя частотно-зависимую диффузионную длину:
Lp(ω) =Lp2/(1+i ωτp) , (2.96)
где Lp - рассмотренное ранее низкочастотное значение диффузионной длины (2.67)
Соответственно для модуля L(ω) можно записать:
(2.97)
Формулы (2.96), (2.97) позволяют получить частотно-зависимые решения для зависимости протекающего через pn переход тока от частоты, произведя в решении полученном на основе решения уравнения непрерывности, замену величин Lp, Ln на величины Lp(ω), Ln(ω)из (2.96) .
Лекция 9 2.7. Переходные процессыПри работе диода в импульсном режиме переходные процессы в нем определяются его емкостными характеристиками. Для малого сигнала значения емкостей можно считать величинами постоянными. При больших сигналах имеют место нелинейные процессы, что может приводить к специфической реакции прибора.
Рассмотрим влияние процесса накопления и рассасывания инжектированного заряда (диффузионной емкости) переходные характеристик тока через переход.
Рис. 2.19. Схема для исследования переходных характеристики диода с pn переходом.
На рис. 2.19 показана электрическая схема, которая может быть использована для изучения переходных характеристик диода, обусловленных свойствами pn перехода. Для задания напряжения произвольной формы на диоде служит импульсный генератор. Регистрация сигналов осуществляется двухканальным осциллографом. Напряжение на диоде регистрируется дифференциальным входом U. Ток регистрируется по падению напряжения на малом сопротивлении Rи, напряжение с которого подается на асимметричный вход осциллографа I. Сопротивление Rи много меньше сопротивления толщи баз диода и не оказывает существенного влияния на переходные процессы.
Включение диода
Включением диода называют переход его в состояние с низким сопротивлением, соответствующим напряжению приложенному в прямом направлении. Переходными процессами называют процессы, предшествующие процессам установления стационарного состояния, соответствующего новым условиям.
На рис. 2.20 показаны диаграммы, характеризующие, включение и выключение диода импульсом тока - (a). О происходящих в диоде процессах можно судить по изменениям напряжения на нем - рис. 2.20 (б).
Рис. 2.20. Форма сигналов, характеризующих переходные процессы в структуре с pn переходом: а) ток через структуру, б) напряжение на структуре, в) напряжение на pn переходе, г) напряжение на сопротивлении толщи.
В принципе кривые рис. 2.20 можно объяснить представив диод в виде эквивалентной схемы, состоящей из последовательно включенного pn перехода и резистора rs рис. 2.21 а. При этом сам переход можно представить в виде некоторого нелинейного, зависящего от напряжения резистора и емкости, которая включает барьерную и диффузионную емкости pn перехода. При этом значения как барьерной, так и диффузионной емкости зависят от напряжения и времени (2.89, 2.95 и рис. 2.18). Сопротивления толщи p и n областей зависят от концентрации свободных носителей заряда, поскольку инжекция приводит к увеличению их концентрации, сопротивление rs должно зависеть от величины тока инжекции и от времени, поскольку инжектированные носители диффундируют вглубь материала с конечной скоростью.
Рис. 2.21. Эквивалентная схема диода.
Таким образом, как видно из рис. 2.21 поведение диода может быть приближенно описано эквивалентной схемой, содержащей по крайней мере три нелинейных элемента, каждый из которых имеет некоторую частотную характеристику. Схемотехнический расчет с использованием полной эквивалентной схемы достаточно сложен, поэтому, в зависимости от решаемой задачи используют некоторый упрощенный ее вариант, как правило с линейными элементами.
В тех случаях, когда требуется точный анализ процессов решается нестационарное уравнение непрерывности, как правило, с использованием численных методов.
Рассмотрим явления, происходящие в pn переходе и прилегающих к нему областях в различные моменты времени переходного процесса (рис. 2.20) на основе рассмотренной нами ранее диффузионной модели инжекции. Согласно этой модели между напряжением на pn переходе и концентрация носителей на его границах имеется однозначная связь см. (2.13):
(2.98)
Откуда для напряжения на переходе получим:
(2.99)
Учитывая, что токи на границе ОПЗ преимущественно диффузионные получим уравнение для полного тока и уравнения для граничных значений производных:
(2.100)
Уравнения (2.98) - (2.100) позволяют не только прогнозировать направление развития электронных процессов в биполярных приборах, но и выполнять простейшие оценки.
Рассмотрим как изменяется концентрация дырок в n области в различные моменты включения (в p области процессы будут аналогичны с точностью до знака носителей заряда).
В момент времени 0 до подачи импульса тока напряжение на переход U = 0 и ток через переход Jp = 0, в соответствии с уравнением (2.98) граничная концентрация np(0) = np0 и в соответствии с (2.100) ∂pn(0)/ ∂x = 0, т.е. распределение носителей в этот момент такое как показано на рис. 2.21 (кривая 0).
Рис. 2.22. Распределение инжектированных носителей заряда в различные моменты времени (см. рис. 32) при включении диода.
В следующий момент времени (1) через pn переход начал протекать ток от внешнего генератора. Поскольку носители в глубь p области распространяются диффузионно, то в первый момент времени инжектированные носители находятся вблизи границы через которую они были инжектированы (кривая 1). При этом ∂pn(0)/ ∂x = Jp(0) и в дальнейшем, пока ток через переход Jp(0) остается постоянным градиент концентрации на границе так же остается постоянным (кривые 1, 2, 3, 4 на рис. 33). По мере инжекции носителей заряда граничная концентрация носителей будет возрастать, это приведет к росту положительного напряжения на переходе см. (76), при этом будет возрастать и напряжение на переходе (моменты 1, 2, 3 на рис. 32) до тех пор пока не установится стационарное распределение инжектированных носителей pn(x) = pn(0)e-x/Lp (кривая 4 на рис 33 и соответствующий момент 4 на рис. 2.22). Установление стационарного распределения инжектированных носителей соответствует окончанию переходного процесса и переходу диода во включенное состояние.
Скорость выключения pn перехода определяется скоростью рекомбинации носителей заряда после прекращения инжекции. Чем меньше время жизни, тем быстрее происходит спад "послеинжекционной эдс" (напряжение на pn переходе после прекращения импульса тока):
Переход диода в выключенное состояние.
Момент прекращения импульса тока не означат выключения диода. Даже после прекращения тока (например при разрыве цепи) диод в течение некоторого времени остается во включенном состоянии: его сопротивление будет низким и на нем будет сохраняться положительное напряжение (моменты 5, 6 на рис. 2.20). Объясняется это тем, что после прекращения тока инжектированные носители в течении некоторого времени будут находиться вблизи pn перехода и до тех пор, пока они не исчезнут за счет рекомбинации высота барьера будет понижена и pn переход будет смещен в положительном направлении см. формулу (2.98). Смещение будет уменьшаться по мере снижения граничной концентрации носителей заряда (рис 2.23). Кривая 4 на рис. 2.23 соответствует току, протекающему через диод в прямом направлении, кривые 3, 4 соответствуют моментам перехода из включенного в выключенное состояние, причем поскольку ток через барьер отсутствует градиент на границе равен нулю. Только после того как граничная концентрация достигнет равновесного значения pn0 напряжение на переходе станет равным нулю. Можно считать, что диод полностью перешел в выключенное состояние только после того как в p и n областях исчезнут инжектированные носители и установятся равновесные концентрации np0 и pno соответственно.
Рис. 2.23. Распределение инжектированных носителей заряда в различные моменты времени (см. рис. 32) при выключении диода.
Переключение из прямого направления в обратное
Рассмотрим случай, когда происходит переключение диода из прямого направления в обратное (рис. 2.24), при этом обратное напряжение может превышать прямое в сотни раз.
На рис. 2.25 показано распределение носителей в n базе диода в различные моменты времени. Кривая 0 соответствует исходному стационарному распределению носителей заряда, когда диод находится в стационарном состоянии, соответствующим прямому включению. Кривая 6 соответствует конечному стационарному распределению носителей заряда, когда диод включен в обратном направлении. Переходные процессы должны обеспечить изменение распределения носителей от начального (0) к конечному (6).
Рис. 2.24. Форма сигналов, характеризующих переходные процессы в диоде при переключении его из прямого направления в обратное: а) Напряжение, от импульсного генератора, б) напряжение на pn переходе, в) ток через диод
После мгновенного изменения полярности напряжения на диоде, поступление дырок из p области прекращается и на границе с областью пространственного заряда возникает ступенчатое распределение инжектированных дырок с градиентом направленным в обратную сторону - пунктирная линия на рис. 2.25 Такому ступенчатому градиенту должен соответствовать бесконечный разрядный ток, направленный в обратном направлении. Поскольку любая реальная электрическая цепь обладает конечным сопротивлением R, то максимально возможный ток в цепи будет Im = U/R, где U - напряжение, приложенное в обратном направлении. Току Im соответствует некоторый градиент концентрации на границе барьера (на рис. 36 он обозначен тонкой линией), этот градиент будет сохраняться в процессе разряда до тех пор пока концентрация инжектированных при прямом включении носителей будет достаточной для его поддержания (кривые 1, 2, 3 на рис. 2.25 и соответствующие им моменты времени на рис. 2.24). Так возникает полочка на кривой разрядного тока, характеризующего рассасывание инжектированных носителей заряда. Со временем градиент концентрации на границе уменьшается, что приводит к окончанию полочки в разрядном токе и началу его спада. По мере рассасывания и рекомбинации носителей заряда их концентрация на границе уменьшается и соответственно уменьшается прямое смещение перехода см. (2.13). В момент, когда концентрация неосновных носителей заряда на границе достигает равновесной, напряжение на pn переходе становится равным нулю.
Рис. 2.25. Изменение концентрации инжектированных носителей в различные моменты времени( см. рис. 35) при переключении диода из прямого направления в обратное
После того как pn(0) становится меньше pn0 напряжение на переходе изменяет знак и распределение носителей заряда в приконтактной области быстро достигает соответствующего обратно включенному переходу.
2.6. Пробой pn перехода
При увеличении напряжения на pn переходе при достижении некоторого напряжения U проб начинается резкое возрастание тока, приводящее к пробою pn перехода. Существует несколько физических механизмов пробоя pn перехода. Рассмотрим основные из них.
Лавинный пробой
В высоком электрическом поле неосновные носитель заряда на длине свободного пробега может набрать энергию достаточную для того, чтобы при соударении с решеткой создавать электронно-дырочную пару. Вновь образованные носители разгоняясь в электрическом поле сами принимают участке в дальнейшем образовании электронно-дырочных пар. Процесс нарастания числа носителей со временем носит лавинный характер, поэтому этот тип пробоя и называют лавинным.
Лавинный пробой характеризуют коэффициентом лавинного умножения, для которого справедливо следующее соотношение:
(2.101)
где J - обратный ток до умножения (равный сумме тока насыщения и генерационного), n - коэффициент, который зависит от материала и профиля легирования pn перехода, этот коэффициент может иметь значения от 2 до 6
Напряжение лавинного пробоя зависит от степени легирования p и n областей. Так для резкого p+n перехода (p+ - означает сильное легирование p области) зависимость напряжения пробоя от степени легирования n области имеет вид:
(2.102)
где Eg - ширина запрещенной зоны в эВ, N - концентрация примеси в слаболегированной области в см-3.
Соответствующая зависимость напряжения от степени легирования для резкого несимметричного перехода для pn переходов, изготовленных из разных материалов, показана на рис. 2.26.
Р
ис.
2.26. Зависимость
напряжения
лавинного
пробоя от
концентрации
примеси для
несимметричного
ступенчатого
перехода.
Туннельный пробой
Если p и n области сильно легированы, то ширина ОПЗ становится малой и за счет туннельного эффекта появляется конечная вероятность для электронов из валентной зоны проникнуть в зону проводимости, преодолев барьер, который возникает в сильном электрическом поле. Для туннельного эффекта характерно то, что электроны после преодоления энергии не изменяют своей энергии, следовательно для того, чтобы этот эффект имел место электрическое поле должно быть настолько сильным, чтобы обеспечить такой наклон зон при котором заполненные электронами уровни валентной зоны оказались напротив незаполненных энергетических уровней разрешенной зоны рис. 2.27. Пунктиром на рисунке показан потенциальный барьер, который должен преодолеть один из электронов.
Поскольку туннельный механизм перехода носителей имеет место только при малой ширине ОПЗ, то для этого типа пробоя характерны невысокие пробивные напряжения. К отличительным особенностям туннельного пробоя следует так же отнести сравнительно слабую зависимость от температуры напряжения пробоя.
Рис. 2.27. Энергетическая диаграмма, поясняющая возникновение свободных носителей заряда при туннельном переходе.
Тепловой пробой
При увеличении обратного напряжения увеличивается и мощность рассеиваемая в переходе в виде тепла, поэтому для pn переходов со сравнительно высокими обратными токами возможен разогрев pn перехода, что в свою очередь приведет к увеличению обратного тока. Возрастание обратного тока приведет к дополнительному выделению тепла и соответственно дополнительному разогреву, что явится причиной дальнейшего увеличения обратного тока. Таким образом в pn переходе возникает положительная обратная связь, которая приводит к возникновению тепловой неустойчивости - тепловому пробою.
Предположим, что мы снимаем ВАХ pn перехода, поддерживая постоянным значение выделяющейся в переходе мощности P = UI = const, соответствующей определенной температуре. На рис. 39 показаны, соответствующие различной температуре обратные токи и гиперболические кривые, соответствующие постоянству выделяемой мощности, определяющей температуру перехода. Если соединить точки пересечения кривых, соответствующих одинаковой температуре, то получим обратную ветвь характеристики pn перехода в случае его теплового пробоя.
Р
ис.
2.28. Диаграмма,
поясняющая
формирование
обратной ветви
вольтамперной
характеристики
pn перехода при
тепловом пробое
.
Как видно из рис. 2.28 при тепловом пробое на обратной характеристике pn перехода возникает участок с отрицательным дифференциальным сопротивлением. На этом участке имеет место возрастание тока при уменьшении напряжения (неустойчивость тока). Если не принять специальных мер для ограничения тока, то диод выходит из строя. Предпосылкой для возникновения теплового пробоя служат большие значения обратного тока, поэтому этот тип пробоя легче возникает в приборах, изготовленных на основе материалов с небольшой шириной запрещенной зоны. Так, например, в высоковольтных германиевых диодах он может иметь место уже при комнатных температурах. В диодах на основе Si и GaAs он может иметь место при высоких температурах, когда значения обратных токов становятся большими.
164
Воронков Э.Н. Твердотельная электроника. 2002г.Содержание
Лекция 10 119
2.7. Силовые диоды 119
2.8. Стабилитроны 120
2.9. Полупроводниковые управляемые емкости (варикапы) 121
2.10. Туннельные диоды 123
Лекция 11 126
3. БИПОЛЯРНЫЕ ТРАНЗИСТОРЫ 126
3.1. Принцип работы 126
Лекция 12 133
3.2. Статические вольтамперные характеристики биполярного транзистора. 133
Лекция 13 146
3.4. Количественный анализ процессов в биполярном транзисторе. 146
Лекция 14 152
3.5. Влияние конструктивно технологических характеристик транзистора на параметры эквивалентной схемы. 152
4.5.1. Коэффициент передачи по току. 153
4.5.4. Дифференциальное сопротивление коллекторного перехода - rк 157
Лекция 15 160
3.6. Частотные характеристики биполярного транзистора. 160
3.6.1. Зависимость коэффициента передачи тока от частоты в схеме с общей базой [α(ω)]. 160
3.6.2. Зависимость коэффициента передачи тока от частоты в схеме с общим эмиттером [β(ω)]. 162
Лекция 10 2.7. Силовые диоды
Силовые выпрямительные диоды, как правило, работают в блоках, обеспечивающих энергопитание электротехнических устройств, поэтому, как правило, они должны быть мощными, обладать высоким к.п.д. преобразования переменного тока в постоянный, не изменять свои параметры в процессе работы и их конструкция должна предусматривать хороший теплоотвод.
Поскольку на выпрямительных диодах, как правило, рассеивается значительная мощность они разогреваются, что приводит к ухудшению их выпрямительных свойств и, если температура pn перехода превысит определенное значение, диод может выйти из строя, что в свою очередь может сопровождаться выходом из строя всего силового блока.
Для характеристики воздействия температуры на pn переход вводят специальный параметр – тепловое сопротивление. Тепловое сопротивление полупроводниковых приборов характеризует как выделяющаяся в полупроводниковом приборе мощность влияет на его разогрев. Измеряется тепловое Rт сопротивление в [o/Вт] :
(2.103)
Tп - температура PN перехода, Тос - температура окружающей среды
Величина Rт - зависит от конструкции прибора, в частности способа крепления кристалла, конструкции корпуса. Чем более массивный кристаллодержатель и сам корпус, тем меньше тепловое сопротивление прибора. На рис. 2.29 в качестве примера приведены конструкции двух корпусов с указанием их теплового сопротивления.
Рис. 2.29. Примеры
конструкций
диодов с различным
сопротивлением: 1,2-малой мощности, Rт = (100-200) °/Вт,
3-средней
мощности, Rт =
1-10°/Вт.
Стабилитроны полупроводниковые приборы на основе диодов с pn переходами предназначенные для работы в качестве источников опорного напряжения в различных электронных схемах.
Рис. 2.30. Диаграммы поясняющие работу стабилитрона: включение стабилитрона (а), ВАХ стабилитрона и задание его режима с помощью сопротивления R.
Для стабилизации напряжения в стабилитроне используется тот участок ВАХ диода на котором изменение тока сопровождается небольшими изменениями напряжениями. Чаще всего в стабилитроне используется участок обратимого пробоя на обратной ветви диода, соответственно pn переход в этом случае включается в обратном направлении, как это показано на рис. 2.30а.
Два встречно включенных стабилитрона могут использоваться как ограничители напряжения, которые позволяют защитить входные цепи различных устройств от перегрузок.
В тех случаях, когда требуется получить небольшие опорные напряжения для стабилизации напряжения может быть использован участок прямой ВАХ диода.
К основным характеристическим параметрам стабилитрона относят параметры характеризующие качество стабилизации напряжение в заданном диапазоне токов:
дифференциальное сопротивление Rd=ΔUст/ΔI (обычно омы);
температурный коэффициент напряжения выраженный в процентах относительно напряжения стабилизации Uст, он характеризует изменение напряжения стабилизации с температурой ТКН = ΔUст/(ΔTUст)%. Обычно ТКН не превышает сотых долей процента.
2.9. Полупроводниковые управляемые емкости (варикапы)
Полупроводниковые управляемые емкости- варикапы (от англ. vary – изменяться и capacitance - емкость) нашли широкое распространение в самых различных радиотехнических , телевизионных и специальных схемах для автоматической настройки контуров. В качестве варикапов используются специально сконструированные диоды, в которых емкость должна обладать высокой добротностью в заданном диапазоне частот, стабильностью во времени и по возможности мало изменяться с температурой. В варикапах pn переход включается в обратном направлении, т.е. используется его барьерная емкость.
Рис. 2.31. Эквивалентные схемы варикапа
На рис. 2.31 показаны эквивалентные схема варикапа, где R – дифференциальное сопротивление включенного в обратном направлении pn перехода, C – емкость pn перехода, rs –толщи полупроводникового материала и контактов к p и n областям. Все параметры эквивалентной схемы измеряются в заданной рабочей точке, в которой они должны быть оптимальными с точки зрения добротности варикапа.
Рассчитаем импеданс и добротность варикапа, используя эквивалентную схемы рис. 2.31а. Импеданс:
(2.103)
Важнейшим параметром, определяющим качество полупроводниковой емкости, является ее добротность Q. Чем ниже активные потери в емкости, тем выше добротность. Используя (2.103) получим:
(2.104)
Поскольку сопротивление перехода R в полупроводниковой емкости всегда много больше rs в (2.104) величины rs можно пренебречь, тогда:
(2.105)
Рис. 2.32 Зависимость добротности варикапа от частоты (пояснения в тексте)
На рис. 2.32 показана зависимость добротности от частоты, рассчитанная по (2.105) при R=107 Ом, rs = 10 Ом и C=10 пф для кривой 1 и C=30 пф для кривой 2. Эти кривые показывают как критично значение добротности к режиму варикапа (максимальная добротность должна соответствовать рабочей частоте) и то, что при изменении смещения на варикапе будет изменяться не только его емкость (см. п.п. 2.5), но и его добротность.
2.10. Туннельные диодыЕсли P и N области диода сильно легированы (до вырождения), то ширина барьерного слоя становится очень узкой и электроны могут туннелировать через него. Для изготовления туннельных диодов используют pn переход, в котором p и n области легированы до вырождения, т.е. уровень Ферми как в p, так и в n области попадает в соответствующую зону.
На рис. 2.32 показаны вольтамперные характеристики туннельных диодов, справа - обращенных. Обращенными эти диоды называются, поскольку при малых обратных смещениях у них значительно выше, чем при прямом (инверсия выпрямления). Пунктиром показаны ВАХ соответствующих диодов в случае, если бы туннельный механизм отсутствовал.
Рис. 2.32. Вольтамперные характеристики туннельных диодов.
На следующем рис. 2.33 показаны энергетические диаграммы, соответствующие различным точкам показанным на ВАХ туннельного диода рис. 2.30. Стрелками обозначены направления туннелирующих электронов (точки 2 и 3) и надбарьерный переход электронов и дырок (точка 5).
Поскольку барьер узкий при обратном смещении (т.2 на рис. 2.30 и 2.31) электроны получают возможность туннелировать из валентной зоны непосредственно в зону проводимости создавая значительный ток.
Наличие вырождения приводит к тому, что при прямом смещении электроны из зоны проводимости получают возможность туннелировать на свободные места у потолка валентной зоны p области (т.2 на рис. 2.30 и 2.31).
Рис. 2.33. Энергетические диаграммы, поясняющие работу туннельного диода.
При дальнейшем увеличении прямого смещения (т.4 на рис. 2.32) энергия дна зоны проводимости в материале n типа соответствует энергиям запрещенной зоны в материале p типа, см. энергетическую диаграмму для т. 4 на рис. 2.33, и поскольку переход на эти уровни запрещен туннельный ток падает до нуля.
Увеличение прямого смещения приводит к уменьшению высоты потенциального барьера и соответственно возрастанию надбарьерных токов (т. 5 на рис. 2.32 и рис. 2.33), как это имеет место в обычных диодах с pn переходом смещенным в прямом направлении.
Наличие на ВАХ туннельного диода участка с отрицательным дифференциальным сопротивлением (ток уменьшается при росте напряжения) позволяет на их основе создавать усилительные и генераторные схемы.
Лекция 113. БИПОЛЯРНЫЕ ТРАНЗИСТОРЫ 3.1. Принцип работы
Б
иполярный
транзистор
- трехэлектродный
полупроводниковый
прибор с двумя,
расположенными
на близком
расстоянии
параллельными
pn - переходами.
Конструкции
биполярного
транзистора
схематически
показаны на
рис. 3.1, там же
приведены
соответствующие
обозначения. Как видно из
рис. 3.1 транзистор
состоит из трех
основных областей:
эмиттерной,
базовой и
коллекторной.
К каждой из
областей имеется
омический
контакт. Для
того, чтобы
транзистор
обладал усилительными
свойствами
толщина базовой
области должна
быть меньше
диффузионной
длины неосновных
носителей
заряда, т.е. большая
часть носителей
инжектированных
эмиттером
должна не должна
рекомбинировать
по дороге к
коллектору.
Рис. 3.1. Структура и обозначения pnp и npn биполярных транзисторов
На границах между p и n областям возникает область пространственного заряда, причем электрические поля в эмиттерном и коллекторном переходе направлены так, что для pnp транзистора базовая область создает энергетический барьер для дырок в эмиттерной p – области, для npn транзистора базовая область создает аналогичный барьер для электронов эмиттерной n –области. При отсутствии внешнего смещения на переходах потоки носителей заряда через переходы скомпенсированы и токи через электроды транзистора отсутствуют.
Д
ля
того, чтобы
транзистор
работал в режиме
усиления входного
сигнала, эмиттерный
переход смещают
в прямом направлении,
коллекторный
в обратном,
соответствующие
диаграммы
показаны на
рис. 3.2. Приложенное
к эмиттерному
переходу смещение
уменьшает
потенциальный
барьер из эмиттера
в базу инжектируются
дырки (в pnp транзисторе)
или электроны
(в npn транзисторе)
инжектированные
носители проходят
и достигают
коллектора.
Между базой
и коллектором
барьера нет,
поэтому все
дошедшие до
коллектора
носители заряда
переходят через
коллекторный
переход и создают
коллекторный
ток.
Рис. 3.2. Диаграммы, поясняющие работу биполярных транзисторов: (а) смещение на переходах отсутствует; (б) эмиттерный переход смещен в прямом направлении, коллекторный в обратном.
Поскольку коллекторный переход расположен близко от эмиттерного основная часть инжектированных эмиттером носителей достигает коллектора, таким образом инжекционный ток эмиттера примерно равен току коллектора. При этом, мощность затраченная во входной (эмиттерной) цепи, на создание тока меньше мощности, которая выделяется в выходной (коллекторной) цепи, т.е. имеет место усиление мощности. Таким образом входной сигнал изменяя высоту потенциального барьера модулирует поток неосновных носителей создающий коллекторный ток и соответственно создает усиленный за счет энергии коллекторной батареи сигнал в выходной цепи.
Н
а
рис. 3.3 показаны
энергетические
диаграммы для
pnp и npn транзисторов,
соответствующие
потенциальным
диаграммам
приведенным
на рис. 32б.
Рис. 3.3. Энергетические диаграммы pnp (а) и npn (б) транзисторов в активном режиме: эмиттерный переход смещен в прямом направлении, коллекторный в обратном.
Рассмотрим токи черезколлекторный переход. Как видно из рис. 3.3а. для p-n-p транзистора вклад в управляемый ток коллектора дают инжектированные эмиттером дырки – поток 1. Электронный ток коллектора, который образуется за счет генерируемых теплом в области коллектора электронов (ток утечки, состоящий из неосновных носителей) – поток 2, не несет сигнала и жалательно, чтобы он был как можно меньще.
Для n-p-n транзистора вклад в управляемый ток коллектора дают инжектированные эмиттером электроны – поток 1 на рис. 3.3б . Дырочный ток коллектора, образуемый генерируемыми в области коллектора неосновными носителями (ток утечки) – поток 2 на рис. 3.3б, и сигнала не несет.
Рассмотрим токи через эмиттерный переход. Как видно из рис. 3.3, при прямом смещении эмиттерного перехода, помимо потока носителей инжектированных из эмиттера поток 1, возможна так же инжекция из базы в эмиттер носителей другого знака, поток 2. Этот инжекционный ток не проходит через коллекторную цепи и соответственно не способствует усилению сигнала, поэтому его стремятся сделать как можно меньше. Это достигается тем, что степень легирования эмиттера задается на значительно выше, чем степень легирования базы, тогда соответственно и инжекционный ток эмиттера выше инжекционного тока базы.
Перенос зарядов через базу транзистора можно характеризовать следующими уравнениями (для pnp транзистора):
(3.1)
Коэффициент инжекции эмиттерного перехода γ показывает какая часть эмиттерного тока состоит из заряда инжектированного в базу. Поскольку только инжектированные носители создают эффект усиления желательно, чтобы коэффициент инжекции был как можно выше (обычно γ > 0,99).
Не все инжектированные эмиттером носители доходят до коллектора, некоторая их часть рекомбинирует:
(3.2)
Коэффициент переноса κ показывает какая часть инжектированных носителей дошла до коллектора не прорекомбинировав. Коэффициент переноса зависит от времени жизни неосновных носителей в базе и ее длины. Именно необходимость обеспечить перенос инжектированных носителей через базу транзистора выдвигает требование, чтобы диффузионная длина была больше толщины базы транзистора Lp>>W. Выполнение этого условия позволяет обеспечить высокие значения коэффициента переноса (обычно κ > 0,98).
Коллекторный ток состоит из тока носителей заряда инжектированных эмиттером и тока утечки коллекторного перехода Iкоб (индекс б - означает, что рассматриваемая схема является схемой с общей базой - ОБ), поэтому, учитывая (4_1) и (4_2) запишем:
(3.3)
Чем выше α - коэффициент передачи эмиттерного тока в коллекторную цепь, тем выше усиление транзистора по мощности, поэтому иногда этот коэффициент называют коэффициентом усиления транзистора в схеме с общей базой (рис. 51б, 52), однако этот коэффициент всегда несколько меньше единицы, если не происходит лавинного умножения носителей в коллекторном переходе. Последний эффект может иметь место при сравнительно высоких напряжениях и иногда используется в специально сконструированных транзисторах, в этом случае:
α = γκM, (3.4)
M = Iк/Ipк - коэффициент, характеризующий умножение неосновных носителей, дошедших до коллектора.
Коэффициенты γ и κ характеризуют вклад инжекционных и рекомбинационных процессов в коллекторный ток, т.е. в работу транзистора и его характеристики.
Для npn транзистора можно написать соотношения аналогичные (3.1) - (3.4), при этом изменятся только индексы обозначающие тип носителей заряда.
Запишем основные уравнения, характеризующие соотношения между токами транзистора:
Iэ = Iк + Iб,
Iк = αIэ + Iкоб. (3.5)
Для тока Iб можно написать:
Iб = Iэ - Iк = Iэ - αIэ = Iэ(1 - α) - Iкоб. (3.6)
Постоянное смещение на эмиттерном и коллекторном переходах задает некоторые значения токов и напряжений на эмиттерном и коллекторном переходах: Iэ0, Uэ0, Iк0, Uк0, которые характеризуют некоторую статическую рабочую точку на входных и выходных характеристиках. Обычно для характеристики рабочей точки используют значения в тока в выходной цепи, например для схемы рис. 3.4 это будут: Iк0, Uк0.
В усилительном каскаде для задания смещения на эмиттерный и коллекторный переходы не обязательно использовать две батареи, Для задания смещения на эмиттерный переход, как правило используется резистивный делитель, как это показано на рис. 3.4, который иллюстрирует три возможных способа задания входного сигнала относительно выходного и соответствующие эквивалентные схемы каскадов по переменному сигналу: схема с общим для входной и выходной цепей базовым электродом - ОБ, эмиттерным электродом - ОЭ и коллекторным - ОК (при составлении эквивалентных схем по переменному току сопротивление батарей принимается равным нулю).
Рис. 3.4. Три схемы включения источника сигнала и нагрузки в усилительном каскаде и соответствующие схемы замещения каскадов по переменному току.
Сигнал от внешнего источника может сопровождаться изменением токов через электроды транзистора и напряжений на его электродах:
Iэ(t) = Iэ0 + ΔIэ(t), Uэ(t) = Uэ0 + ΔUэ(t);
Iб(t) = Iб0 + ΔIб(t), Uб(t) = Uб0 + ΔUб(t);
Iк(t) = Iк0 + ΔIк(t), Uк(t) = Uк0 + ΔUк(t).
Будем использовать для обозначения сигналов вместо приращений прописные буквы, тогда для коэффициентов передачи по току из (3.5), (3.6) для схем ОБ. ОЭ. ОК получим:
Kiб = iк/iэ = α, Kiэ = iк/iб = α./(1- α.), Kiк = iэ/iк = 1/(1-α)
Часто для коэффициента передачи тока в схеме с общим эмиттером используют значок β = Kiэ = α./(1- α.). тогда Kiк = 1/(1-α)= β+1. Коэффициент α < 1 и, как правило, составляет 0,98 - 0,99, при этом соответственно коэффициент β >> 1 и составляет 49 - 99. Таки образом для схем ОЭ и ОК имеет место усиление тока.
Лекция 12
3.2. Статические вольтамперные характеристики биполярного транзистора.
Н
а
рис. 3.5 показана
схема замещения
биполярного
транзистора.
На этой схеме
функции I1=f1(Uэб),
I2=f2(Uкб)
описывают
нелинейные
характеристики
эмиттерного
и коллекторного
переходов.
Генератор тока
αNI1
характеризует
собранный
коллектором,
при нормальном
включении
транзистора
(Uэб > 0, Uкб < 0), инжекционный
ток эмиттера,
при нормальном
включении
транзистора
(Uэб > 0, Uкб < 0). Генератор
αII2
характеризует
собранный
эмиттером, при
инверсном
включении
транзистора
(Uэб < 0, Uкб > 0), инжекционный
ток коллектора.
Для представленной на рис. 3.5 схемы можно записать:
(3.7)
где (3.8)
Подставив (4.8) в (4.7) получим выражения для входной JЭ(UЭБ,UКБ) и выходной JК(UЭБ,UКБ) вольтамперных характеристик транзистора в схеме ОБ:
(3.9)
Графики вольтамперных характеристик биполярного транзистора для схемы с общей базой приведены на рис. 55. Можно выделить три основных области, соответствующих различным режимам работы транзистора. Построим распределение неосновных носителей для характерных точек, расположенных в каждой из этих областей (рис. 55).
Рис. 3.6. Статические вольтамперные характеристики биполярного транзистора в схеме с общей базой.
При построении распределения, учтем, что ширина базы мала (W pn0, pn(W)
n0. Поскольку, как правило |UКБ| >> |UT|, то pn(W) ≈ 0. Соответствующее распределение носителей заряда для т. A показано на рис. 3.7. Увеличение тока эмиттера будет сопровождаться возрастанием UЭБ и в соответствии с (3.10) ростом pn(0) и в соответствии с (3.11) ростом градиента концентрации. Уменьшение тока эмиттера (напряжения на эмиттерном переходе) будет сопровождаться уменьшением pn(0) и уменьшением ростом градиента.
Режим насыщения (т. B и т. C на рис. 3.6), соответствует режиму при котором ток коллектора ограничен и не обеспечивает отвод всех подходящих к коллектору инжектированных носителей заряда, границы режима насыщения определяются условиями UЭБ > 0 и UКБ ≤ 0, следовательно в соответствии с (3.10) pn(0) > pn0, pn(W) ≥ pn0. В т. B UЭБ > 0 и UКБ = 0, соответственно pn(0) > pn0 и pn(W) = 0. В т. C увеличение эмиттерного тока (и соответственно UЭБ)не сопровождается увеличением коллекторного тока, однако приводит к увеличению концентрации носителей заряда около коллектора , т.е. согласно (3.11) напряжение на коллекторном переходе становится больше 0. Таким образом в т. C UЭБ > 0 и UКБ > 0, соответственно pn(0) > pn0 и pn(W) > pn0. Поскольку в т. С ток такой же как в т. B градиент концентрации остался прежним.
Рис. 3.7. Распределение носителей в базе транзистора при различных режимах (положение рабочих точек см. рис. 55)
Режим отсечки (т.D на рис. 3.7), соответствует режиму при котором соответствующий сигналу инжекционный ток эмиттера отсутствует соответственно на коллектор не поступают инжектированные носители и транзистор находится в запертом состоянии. Границы режима отсечки определяются условиями UЭБ ≤ 0 и UКБ < 0, следовательно в соответствии с (4_10) pn(0) ≤ pn0, pn(W) ≈ 0. В т. D UЭБ < 0 и UКБ < 0 (|UКБ| >> |UT|), соответственно pn(0) < pn0 и pn(W) = 0. Как видно из соответствующего т.D рис. 3.6 вблизи эмиттера градиент концентрации изменил направление, т.е. через эмиттерный переход начал протекать обратный ток. Если ток через эмиттерный переход будет равне нулю, то соответственно будет равен нуля и эмиттерный ток. В режиме отсечки неосновные носители в транзисторе возникают только в результате генерационных процессов в объеме материала.
Рассмотренные процессы инжекции и собирания носителей коллектором не зависят от схемы включения, соответственно и рассмотренные режимы - активный, насыщения и отсечки могут иметь место и в каскадах с общим эмиттером и общим коллектором, однако, поскольку при изменении общего электрода изменяются входные и выходные токи и напряжения, то соответственно и передаточные характеристики различных каскадов будут отличаться, так же как будут отличаться и вольтамперные характеристики транзистора в различных схемах включения.
Наибольшее распространение в полупроводниковых схемах нашло включение биполярного транзистора по схеме с общим эмиттером. Вольтамперные характеристики для транзистора в схеме ОЭ возиожно, получить перестроением характеристик для схемы ОБ с учетом соотношений между токами и напряжениями в схемах ОБ и ОЭ (см. рис. 3.8).
Рис. 3.8. Обозначение токов через электроды транзистора и разности потенциалов между электродами для схемы ОЭ
В схеме с общим эмиттером входным напряжением будет UБЭ, выходным UКЭ , при этом UБЭ = -UЭБ, т.е. если подать один и тот же сигнал на каскад ОЭ и ОБ, то на выходе этих каскадов он будет в противофазе. Как видно из рис. 57 напряжение на выходе транзистора UКЭ = UБЭ + UКБ, т.е. оно складывается из выходного напряжения в ОБ и перевернутого по фазе входного напряжения в ОБ. Выходной ток в ОЭ так же как и в ОБ равен Iк. В ОЭ входной базовый ток равен Iб = Iэ - Iк = Iэ(1-α), т.е. он в (β+1) раз меньше, чем в схеме ОБ, соответственно входное сопротивление в транзистора в ОЭ должно быть больше чем в ОБ.
Р
ис.
3.9.
Статические
вольтамперные
характеристики
в схеме с общим
эмиттером
Вольтамперные характеристики для схемы ОЭ показаны на рис. 58 на графиках обозначены точки соответствующие точкам на вольтамперных характеристиках для схемы ОБ (рис 3.6) . Следует обратить внимание, что для режима насыщения характеристики не заходят в третий квадрант, т.е. напряжение Uк. не изменяет знак. Действительно в ОЭ: Uкэ. = Uкб - Uэб < 0, так как в режиме насыщения Uкб > 0, Uэб > 0 и Uэб > Uкб. К отличиям от ОЭ следует так же так же отнести то, что тепловой ток I*к0, измеренный при Iб = 0, в (β+1) раз больше, чем ток Iк0, измеренный при Iэ = 0. В ОЭ менше выходное сопротивление транзистора по сравнению со схемой ОЭ (меньше наклон выходных ВАХ).
Похожие работы
... тогда происходило в его лаборатории. Его интуитивный выбор и искусство эксперимента просто изумляют». Сегодня мы понимаем, что без квантовой теории строения полупроводников представить развитие твердотельной электроники невозможно. Поэтому талант Лосева поражает воображение. Он с самого начала видел единую физическую природу кристадина и явления инжекционной люминесценции и в этом значительно ...
... находятся в стадии разработки, и возможно, в скором времени могут быть применены для обработки изделий ювелирной промышленности. Поэтому я постараюсь рассмотреть все возможные варианты применения лазеров в технологических процессах ювелирной промышленности. Пробивка отверстий в камнях. Одним из первых применений лазеров была пробивка отверстий в часовых камнях. Сверление отверстий всегда было ...
... , что собственное быстродействие транзистора обратно пропорционально квадрату длины инверсионного канала. Поэтому для повышения быстродействия необходимо переходить на субмикронные длины канала. 2 РАСЧЕТ ПАРАМЕТРОВ И ХАРАКТЕРИСТИК МДП-ТРАНЗИСТОРА НА ОСНОВЕ АРСЕНИДА ГАЛЛИЯ 2.1 Основные сведения об арсениде галлия Арсени́д га́ллия (GaAs) — химическое соединение галлия и мышьяка. ...
... философии - особенно с методологических позиций материалистического понимания истории и материалистической диалектики с учетом социокультурной обусловленности этого процесса. Однако в западной философии и методологии науки XX в. фактически - особенно в годы «триумфального шествия» логического позитивизма (а у него действительно были немалые успехи) - научное знание исследовалось без учета его ...

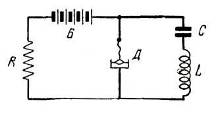
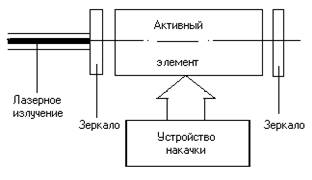
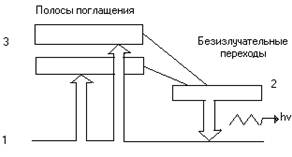



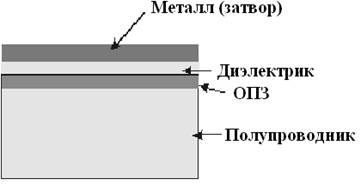


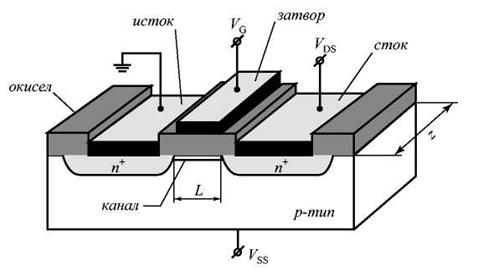
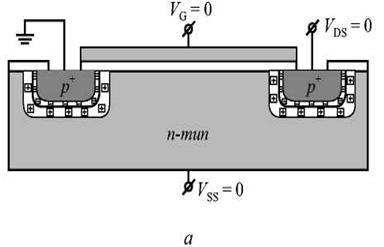
0 комментариев