Навигация
Определение электрических параметров элементов схемы
2. Определение электрических параметров элементов схемы.
Значения токов и напряжений на элементах схемы определяется с помощью программы Electronics Workbench (версия 5.12, разработчик – Interactive Image Technologies LTD).
Для последующего расчета топологических параметров разрабатываемой интегральной схемы необходимо определить следующие параметры:
максимальный ток через резисторы IR . Данный параметр необходим для расчета мощности, выделяющейся на резисторах, необходимой для последующих расчетов;
для транзисторов – максимальный ток на коллекторном переходе, максимальный ток эмиттера,максимальное напряжение на переходе коллектор-база UКБ.
Электрические параметры конденсаторов, необходимые для расчета их топологических параметров, приведены в задании к данной работе и не подлежат определению.
Значения параметров, указанных выше, приведены в табл. 2.1.
Табл. 2.1. Электрические параметры элементов интегральной схемы.
| Параметр | IR1-4, мА | IR5, мА | UКБ, В | IЭ, мА |
| Значение | 0,26 | 4,94 | 1,5 | 4,5 |
Примечание. Данные значения токов и напряжений были измеряны при подаче на логические входы схемы минимально допустимого напряжения логической единицы (1,9 В), и/или максимально допустимого напряжения логического нуля (0,7 В).
3. Технологические этапы изготовления ИМС.
При производстве различных ИМС в текущий момент используется планарная технология, обеспечивающая воспроизводимые параметры интегральных элементов и групповые методы их производства Локальные технологические обработки участков монокристалла кремния обеспечиваются благодаря применению свободных и контактных масок. В планарной технологии многократно повторяются однотипные операции для создания различных по структуре ИМС. Основными технологическими операциями при изготовлении ИМС являются: подготовка полупроводниковой подложки; окисление; фотолитография; диффузия; эпитаксия; ионное легирование, металлизация
Элементы биполярных интегральных структур создаются в едином технологическом цикле на общей полупроводниковой подложке. Каждый элемент схемы формируется в отдельной изолированной области, а соединения между элементами выполняются путем металлизации на поверхности пассивированной схемы. Изоляция между элементами схемы осуществляется двумя способами: обратносмещенными р - n переходами и диэлектриком Изоляция обратно смещенным переходом реализуется следующими технологическими методами: разделительной, коллекторной изолирующей диффузией; базовой изолирующей диффузией; методом трех фотошаблонов, изоляцией n- полостью.
Для изоляции элементов ИМС диэлектриком используют слой SiO2, и Si3Н4, ситалл, стекло, керамику, воздушный зазор.
3.1. Последовательность операций планарно - эпитаксиальной технологии производства ИМС.
1 - механическая обработка поверхности рабочей стороны кремниевой пластины р -типа до 14-го класса чистоты и травление в парах НСl для удаления нарушенного слоя. Подложки кремния шлифуют до заданной толщины, затем полируют (обычно до 14 класса точности) , подвергают травлению и промывают. Эпитаксиальные структуры не требуют дополнительной механической обработки, а лишь подвергаются травлению и промывке перед процессами создания схем.
2 - окисление для создания защитной маски при диффузии примеси n типа. На поверхности кремния выращивается плотная пленка двуокиси кремния, которая имеет близкий к кремнию коэффициент теплового расширения, что позволяет использовать ее как надежное защитное покрытие, а также изолятор отдельных компонентов ИМС, маску при проведении локальной диффузии и как активную часть прибора в МДП- структурах.
Термическое окисление поверхностей кремния является наиболее технологичным методом получения пленок SiO2. В этом случае качестве окисляющей среды используются сухой или увлажненный кислород либо пары воды. При окислении температура рабочей зоны поддерживается на уровне 1100-1300°С. Окисление проводится методом открытой трубы в потоке окислителя. В сухом кислороде выращивается наиболее совершенный по структуре окисный слой, но процесс окисления при этом проходит медленно (Т=1200 °С), толщина d слоя SiO2 составляет 0,1 мкм). На практике окисление проводят в три стадии: в сухом кислороде, влажном кислороде и снова в сухом. Для стабилизации свойств защитных окисных слоев в процессе окисления в среду влажного кислорода или паров воды добавляют борную кислоту, двуокись титана и др.
3 - фотолитография для вскрытия окон в окисле и проведения локальной диффузии в местах формирования скрытых слоев. Создание на поверхности подложки защитной маски малых размеров, используемой в дальнейшем для проведения локальных процессов травления, диффузии, эпитаксии и др. Образуется с помощью фоточувствительного слоя (фоторезиста), который под действием света изменяет свою структуру По способности изменять свойства при облучении фоторезисты делятся на негативные и позитивные.
Освещение негативного фоторезиста вызывает дополнительную полимеризацию его молекул, вследствие чего после проявления пластины полупроводника на ней остаются нерастворимые участки рисунка, которые представляют собой негативное изображение фотошаблона, а неосвещенные участки фоторезиста смываются в растворителе при проявлении.
В позитивном фоторезисте под действием света происходит разрушение молекул. При проявлении такой фоторезист удаляется с освещенных участков, а на поверхности пластины остается позитивное изображение фотошаблона,
Фоторезист должен быть чувствительным к облучению, иметь высокие разрешающую способность и кислотостойкость.
Для создания определенного рисунка с помощью фоторезиста используется фотошаблон, представляющий собой пластину из оптического стекла, на поверхности которой содержится рисунок соответствующий по размерам будущей микросхеме. Фотошаблон может содержать до 2000 изображений одной микросхемы.
Последовательность фотолитографического процесса состоит в следующем .
На окисленную поверхность кремния с толщиной окисла 3000 - 6000 А наносят слой фоторезиста с помощью центрифуги. Фоторезист сушат сначала при комнатной температуре, затем при температуре 100 -150 0С.
Подложку совмещают с фотошаблоном и облучают ультрафиолетовым излучением. Засвеченный фоторезист проявляют, а затем промывают в деионизированной воде. Оставшийся фоторезист задубливают при комнатной температуре и температуре 200 °С в течение одного часа, после чего окисленная поверхность кремния открывается в местах, соответствующих рисунку фотошаблона. Открытые участки окисла травят в специальных буферных травителях (например, 10 мл НF и 100 мл NH4F в воде). На участки окисла, покрытые фоторезистом, травитель не действует. После травления фоторезист растворяют органическим растворителем и горячей серной кислотой. Поверхность пластины тщательно промывают. На поверхности кремния остается слой SiO2, соответствующий рисунку схемы
4 - диффузия для создания скрытого n-слоя.
Локальная диффузия является одной из основных технологических операций при создании полупроводниковых ИМС.
Диффузия в полупроводниковых кристаллах представляет собой направленное перемещение примесных атомов в сторону убывания их концентрации. В качестве легирующих примесей в кремнии используются в основном бор и фосфор, причем бор создает примеси акцепторного типа, а фосфор донорного. Для бора и фосфора энергия активации соответственно равна 3,7 и 4,4 эВ. Различают два режима диффузии: диффузия из неограниченного источника и диффузия из ограниченного источника. В производстве ИМС реализуются оба случая диффузии. Диффузия из неограниченного источника представляет собой первый этап диффузии, в результате которого в полупроводник вводится определенное количество примеси. Этот процесс называют загонкой примеси.
Для создания заданного распределения примесей в глубине и на поверхности полупроводника проводится второй этап диффузии из ограниченного источника. Этот процесс называется разгонкой примеси.
Локальную диффузию проводят в открытые участки кремния по методу открытой трубы в потоке газа - носителя. Температурный интервал диффузии для кремния составляет 950 - 1300 °С. Кремниевые пластины размещают в высокотемпературной зоне диффузионной печи. Газ - носитель в кварцевой трубе при своем движении вытесняет воздух. Источники примеси, размещенные в низкотемпературной зоне, при испарении попадают в газ - носитель и в его составе проходят над поверхностью кремния.
Источники примеси, применяемые в производстве ИМС, могут быть твердыми: жидкими и газообразными. В качестве жидких источников используются хлорокись фосфора РОСlз и ВВrз. После установления температурного режима в рабочую зону печи поступает кислород, что способствует образованию на поверхности кремния фосфоро - и боросиликатного стекла. В дальнейшем диффузия проходит из слоя жидкого стекла Одновременно слой стекла защищает поверхность кремния от испарения и попадания посторонних частиц. Таким образом, в локальных участках кремния происходит диффузия легирующей примеси и создаются области полупроводника с определенным типом проводимости.
После первой фотолитографии проводится локальная диффузия донорной примеси с малым коэффициентом диффузии (Аs, Sb) и формируется скрытый высоколегированный слой n+ глубиной около 2 мкм.
Примесь с малым коэффициентом диффузии необходимо использовать, чтобы свести к минимуму изменение границ скрытого слоя при последующих высокотемпературных технологических операциях. После этого с поверхности полностью удаляется слой окисла и пластина очищается. На очищенной поверхности кремния выращивается эпитаксиальный слой n-типа толщиной 10-15 мкм с удельным сопротивлением 0,1 - 10 Ом*см.
5 - снятие окисла и подготовка поверхности перед процессом эпитакси-ального наращивания;
6 - формирование эпитаксиальной структуры;
Эпитаксия представляет собой процесс роста монокристалла на ориентирующей подложке. Эпитаксиальный слой продолжает кристаллическую решетку подложки. Толщина его может быть от монослоя до нескольких десятков микрон. Эпитаксиальный слой кремния можно вырастить на самом кремнии. Этот процесс называется авто - или гомоэпитаксией. В отличие от авто-эпитаксии процесс выращивания монокристаллических слоев на подложках, отличающихся по химическому составу, называется гетероэпитаксией.
Эпитаксиальный процесс позволяет получать слои полупроводника однородные по концентрации примесей и с различным типом проводимости (как электронным, так и дырочным). Концентрация примесей в слое может быть выше и ниже, чем в подложке, что обеспечивает возможность получения высокоомных слоев на низкоомной подложке.
В производстве эпитаксиальные слои получают за счет реакции на поверхности подложки паров кремниевых соединений с использованием реакции восстановления SiCl4, SiВг4.
В реакционной камере на поверхности подложки в температурном диапазоне 1150 - 1270 °С протекает реакция
| SiCl4+ 2Н2 <=> Si + 4 HС1, | (3.1) |
в результате которой чистый кремний в виде твердого осадка достраивает решетку подложки, а летучее соединение удаляется из камеры.
Процесс эпитаксиального наращивания проводится в специальных установках, рабочим объемом в которых является кварцевая труба, а в качестве газа-носителя используются водород и азот. Водород перед поступлением в рабочий объем многократно очищается от кислорода, паров воды и других примесей. При установившейся рабочей температуре в поток газа носителя добавляется хлористый водород и производится предварительное травление подложки. После этого вводятся в поток газа SiCl4 и соответствующие легирующие примеси.
7 - окисление поверхности эпитаксиального слоя для создания защитной маски при разделительной диффузии;
8 - фотолитография для вскрытия окон под разделительную диффузию;
9 - проведение разделительной диффузии и создание изолированных карманов;
Разделительная диффузия проводится в две стадии: первая (загонка) -при температуре 1100-1150 °С, вторая (разгонка) - при температуре 1200-1250 °С. В качестве диффузанта используется бор. Разделительная диффузия осуществляется на всю глубину эпитаксиального слоя; при этом в подложке кремния формируются отдельные области полупроводника разделенные р-n переходами. В каждой изолированной области в результате последующих технологических операций формируется интегральный элемент.
10 -окисление;
11 - фотолитография для вскрытия окон под базовую диффузию;
12 - формирование базового слоя диффузией примеси р-типа.
Для проведения базовой диффузии процессы очистки поверхности, окисления и фотолитографии повторяются, после чего проводится двухстадийная диффузия бора: первая при температуре 950-1000 °С, вторая при температуре 1150-1200 °С.
13 -окисление;
14 - фотолитография для вскрытия окон под эмиттерную диффузию;
15 - формирование эмиттерного слоя диффузией примеси n-типа;
Эмиттерные области формируются после четвертой фотолитографии Эмиттерная диффузия проводится в одну стадию при температуре около 1050 °С. Одновременно с эмиттерами формируются области под контакты коллекторов и нижние обкладки МДП-конденсаторов. В качестве легирующей примеси используется фосфор.
16 – фотолитография для вскрытия окон для травления окисла под МДП-конденсаторы.
Данный этап необходим для создания тонкого окисла между верхней и нижней обкладками конденсатора. Он получается травлением пассивирующего слоя до нужной толщины.
17 – формирование тонкого окисла в местах создания МДП-конденсаторов.
18 - фотолитография для вскрытия контактных окон;
19 - напыление пленки алюминия.
Соединения элементов ИМС создаются металлизацией. На поверхность ИМС методом термического испарения в вакууме наносится слой алюминия толщиной около 1 мкм. После фотолитографии на поверхности ИМС остаются металлические соединения, соответствующие рисунку схемы. После фотолитографии металл обжигается в среде азота при температуре около 500°С.
20 - фотолитография для создания рисунка разводки и нанесение слоя защитного диэлектрика.
21 – фотолитография для вскрытия окон контактных площадок для последующего приваривания проводников.
4. Последовательность расчета параметров биполярного транзистора.
Исходные данные для расчета.
Максимальное напряжение на коллекторном переходе: Uкб = 1,5 В
Максимальный ток эмиттера: Іэ = 4,5 мА
Граничная частота fт = 500 МГц.
Дальнейший расчет проводится с помощью программы расчета параметров биполярных транзисторов, результаты расчета, представленные ниже, были получены с помощью данной программы.
Расчет выполняется в следующей последовательности.
1. По заданному максимально допустимому напряжению Uкб определяют пробивное напряжение Uкб0 , которое должно быть хотя бы на 20% больше Uкб и учитывает возможные колебания напряжения питания, т.е. Uкб0=1,2 Uкб, в нашем случае Uкб0=1,8 В. Пробивное напряжение Uпр коллекторного перехода выбираем с коэффициентом запаса 3, это учитывает возможность пробоя по поверхности и на закруглениях коллекторного перехода. В нашем случае Uпр = 5,4 В.
По графику зависимости Uпр (Nдк) [1] , где Nдк – концентрация доноров в коллекторе, находят Nдк . В программе расчета значение концентрации находится численными методами. В нашем случае Nдк = 5·1017 см-3. Данное значение слишком велико, т.к при таком значении возможно появление паразитного n-канала, поэтому уменьшим его до 1016 см-3.
По графику зависимости подвижности электронов от их концентрации [1] находят подвижность электронов. В нашем случае mn = 1200 см2/(В·с).
2. Определяют характеристическую длину распределения акцепторов Lа и доноров Lд:
|
| ( 4.1) |
где хjк – глубина коллекторного перехода. В нашем случае La = 0,374 мкм; Lд = 0,0748 мкм.
3. Для расчета ширины ОПЗ (области пространственного заряда) на коллекторном и эмиттерном переходах предварительно вычисляют контактную разность потенциалов на коллекторном переходе:
|
| ( 4.2 ) |
где fт – тепловой потенциал, равный 0,0258 В при Т=300 К.; ni – концентрация собственных носителей заряда в кремнии (ni» 1010 см-3). В нашем случае fк = 0,6771 В.
Контактная разность потенциалов на эмиттерном переходе fэ рассчитывается аналогично fк. В нашем случае fэ = 0,1809 В.
4. Рассчитывают ширину ОПЗ, распространяющуюся в сторону базы (Dхкб) и в сторону коллектора (Dхкк) при максимальном смещении коллекторного перехода Uкб :
|
| ( 4.3 ) |
|
| ( 4.4 ) |
где  , e0, eн – соответственно диэлектрическая постоянная и относительная диэлектрическая проницаемость полупроводниковой подложки.
, e0, eн – соответственно диэлектрическая постоянная и относительная диэлектрическая проницаемость полупроводниковой подложки.
В нашем случае Dхкб = 0,387 мкм, Dхкк = 0,6656 мкм.
5. Выбираем ширину технологической базы равной 1 мкм.
6. Определяем концентрацию акцепторов на эмиттерном переходе:
| Na(xjэ) = Nдкexp(Wб0/La) | ( 4.5 ) |
В нашем случае Na(xjэ) = 1,338·1017 см-3.
7. В результате высокой степени легирования эмиттера область объемного заряда на эмиттерном переходе в основном будет сосредоточена в базе. Приближенно можно считать, что Dхэб » Dхэ, где
|
| ( 4.6 ) |
В нашем случае Dхэ = 0,08858 мкм.
8. Расчитываем ширину активной базы:
| Wба = Wб0 - Dхэ - Dхкб | ( 4.7 ) |
В нашем случае Wба = 0,4944 мкм.
Дальнейший расчет транзистора включает вычисление площади эмиттерного перехода,
Похожие работы
... всех сферах деятельности человека. Созданию систем автоматического проектирования, промышленных роботов, автоматизированных и автоматических производственных линий, средств связи и многому другому способствует микроэлектроника. /1/ Цель работы: проектирование топологии гибридной интегральной микросхемы К2ТС241 (RST-триггер) 1. ОБЩИЙ РАЗДЕЛ 1.1 Характеристика схемы Гибридные ...
... ). Перспективы развития микроэлектроники Функциональная микроэлектроника. Оптоэлектроника, акустоэлектроника, магнетоэлектроника, биоэлектроника и др. Содержание лекций 1 Цели и задачи курса “Электронные, квантовые приборы и микроэлектроника”. Физика полупроводников. p-n- переходы. Полупроводниковые диоды. Разновидности и характеристики. 2 Транзисторы. Принцип действия, разновидности и ...
... принципов и явлений, реализация которых позволяет получить приборы со сложным схемотехническим или системотехническим функциональным назначением. В функциональной микроэлектронике начинают использовать (рис.1): Рис. 1. Основные направления функциональной микроэлектроники. Оптические явления (когерентная и некогорентная оптика, нелинейная оптика, электрооптика, магнитооптика). Их ...
... технологии широкополосного доступа - по электросетям. Было разработано оборудование PLC первого и второго поколений. Достигнутая предельная скорость передачи данных не превышала 10-14 Мб/с. Реальная же скорость передачи данных в тестовых сетях PLC с применением этого оборудования отличалась на порядок и составляла 1-2 Мб/с. Кроме этого, абонентское оборудование PLC имело сравнительно высокую ...
















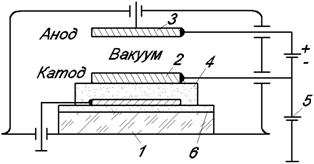


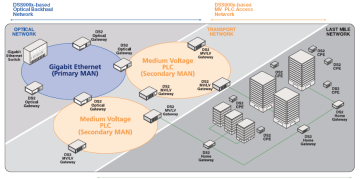
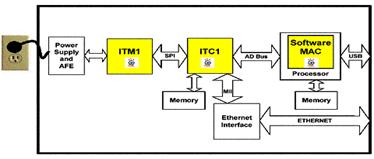
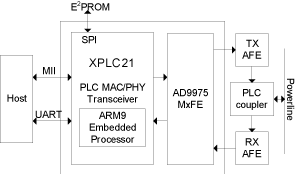

0 комментариев