Навигация
Технологические основы электроники
Реферат
1. Изобразить и описать последовательность формирования изолированных областей в структуре с диэлектрической изоляцией
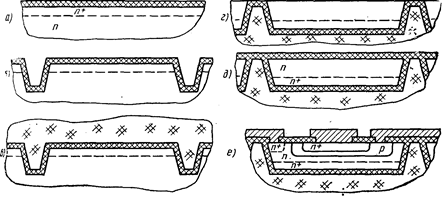
Рис. 1. Последовательность формирования изолированных областей в структуре с диэлектрической изоляцией:
а — исходная пластина; б — избирательное травление окисла, глубокое травление кремния, окисление поверхности; в — осаждение поликристаллического кремния; г — шлифование и полирование обратной стороны пластины; д — окисление поверхности; е — готовая структура после базовой и эмиттерной диффузии и получения межсоединений
На рис.1 представлена последовательность формирования структуры с диэлектрической изоляцией. В исходной пластине кремния n-типа методом фотолитографии вытравливают участки окиси кремния, а затем и кремния по контуру будущих элементов. В результате образуются канавки по замкнутому контуру. Полученную рельефную поверхность окисляют. Далее эту поверхность покрывают толстым слоем кремния методом осаждения. Вследствие дезориентирующего влияния окисного слоя осажденный кремний имеет поликристаллическую структуру и служит конструкционным основанием будущей ИМС. Обратную сторону шлифуют, удаляя монокристаллический слой до вскрытия окиси кремния по границам областей, и производят доводку (для удаления нарушенного слоя). После протравливания и отмывки поверхности ее окисляют. Далее в образовавшихся изолированных областях монокристаллического кремния n-типа диффузионным методом формируют элементы (базовые области, резисторы, эмиттеры, области под контакты). Обычным путем получают и межсоединения на поверхности пластины. Если исходная пластина содержит эпитаксиальный n+-слой, то транзисторы получаются со скрытым слоем.
2. Изобразить схему технологического процесса изготовления ИМС эпитаксиально-планарной структуры без скрытого слоя.

Рис. 2. Последовательность формирования эпитаксиально-планарной структуры:
а—исходная пластина; б—стравливание окисла, подготовка поверхности; в—эпитаксиальное наращивание n-слоя, окисление поверхности; г—вскрытие окон в окисле под изолирующую (разделительную) диффузию примеси; д — диффузия акцепторной примеси, окисление поверхности; е — готовая структура после формирования диффузионных базовых и эмиттерных областей, а также получения межсоединений
Чтобы получить простейшую эпитаксиально-планарную структуру, в качестве исходной заготовки используют монокристаллическую пластину кремния, равномерно легированную акцепторной примесью. Для нанесения эпитаксиального слоя на одну из сторон пластины ее освобождают от окисла и тщательно очищают (рис.2), после чего проводят осаждение монокристаллического слоя кремния n-типа. Далее поверхность пластины окисляют и методом фотолитографии вскрывают окна в виде узких замкнутых дорожек, соответствующих контуру коллекторных и изолирующих областей ПМС. Проводя через окна диффузию акцепторной примеси до смыкания ее с р-областью, получают таким образом изолированные друг от друга островки равномерно легированного эпитаксиального n-кремния. Рассмотренный процесс диффузии называют изолирующей или разделительной диффузией. В полученной на данной стадии заготовке (рис. 2,д) в дальнейшем формируют базовые и эмиттерные области (диффузионным методом), а также контакты и межсоединения.
3. Каким образом осуществляется изоляция в изопланарной структуре
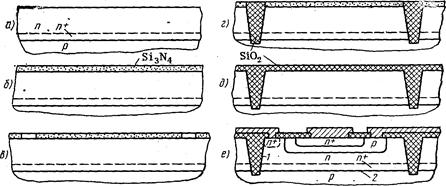
Рис. 3 Последовательность формирования изолированных областей
в изопланарной структуре:
а—пластина с эпитаксиальным и скрытым слоями; б — нанесение слоя нитрида кремния;
в — избирательное травление нитрида кремния по контуру будущих элементов; г — глубокое окисление кремния; д — стравливание нитрида кремния и окисление поверхности;
е—готовая структура после формирования базовых и эмиттерных областей а также межсоединений
На рис. 3,е представлена изопланарная структура транзистора, в которой донная часть 2 коллектора изолирована от монокристаллической пластины
р-n-переходом, а боковая 1— толстым слоем окисла, полученным сквозным локальным окислением эпитаксиального слоя.
Начальные стадии процесса получения изопланарной структуры следующие (рис. 3). На поверхность пластины, содержащей эпитаксиальные n+- и n-слои, осаждают (из газовой фазы) слой нитрида кремния Si3N4. Методом фотолитографии в этом слое образуют защитную маску с окнами по контуру коллекторных областей. В процессе окисления нитридная маска сохраняется. Затем ее стравливают и всю поверхность окисляют. Далее проводят диффузию для формирования базы и эмиттера, формируют контактные окна и межсоединения.
4. Используется ли эпитаксия при создании КМДП-структуры
Полная изоляция МДП-транзисторов обеспечивается при формировании их в виде островков на монокристаллической изолирующей пластине. В качестве изолирующей пластины обычно используют синтетический сапфир, имеющий достаточно хорошее кристаллографическое сопряжение с кремнием. Поэтому эти структуры получили название структур «кремний на сапфире» или сокращенно КНС. Эпитаксиально выращенный на сапфире кремний имеет высокую плотность структурных нарушений (дислокации), что заметно снижает подвижность носителей заряда. Вследствие этого структуры на биполярных транзисторах оказались не эффективными и наиболее широкое применение нашли МДП-КНС-структуры, особенно КМПД-КНС-структуры. В отличие от структур, изолированных р-n-переходом, когда используется высокоомная (слаболегированная) пластина, структуры на изолирующей пластине устойчивы к температурным и радиационным воздействиям.
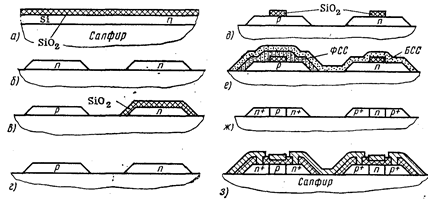
Рис. 4 Последовательность формирования КМДП-КНС-структуры:
а—исходная пластина «сапфир—эпитаксиальный кремний—окись кремния»; б—избирательное анизотропное травление кремния с помощью оксидной маски (образование островков); в—избирательная диффузия акцепторной примеси; г — снятие маски с островков; д — маскирование островков с помощью SiO2; е — избирательное покрытие фосфорсиликатным стеклом (ФСС) р-островков и общее покрытие боросиликатным стеклом (БСС); ж— структура после диффузии примесей и стравливания БСС, ФСС и SiO2, з — готовая структура после нанесения SiO2 и формирования межсоединений
В процессе формирования КМДП-КНС-структуры (рис. 4) методом эпитаксиального наращивания (процесс гетероэпитаксии) создают сплошной слой высокоомного п-Si. После маскирования окисью кремния и анизотропного травления получают отдельные изолированные островки п-Si. Проведя повторное маскирование окисью кремния, методом диффузии часть островков легируют акцепторной примесью на всю глубину, превращая их в островки р- Si. Предварительно защитив маской из окиси кремния участки будущих каналов, избирательно покрывают р-островки фосфоро-силикатным (SiO2.P2O5), а n-островки — боросиликатным (SiO2.B2O3) стеклами. Последующим нагревом диффундируют до-норную (Р) и акцепторную (В) примеси из легированных стекол в области стоков и истоков. В дальнейшем стекло и участки SiO2 стравливают, наносят слой окиси кремния, вытравливают участки окисла под затвор, выращивают тонкий слой диэлектрика и формируют затворы, а также межсоединения. Гетероэпитаксиальные слои, полученные в таких структурах, имеют небольшую толщину (~1 мкм), что обусловлено относительным несовершенством кристаллической структуры, выращиваемой на сапфире: с увеличением толщины пленки плотность дислокации увеличивается.
МДП-приборы, в которых в качестве канала используется тонкий приповерхностный слой, вполне могут быть реализованы в тонких эпитаксиальных слоях порядка десятых долей микрометра. Однако тонкие эпитаксиальные слои практически исключают возможность многократного образования окиси кремния за счет термического окисления, так как толщина слоя SiO2, необходимого для защиты при термической диффузии, соизмерима с толщиной такого эпитаксиального слоя. Поэтому обычно слои окиси кремния получают методом осаждения из газовой фазы, что, кстати, позволяет использовать относительно низкие температуры.
5. Указать недостатки методов диффузии
Метод термической диффузии примеси имеет ряд недостатков и ограничений.
1. Высокая температура процесса приводит к перераспределению примеси в ранее сформированных слоях и областях и смещению р-n-переходов, что затрудняет воспроизводимость активной базы транзисторов толщиной менее 0,6 мкм.
2. Наличие боковой диффузии увеличивает площадь отдельных диффузи-онных областей и элементов в целом.
3. Зависимость коэффициента диффузии и растворимости примеси от температуры исключают возможность использовать многие полупроводниковые материалы и легирующие элементы, перспективные для микроэлектроники.
6. Желательно или нет присутствие второго максимума на профиле распределения примеси
Профиль распределения. При облучении монокристаллической мишени ионами в направлениях, отличающихся от основных, профиль распределения внедренных атомов описывается нормальным законом распределения (рис. 5):
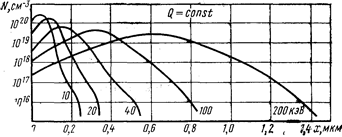
Рис.5 Профили распределения электрически активных атомов бора при различных
энергиях ионного пучка
![]() (1)
(1)
![]()
![]() где Q — доза легирования [см-2]; — средняя длина пробега ионов [см]; —среднеквадратическое отклонение длин пробегов [см].
где Q — доза легирования [см-2]; — средняя длина пробега ионов [см]; —среднеквадратическое отклонение длин пробегов [см].
![]() Максимальная концентрация примеси, соответствующая средней длине пробега ,
Максимальная концентрация примеси, соответствующая средней длине пробега ,
![]() (2)
(2)
а концентрация примеси на уровне р-n-перехода
![]() (3)
(3)
Если допустить, что в процессе отжига вся внедренная примесь переходит в активное состояние, а перераспределением примеси можно пренебречь, то глубина залегания р-n-перехода из (2) и (3) окажется равной
![]() (4)
(4)
Знак «±» указывают на возможность получения двух переходов на разной глубине, т. е. образования заглубленного (скрытого) слоя. Так, например, при внедрении бора с энергией ионов 160 кэВ и концентрацией Nmax=1018 см-3 в пластину с концентрацией фосфора Nисх=1016 см-3 образуются два перехода на глубине 0,248 и 3,952 мкм. Необходимая при этом доза легирования согласно (2) равна 2,9х1013 см-2. Решение обратной задачи, т. е. определение энергии ионов, необходимой для образования переходов на заданной глубине, может быть выполнено лишь на ЭВМ с помощью итерационных алгоритмов.
В монокристаллах можно выделить направления, вдоль которых имеются периодически расположенные атомные цепочки и свободные от атомов каналы. При облучении мишени в таких направлениях наблюдаются аномально большие пробеги ионов, так как большая их часть проникает в глубь решетки по каналам, испытывая относительно слабое торможение. В кремнии эффект каналирования ионов наблюдается в направлениях <110>, <100> и <111>. Наименьшая плотность атомов имеет место в плоскостях {110} (рис. 6), наибольшая — в {111}. Соответственно средняя длина пробега ионов в направлениях <110> вдвое больше, чем в направлениях <111>.

Рис. 6 Проекция структуры Si на плоскость (110)
При каналировании потери энергии ионов происходят в основном за счет взаимодействия с электронами. Ядерное торможение в канале возможно только при столкновении ионов с атомами полупроводника и примеси, расположенными в междоузлиях. Часть ионов испытывает раннее торможение вблизи поверхности кристалла из-за столкновений с атомами кристаллической решетки. По мере облучения мишени плотность дефектов в приповерхностном слое возрастает (каналы перекрываются атомами, смещенными в область канала) и эффект каналирования исчезает. Характер распределения примесей, отвечающий описанным явлениям, показан на рис. 7. При больших дозах облучения в распределении примеси имеется два максимума.

Рис. 7 Распределение примеси при каналировании ионов:
1 — при умеренных дозах легирования;
2 — при больших дозах легирования
7. Какой минимальный размер элементов можно получить при рентгеновской литографии? Чем ограничена разрешающая способность?
При помощи рентгеновской литографии можно достичь разрешения
до 0,05 мкм.
В отличие от фотолитографии, где экспонирование производится широкими коллимированными световыми пучками, рентгенолитография не располагает соответствующей «оптикой» и экспонирование на рентгеновских установках приходится выполнять в пучках с большим углом расходимости. При наличии зазора между шаблоном и подложкой это приводит к искажению размеров и смещению элементов рисунка, передаваемого в слой резиста. Максимальное смещение элемента возникает на периферии пластины и равно ![]() , параметры на рис. 8.
, параметры на рис. 8.

Рис. 8 Схема экспонирования на рентгеновской установке с вращающейся мишенью
Кроме того, конечные размеры пятна на поверхности мишени из-за низкой степени фокусировки снижают контрастность изображения в слое резиста. Размытость изображения, т. е. ширина зоны полутени по контуру элемента, ![]() . Удовлетворительные результаты получают при
. Удовлетворительные результаты получают при ![]() mm,
mm, ![]() мкм и
мкм и ![]() см.
см.
Расходящиеся пучки рентгеновских трубок имеют в плоскости подложки невысокую плотность потока энергии. Это вынуждает использовать в производстве высокочувствительные негативные рентгенорезисты, обладающие ограниченным (~0,5 мкм) разрешением.
Похожие работы
... условиям эксплуатации и конструктивным показателям, могут образовывать семейства серий интегральных схем. 2. ЛОГИЧЕСКИЕ ЭЛЕМЕНТЫ Логические и запоминающие элементы составляют основу устройств цифровой обработки информации – вычислительных машин, цифровых измерительных приборов и устройств автоматики. Логические элементы выполняют простейшие логические ...
... полярности источников питания на рисунке 3.4 и направления токов для p-n-p транзистора. В случае n-p-n транзистора полярности напряжения и направления токов изменяются на противоположные. Рисунок 3.4 Физические процессы в БТ. Этот режим работы (НАР) является основным и определяет назначение и название элементов транзистора. Эмиттерный переход осуществляет инжекцию носителей в узкую ...
... электротехнических и электронных устройств, в которых используется явление резонанса напряжения. Литература 1. Иванов И.И., Равдоник В.С. Электротехника. - М.: Высшая школа, 1984, с.53 - 58. 2. Касаткин А.С., Немцов М.В. Электротехника. - М.: Энергоатомиздат, 1983, с.73 - 77. Лабораторная работа №5 КОМПЕНСАЦИЯ РЕАКТИВНОЙ МОЩНОСТИ Цель работы. Ознакомление с методом повышения ...
... (на ряде свалок возникли пожары (которые не удавалось потушить годами), активно развивается технология их сжигания. Водород. Набирает силу новая отрасль промышленности - водородная энергетика и технология. Потребность экономики в водороде идет по нарастающей. Ведь это простейшее и легчайшее вещество может использоваться не только как топливо, но и как необходимый сырьевой элемент во многих ...



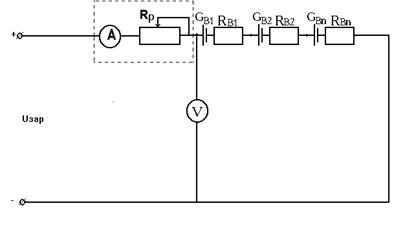
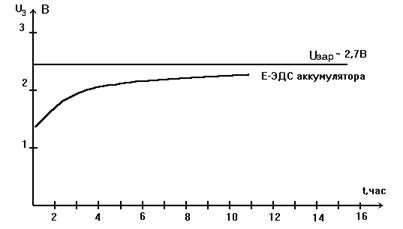


0 комментариев