Навигация
Изобразить схему вакуумной системы многопозиционной установки для вакуумного напыления
10. Изобразить схему вакуумной системы многопозиционной установки для вакуумного напыления
Известно, что для получения рабочего вакуума затрачивается время до 1,5—2 ч (даже при разогретом диффузионном насосе). Так как время напыления отдельного слоя редко превышает 1-1,5 мин, то стремятся использовать многопозиционные вакуумные установки, позволяющие, не нарушая вакуума (за один вакуумный цикл), последовательно или одновременно обрабатывать несколько подложек. Эффект еще более значителен, если при этом применяют групповые подложки. Обычно используют групповые ситалловые подложки стандартного размера 60х48 или 120х96 мм.
По степени непрерывности процесса обработки МПВУ могут быть разделены на две группы: однокамерные периодического действия и многокамерные полунепрерывного или непрерывного действия.
Установки первой группы работают по следующему циклу: установка подложек—откачка рабочего объема - обработка (напыление) - снятие вакуума и вскрытие—снятие обработанных подложек. Для таких установок характерно, что вспомогательное время на откачку не перекрывается с основным технологическим временем, а также что установка подложек и их совмещение с масками выполняются вручную (непосредственно или через соответствующие механизмы).
В установках, второй группы откачка частично (МПВУ полунепрерывного действия) или полностью (МПВУ непрерывного действия) совмещается с основным процессом обработки. Это достигается с помощью многокамерной системы с различным уровнем вакуума в отдельных- камерах. В подобных установках можно выполнять полный цикл изготовления микросхемы, т. е. напылять все слои, поэтому в обработке одновременно (на разных стадиях) могут находиться несколько подложек. Управление в таких установках (транспортировка подложек и фиксация их на рабочих позициях) осуществляется автоматически. Таким образом, установки второй группы представляют собой автоматические линии.
Однокамерная установка периодического действия имеет внутрикамерное многопозиционное устройство карусельного типа, которое выполняют в одном из двух вариантов: либо в каждой позиции карусели (барабане) устанавливают подложку в комплекте с трафаретом (если таковые используют в данном процессе), либо на карусели устанавливают только подложки, а маски размещают в неподвижном многопозиционном диске и, таким образом подложка, переходя из позиции в позицию, последовательно совмещается с различными масками.
В установках первого типа обычно имеется одна рабочая позиция (позиция напыления), поэтому в каждый момент времени обрабатывается лишь одна подложка. К таким установкам, в частности, относится УВН-2М-2, упрощенная схема внутрикамерного устройства которой представлена на рис.11
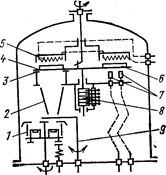
Рис. 11 Схема внутрикамерного устройства УВН-2М-2:
1 — карусель испарителей; 2 — экраны; 3—диафрагма; 4 — карусель трафаретов и подложек; 5 — нагреватель подложек; 6 — имитатор с датчиками температуры и сопротивления пленки; 7 — электроды войной очистки; 8 — коллектор; 9 — заслонка
В данном случае карусель подложек и масок имеет восемь позиций и может непрерывно вращаться со скоростью 40—150 об/мин. Это обеспечивает идентичность свойств пленки на всех подложках. На базовой плите смонтирована пятипозиционная карусель резистивных испарителей таким образом, что питание подается только на тот испаритель, который выведен на рабочую позицию.
Технологические возможности такой установки в основном заключаются в напылении элементов одного слоя через трафареты, а также в напылении двух сплошных слоев (например, резистивного и проводящего) с последующей двухкратной фотолитографией.
Внутрикамерное устройство включает в себя также систему ионной очистки, установленную неподвижно в одной из позиций, систему нагрева подложек, датчики контроля сопротивления и толщины наносимой пленки.
11. Описать метод получения пленок путем катодного распыления
Атомарный (молекулярный) поток вещества можно получить, бомбардируя поверхность твердого образца ионами с энергией порядка сотен и тысяч электрон-вольт. Энергия ионов при этом в несколько раз превышает теплоту сублимации поверхностных атомов и образец (мишень) интенсивно распыляется. В процессе бомбардировки мишень активно охлаждают. Это исключает протекание в ней диффузионных процессов. В условиях повышенного по сравнению с термическим вакуумным напылением давления значительная часть распыленных атомов рассеивается, что, с одной стороны, уменьшает скорость осаждения, а с другой — повышает равномерность осаждения пленки по площади подложки. Этому же способствует и большая площадь мишени.
Таким образом, по сравнению с термическим испарением в вакууме распыление ионной бомбардировкой позволяет:
1) получать пленки из тугоплавких металлов, перспективных для микроэлектроники;
2) наносить на подложку соединения и сплавы без диссоциации и фракционирования, т. е. без изменения исходного состава;
3) осаждать окисные, нитридные и другие пленки за счет химического взаимодействия распыляемого материала с вводимыми в камеру химически активными газами (реактивное катодное распыление);
4) получать равномерные по толщине пленки на большой площади, в частности, при наличии поверхностного рельефа;
5) многократно использовать мишень в качестве источника материала, что повышает однородность процесса и облегчает его автоматизацию (например, в установках непрерывного действия);
6) обеспечивать высокую адгезию пленок к подложке благодаря специфическим условиям на подложке и высокой энергии осаждающихся атомов (частичное внедрение в решетку материала подложки);
7) обеспечивать малую инерционность процесса.
Для распыления мишени используют ионы инертных газов (обычно аргон высокой чистоты). Источником ионов служит либо самостоятельный тлеющий разряд, либо плазма несамостоятельного разряда (дугового или высокочастотного). В настоящее время в производстве применяют различные процессы распыления, отличающиеся характером питающего напряжения (постоянное, переменное, высокочастотное), способом возбуждения и поддержания разряда (автоэлектронная эмиссия, термоэмиссия, магнитное поле, электрическое ВЧ-поле и т.д.), числом электродов. Такое разнообразие процессов и их модификаций обусловлено стремлением улучшить основные технологические показатели — скорость осаждения, чистоту и однородность по толщине получаемой пленки, а также стремлением расширить круг материалов, используемых для получения пленок этим методом.
Физические основы процесса целесообразно рассмотреть на примере простейшей его разновидности — катодного распыления на постоянном токе самостоятельного тлеющего разряда.

Рис. 12 Схема катодного распыления (двухэлектродная система) и характер распределения потенциала в пространстве между катодом и анодом:
1—анод; 2—подложка; 3 — изолятор;4—экран; 5 — катод-мишень
Физические основы катодного распыления. При катодном распылении используют простейшую двухэлектродную схему (рис.12), называемую также диодной схемой распыления, которая состоит из катода (распыляемой мишени) и анода. Подложки размещают на аноде. Тлеющий разряд создается в разреженном аргоне при давлении 1—10 Па. В процессе распыления непрерывно работает система откачки, а аргон с определенным расходом поступает в камеру через натекатель, что и обеспечивает заданное давление газа. Катод-мишень наводится под отрицательным потенциалом относительно заземленного анода.
Возможные режимы самостоятельного тлеющего разряда можно описать с помощью вольт-амперной характеристики (рис. 13)

Рис. 13 Вольт-амперная характеристика самостоятельного газового разряда
В исходном газовом промежутке «катод — анод» вследствие фотоэмиссии катода, воздействия космического излучения и других причин всегда присутствуют электроны. Кроме того, при высоких напряжениях имеет место автоэлектронная эмиссия с холодного катода. Поэтому пробивная напряженность электрического поля в таком промежутке при давлениях 1—10 Па составляет около 0,5 кВ/см. Для расстояний между анодом и катодом L=3![]() 8 см напряжение необходимое для электрического пробоя и зажигания разряда (напряжение зажигания) порядка 1,5—4 кВ. Приобретая в электрическом поле энергию, электроны движутся к аноду, ионизируя по пути атомы газа, в результате чего происходит лавинообразное нарастание потока электронов к аноду и (встречного) ионов к катоду. Вследствие этого резко повышается проводимость газового промежутка, возрастает ток и снижается напряжение [до нескольких сотен вольт (участок 1 на рис. 13)]. Возникающий при этом разряд может стать стационарным лишь при условии, если с катода в разрядный промежуток будут поступать электроны в количестве, достаточном для поддержания концентрации электронов и ионов в разряде. По достижении катода ионы рекомбинируют (нейтрализуются) с электронами, поступающими на катод из внешней цепи. Освобождающаяся энергия достаточна (с определенной вероятностью
8 см напряжение необходимое для электрического пробоя и зажигания разряда (напряжение зажигания) порядка 1,5—4 кВ. Приобретая в электрическом поле энергию, электроны движутся к аноду, ионизируя по пути атомы газа, в результате чего происходит лавинообразное нарастание потока электронов к аноду и (встречного) ионов к катоду. Вследствие этого резко повышается проводимость газового промежутка, возрастает ток и снижается напряжение [до нескольких сотен вольт (участок 1 на рис. 13)]. Возникающий при этом разряд может стать стационарным лишь при условии, если с катода в разрядный промежуток будут поступать электроны в количестве, достаточном для поддержания концентрации электронов и ионов в разряде. По достижении катода ионы рекомбинируют (нейтрализуются) с электронами, поступающими на катод из внешней цепи. Освобождающаяся энергия достаточна (с определенной вероятностью ![]() ), чтобы вызвать эмиссию электрона с поверхности катода (вторичная ионно-электронная эмиссия), а при определенной кинетической энергии ионы могут выбивать также атомы из материала катода (распыление). Вторичные электроны в результате столкновений должны создавать такое количество ионов (в среднем 1/
), чтобы вызвать эмиссию электрона с поверхности катода (вторичная ионно-электронная эмиссия), а при определенной кинетической энергии ионы могут выбивать также атомы из материала катода (распыление). Вторичные электроны в результате столкновений должны создавать такое количество ионов (в среднем 1/![]() на один электрон), которое, с одной стороны, компенсирует их убыль в результате нейтрализации, а с другой — обеспечивает постоянный приток вторичных электронов с катода. В этом случае разряд поддерживает сам себя и называется самостоятельным тлеющим разрядом.
на один электрон), которое, с одной стороны, компенсирует их убыль в результате нейтрализации, а с другой — обеспечивает постоянный приток вторичных электронов с катода. В этом случае разряд поддерживает сам себя и называется самостоятельным тлеющим разрядом.
Для тлеющего разряда характерно определенное распределение потенциала, обусловленное расположением пространственных зарядов. Не рассматривая тонкой структуры разряда, можно выделить в нем две основные области: темное катодное пространство и положительный светящийся столб (см. рис. 12). Толщина dк темного катодного пространства (ТКП) приблизительно равна среднему расстоянию, которое проходит вторичный электрон от катода до первого ионизирующего столкновения. В дальнейшем электрон еще способен многократно ионизировать молекулы газа, поскольку его энергия в момент первого столкновения составляет сотни электрон-вольт и существенно превышает энергию, необходимую для ионизации атома, например, аргона (15,7 эВ). Поэтому непосредственно за ТКП образуется область ионизированного газа, в которой число электронов и положительных ионов примерно одинаково. Эта область (область положительного столба) характеризуется высокой проводимостью и малым падением напряжения. Свечение положительного столба объясняется возбуждением нейтральных молекул при их столкновении с электронами, а также рекомбинацией ионов. Благодаря экранирующему действию электронов положительные ионы перемещаются в направлении к катоду главным образом за счет диффузии, так как их дрейф в таких условиях незначителен. Достигая границы ТКП, ионы ускоряются сильным полем и бомбардируют катод. Из-за различия в скорости ионов и электронов в ТКП образуется положительный пространственный заряд, который и обусловливает значительное падение напряжения и высокую напряженность поля. Таким образом, ТКП, в котором практически сосредоточено все поле, играет решающую роль как в обеспечении разряда, так и в процессе распыления. Оно обеспечивает энергию электронов, необходимую для поддержания разряда, и энергию ионов, необходимую для эффективной бомбардировки катода-мишени.
В установившемся режиме (участок 2 ВАХ) падение напряжения в области ТКП принимает определенное значение uнк, называемое нормальным катодным напряжением. Оно зависит от рода газа, его давления р, материала мишени и до определенного значения не зависит от разрядного тока. Последнее объясняется условиями существования нормального тлеющего разряда: при увеличении разрядного тока (за счет увеличения подводимой мощности) площадь катода, покрытая разрядом, увеличивается таким образом, что плотность тока остается неизменной и минимально необходимой для эмиссии вторичных электронов, поддерживающих самостоятельный разряд. Из-за низкой плотности тока распыление мишени в режиме нормального тлеющего разряда незначительно.
Когда вся площадь катода покроется разрядом, дальнейшее увеличение тока приводит к возрастанию его плотности. Это ведет к повышению катодного падения напряжения и повышению коэффициента вторичной электронной эмиссии ![]() , обеспечивающих самостоятельный разряд. Участок 3 ВАХ соответствует аномальному тлеющему разряду и используется для распыления в производственных условиях.
, обеспечивающих самостоятельный разряд. Участок 3 ВАХ соответствует аномальному тлеющему разряду и используется для распыления в производственных условиях.
С повышением тока увеличиваются плотность тока и интенсивность распыления. При некотором значении плотности тока, зависящем от условий охлаждения мишени, катод сильно разогревается и начинает заметно проявляться термоэлектронная эмиссия. Ток в разряде возрастает, а напряжение падает, поскольку разряд становится несамостоятельным и имеет характер дугового разряда (участок 4 ВАХ). Для предотвращения перехода тлеющего разряда в дуговой высоковольтный источник питания должен иметь ограничения по мощности, а мишень интенсивно охлаждаться.
Основной характеристикой, определяющей эффективность распыления, является коэффициент распыления kp, представляющий собой среднее число атомов мишени, распыленных одним ионом. Коэффициент распыления зависит от энергии иона ЕИ, его массы (рода рабочего газа), материала мишени и в некоторой степени от ее температуры и состояния поверхности, а также от угла падения иона. В табл. 1 приведены значения коэффициентов распыления для некоторых металлов.
Таблица 1 Значения коэффициента распыления
| Распреде-ляемое вещество | Коэффициент распыления kP | |||
| при ЕИ=600 эВ | при ЕИ =1 кэВ | |||
| Аг | Кг | Аг | Кг | |
| Си | 2,3 | 2,8 | 3,2 | 3,4 |
| Fe | 1,3 | 1,2 | 1,4 | 1,4 |
| Мо | 0,9 | 1,1 | 1,1 | 1,2 |
| Ni | 1,5 | 1,5 | 2,1 | 1,7 |
Коэффициент распыления необходимо рассматривать как случайную величину, обладающую определенными статистическими характеристиками. Как следует из таблицы, увеличение коэффициента распыления возможно за счет увеличения как энергии ионов, так и молекулярной массы газа, в среде которого происходит распыление (Аг, Кг).
Увеличение давления рабочего газа повышает вероятность столкновения распыленных атомов с молекулами газа, в результате чего часть атомов не приходит на подложку, а рассеивается в объеме камеры или возвращается на мишень. При этом скорости распыления и осаждения падают. Таким же образом влияет на эти параметры увеличение расстояния L от катода до подложки. Минимально допустимое значение L должно несколько превышать ширину темного катодного пространства dК, иначе вероятность ионизирующих столкновений вторичных электронов резко уменьшится и разряд станет нестабильным. В то же время высокая энергия электронов вблизи границы ТКП приводит к тому, что интенсивность бомбардировки поверхности подложки повышается и она разогревается, результатом чего является снижение скорости осаждения, а в ряде случаев - возникновение нежелатель-ных радиационных нарушений поверхностного слоя. На практике расстояние L подбирают экспериментально.
Из сказанного следует, что массовая скорость распыления вещества катода, т.е. количество вещества в граммах, распыленного с 1 см2 катода в 1 с, определяется для аномально тлеющего разряда выражением
w=k(u-uНК)J/(pL) (5)
где и—напряжение «анод—катод»; иНК—нормальное катодное падение напряжения, при котором распыление пренебрежимо мало;
J—плотность разрядного тока; р—давление рабочего газа; L— расстояние «катод—подложка»; k—постоянная, зависящая от рода газа и материала катода.
Из проведенного анализа ясно, что все технологические параметры распыления (и, иНК, J и р) функционально связаны друг с другом и выбор одного из них однозначно определяет значения других. Это положение иллюстрируется рис. 14, на котором представлены рабочие участки вольт-амперных характеристик разряда при различных давлениях рабочего газа, а также нагрузочная выходная характеристика блока питания. Точка пересечения нагрузочной характеристики с ВАХ определяет режим распыления.

Рис. 14 Семейство ВАХ аномально тлеющего разряда при различных давлениях газовой
смеси (р1> р2> р3> р4> р5) и нагрузочная характеристика (N) блока питания
При распылении сплавов скорость процесса для разных компонентов в общем случае различна. Обеспечить заданный состав пленок при ионном распылении в большинстве случаев проще, чем при термическом вакуумном напылении. Один из приемов заключается в использовании составных (мозаичных) мишеней, причем соотношение площадей компонентов мишени рассчитывают, исходя из заданного состава пленки и коэффициентов распыления.
Условия конденсации распыленных атомов. При ионном распылении (в отличие от термического вакуумного напыления) поток атомов вещества на подложку имеет следующие особенности:
1) энергия и направление удара атомов о поверхность подложки носят случайный характер по поверхности и во времени;
2) плотность потока атомов на подложку приблизительно на порядок ниже, что обусловливает более низкие скорости роста пленок (~0,5 нм/с);
3) средняя энергия атомов, подлетающих к подложке, на 1—2 порядка более высокая;
4) наряду с нейтральными атомами в потоке присутствуют ионы распыляемого вещества и электроны;
5) относительное содержание молекул остаточного газа в потоке и на подложке более высокое.
Эти особенности придают специфический характер процессу конденсации при ионном распылении. Важным при этом является наличие на поверхности подложки распределенного отрицательного заряда: направляясь к аноду, часть потока электронов остается на поверхности диэлектрической подложки (а затем и пленки), образуя статический заряд, потенциал которого может достигать 100 В (и более) относительно заземленного анода. Под влиянием отрицательного заряда возникают поток положительных ионов остаточного газа, загрязняющего пленку, поток ионов рабочего газа, способствующий десорбции газов, и поток ионов распыленного материала катода, который, двигаясь вдоль подложки к «ямам» потенциального рельефа, приводит к быстрому образованию крупных кристаллов. Рост таких кристаллов приводит к раннему образованию сплошной пленки, т.е. снижает значение критической толщины. Кроме того, зарядовый механизм конденсации объясняет, почему для пленок не существуют критическое значение температуры подложки и критическая плотность пучка.
Образованию крупных кристаллов способствуют также высокие энергии нейтральных атомов распыленного вещества и нагрев подложки из-за бомбардировки. Оба эти фактора обеспечивают высокую миграционную способность атомов.
При катодном распылении легче, чем при термическом вакуумном испарении, достигнуть равномерного распределения конденсата по толщине, так как плоский источник атомов — катод может по размерам быть больше расстояния до подложки (30—80 мм). Так, при диаметре катода 300—350 мм достигается равномерность конденсата по толщине ±2% на площади анода диаметром 150 мм. При планетарном движении подложек на вращающемся аноде равномерность в распределении конденсата улучшается до ±1%.
Ранее были отмечены некоторые побочные явления, способствующие десорбции остаточных газов из пленки. Тем не менее содержание газов в пленке обычно остается высоким. Например, при парциальном давлении остаточных газов 10-4 Па осажденная пленка тантала содержит до 10 ат. % кислорода. Причина повышенного содержания газа в осажденной пленке состоит в низкой плотности потока распыленных атомов на подложку, в то время как плотность потока остаточных газов на подложку имеет примерно тот же порядок, что и при термическом вакуумном напылении. Кроме того, эффективность работы диффузионного насоса (скорость откачки) при давлениях выше 0,1 Па заметно снижается, и несмотря на то, что напуск рабочего газа производят только после откачки до глубокого вакуума (10-4 Па), в присутствии рабочего газа остаточный газ удаляется менее эффективно, и его парциальное давление повышается.
Похожие работы
... условиям эксплуатации и конструктивным показателям, могут образовывать семейства серий интегральных схем. 2. ЛОГИЧЕСКИЕ ЭЛЕМЕНТЫ Логические и запоминающие элементы составляют основу устройств цифровой обработки информации – вычислительных машин, цифровых измерительных приборов и устройств автоматики. Логические элементы выполняют простейшие логические ...
... полярности источников питания на рисунке 3.4 и направления токов для p-n-p транзистора. В случае n-p-n транзистора полярности напряжения и направления токов изменяются на противоположные. Рисунок 3.4 Физические процессы в БТ. Этот режим работы (НАР) является основным и определяет назначение и название элементов транзистора. Эмиттерный переход осуществляет инжекцию носителей в узкую ...
... электротехнических и электронных устройств, в которых используется явление резонанса напряжения. Литература 1. Иванов И.И., Равдоник В.С. Электротехника. - М.: Высшая школа, 1984, с.53 - 58. 2. Касаткин А.С., Немцов М.В. Электротехника. - М.: Энергоатомиздат, 1983, с.73 - 77. Лабораторная работа №5 КОМПЕНСАЦИЯ РЕАКТИВНОЙ МОЩНОСТИ Цель работы. Ознакомление с методом повышения ...
... (на ряде свалок возникли пожары (которые не удавалось потушить годами), активно развивается технология их сжигания. Водород. Набирает силу новая отрасль промышленности - водородная энергетика и технология. Потребность экономики в водороде идет по нарастающей. Ведь это простейшее и легчайшее вещество может использоваться не только как топливо, но и как необходимый сырьевой элемент во многих ...



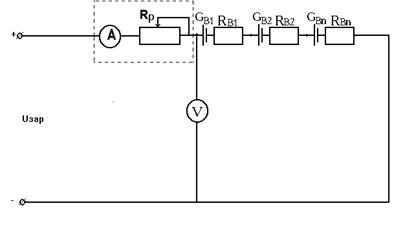
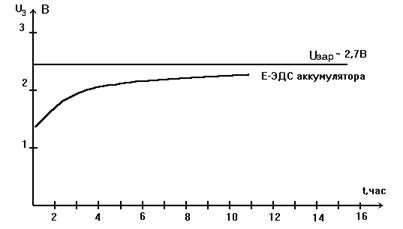


0 комментариев