Навигация
Физические процессы в дрейфовых транзисторах при больших плотностях тока
2.2 Физические процессы в дрейфовых транзисторах при больших плотностях тока
При больших плотностях тока концентрация электронов в базе п+-р-п-п+ транзистора увеличивается, а в силу квазиэлектронейтральности увеличивается и концентрация дырок. Это приводит к повышению уровня инжекции в определенных частях базы и ликвидации там встроенного электрического поля. Для транзистора, полученного методом двойной односторонней диффузии, уровень инжекции электронов наиболее сильно увеличивается в приэмиттерной части, а затем и в приколлекторной части базы (рис. 2.16, в). Повышение концентрации дырок в базе вблизи ОПЗ эмиттера приводит к возрастанию доли тока дырок, инжектированных из базы в эмиттер, и снижению коэффициента инжекции. При дальнейшем увеличении тока уровень инжекции становится высоким практически во всей области базы [n(x)>>|N(x)|] и процессы переноса электронов в базе дрейфового транзистора подобны процессам в базе бездрейфового транзистора. Указанные процессы определяют зависимость коэффициента передачи тока от тока коллектора (или эмиттера). Эффекты Кирка и квазинасыщения дают дополнительный вклад в спад коэффициента передачи тока транзистора при больших плотностях тока.
Рассмотрим физические процессы, происходящие в базе транзистора при произвольных уровнях инжекции. Граничное условие для носителей заряда в базе на границе ОПЗ эмиттера имеет вид[4]
![]() (2.2.1)
(2.2.1)
Подставив (2.2.1) в (2.1.4) и полагая х=х2Э, получим выражение для сквозного тока электронов в базе
![]()
 (2.2.2)
(2.2.2)
Интеграл от концентрации дырок р(х) в базе с помощью условия квазиэлектронейтральности (2.1.8) можно представить в виде
![]() (2.2.3)
(2.2.3)
Здесь Qpи Qn — заряды дырок и электронов в квазиэлектронейтральной базе, a QВ0 — заряд равновесных дырок в базе:
![]() (2.2.4)
(2.2.4)
![]() (2.2.5)
(2.2.5)
Известно,[4] что при низком уровне инжекции заряд электронов в базе Qn пропорционален сквозному току 1пх. Коэффициент пропорциональности представляет собой постоянную накопления заряда электронов в базе и определяется (2.1.23). При высоком уровне инжекции [п(х)>>|N(х)|] пропорциональность между Qn и Inx по-прежнему сохраняется, но коэффициент пропорциональности имеет другое значение, определяемое формулой [3]:
![]() (2.2.6)
(2.2.6)
В общем случае
![]() (2.2.7)
(2.2.7)
где т=т(η) при низком уровне инжекции и т=2 при высоком уровне инжекции электронов в базе.
Выражение (2.2.2) с учетом (2.2.4) , (2.2.5) и (2.2.7) можно представить в виде
 (2.2.8)
(2.2.8)
В (2.2.8) обозначено
![]() ; (2.2.9)
; (2.2.9)
![]() (2.2.10)
(2.2.10)
Ток /Эns определяет электронную составляющую тока насыщения эмиттерного р-п перехода при низком уровне инжекции. Ток ikf является характеристическим током, определяющим границу между низким и высоким уровнями инжекции электронов в базе.
Далее будем рассматривать нормальный активный режим. Для этого режима UK<<-φT, и поэтому
![]() (2.2.11)
(2.2.11)
Использовав (2.2.11), можно установить связь между напряжением Uэ и сквозным током Inx.
![]() (2.2.12)
(2.2.12)
Определим ток объемной рекомбинации электронов в базе, В соответствии с [4] этот ток
![]() (2.2.13)
(2.2.13)
Время жизни электронов зависит от концентрации легирующих примесей [4], а поэтому и от координаты. Тогда в соответствии с [4] запишем
 (2.2.14)
(2.2.14)
 (2.2.15)
(2.2.15)
где τпо(То), τро(Tо) определяются при Tо=300 К.
При высоком уровне инжекции можно считать, что концентрация электронов в базе уменьшается практически линейно от ее значения nрэ у эмиттера до нуля у коллектора:
![]() (2.2.16)
(2.2.16)
Кроме того, при высоком уровне инжекции
![]() (2.2.17)
(2.2.17)
С учетом этих предположений можно ввести эффективное (усредненное) время жизни электронов в базе в соответствии с выражением
 (2.2.18)
(2.2.18)
где интегрирование проводится в пределах квазиэлектронейтральной базы от x2Э до x1K.
С учетом (2.2.18) и (2.2.7) ток объемной рекомбинации электронов в базе определяется выражением
![]() (2.2.19)
(2.2.19)
Для расчета коэффициента передачи тока необходимо определить ток дырок, инжектированных из р-базы в п+-эмиттер. Дырки, проникающие в эмиттер дрейфового транзистора, перемещаются в нем не только за счет диффузии, но и под действием электрического поля, обусловленного неоднородным легированием эмиттера, а также эффектом сужения запрещенной зоны в сильнолегированном эмиттере. В состоянии термодинамического равновесия ток электронов эмиттера равен нулю. Положим в уравнении [4]
![]() (2.2.20)
(2.2.20)
где ∆φG=∆EG/q, ∆EG-сужение запрещенной зоны;
A- коэффициент асимметрии в сужении (А=0,5).
Jnx=0 и использовав соотношение Эйнштейна, выразим напряженность электрического поля:
![]() (2.2.21)
(2.2.21)
Подставив (2.2.21) в уравнение для плотности тока дырок [4],
![]() (2.2.22)
(2.2.22)
получим ![]() (2.2.23)
(2.2.23)
Дрейфовый ток дырок пропорционален эффективной напряженности электрического поля для дырок[4]:
![]() (2.2.24)
(2.2.24)
Первый член в этом выражении является «классической» составляющей напряженности электрического поля, обусловленного неоднородным легированием. Второй член отражает наличие добавочной силы, связанной с изменением валентных сил в кристалле, обусловленных сильным легированием (эффект СЗЗ). Для транзистора с распределением концентрации легирующих примесей, показанным на рис. 2.1.1, первая составляющая поля Ep1 при НУИ направлена по оси х и тормозит дырки, инжектированные в эмиттер. Вторая составляющая поля Ep2<0 и уменьшает тормозящее поле для дырок в эмиттере. Таким образом, влияние СЗЗ приводит к дополнительному накоплению заряда дырок в эмиттере, увеличению концентрации дырок дырочного тока эмиттера и к уменьшению коэффициента инжекции.
Распределение электрического поля и концентрация дырок в эмиттере.
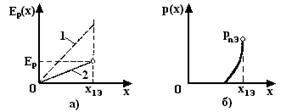
Рис.2.2.1
Примерное распределение Ер(х) в квазиэлектронейтральной области эмиттера показано на рис. 2.2.1,а. Без учета сужения запрещенной зоны Ep1 определяется кривой 1, а с учетом — кривой 2. Обычно при низком уровне инжекции тормозящее электрическое поле достаточно велико, и дырки, диффундирующие против поля, проникают в эмиттер на небольшое расстояние, на котором Ер мало изменяется. Для оценочного расчета р(х) будем полагать, что на этом расстоянии электрическое поле Ер, коэффициент диффузии дырок Dp и их время жизни τр постоянны и соответствуют значениям, рассчитанным при х=х1Э. Подставив (2.2.23) в уравнение непрерывности для дырок[4]
![]() (2.2.25)
(2.2.25)
получим для стационарного режима
 (2.2.26)
(2.2.26)
где![]() — диффузионная длина дырок.
— диффузионная длина дырок.
Приближенное решение этого дифференциального уравнения имеет вид
![]() (2.2.27)
(2.2.27)
где рпэ ==р(х1Э)) — концентрация дырок при х=х1э (рис. 2.2.1,6).
В этом случае характеристическая длина L*, на которой концентрация дырок спадает в е раз, называется диффузионной длиной против поля. Она определяется выражением
![]() (2.2.28)
(2.2.28)
где ηЭ=EpLp/φT![]() фактор поля; функция
фактор поля; функция
![]() , при ηЭ»1.
, при ηЭ»1.
Таким образом, при низком уровне инжекции дырочный ток эмиттера (при x=x1Э) определяется выражением
![]() (2.2.29)
(2.2.29)
Учитывая, что ![]() , окончательно можно записать
, окончательно можно записать
![]() (2.2.30)
(2.2.30)
 (2.2.31)
(2.2.31)
Полученные выражения позволяют определить коэффициент передачи тока базы для нормального активного режима. Ток базы транзистора
![]() (2.2.32)
(2.2.32)
где первые две составляющие тока базы определяются выражениями (2.2.19), (2.2.30), (2.2.31) , а третья (связана с рекомбинацией в ОПЗ) в соответствии с[4]
![]() (2.2.33)
(2.2.33)
Интегральный коэффициент передачи тока базы
![]() (2.2.34)
(2.2.34)
Подставив в (2.2.34) выражения (2.2.19), (2.2.30), (2.2.31), (2.2.33) и (2.2.11) и выполнив необходимые преобразования[4], получим
 (2.2.35)
(2.2.35)
где IRS=I2R)/IЭns—характеристический ток влияния рекомбинации носителей заряда в ОПЗ эмиттера.
Так как в данной постановке задачи IK≈IЭ=Inx, выражение (2.2.35) определяет зависимость β от тока коллектора. Первый член выражения (2.2.35) обусловлен рекомбинационными потерями электронов в объеме базы, второй член—дефектом инжекции эмиттера, третий — наличием рекомбинации носителей заряда в ОПЗ эмиттера. Зависимость β(Iк) для мощного транзистора показана на рис. 2.2.2.
Зависимость коэффициента передачи тока от тока коллектора.
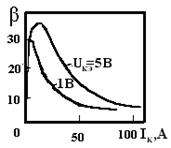
Рис. 2.2.2
Спад β в области малых токов обусловлен рекомбинацией носителей заряда в ОПЗ эмиттера от тока коллектора(третий член), а спад β в области больших токов—уменьшением коэффициента инжекции (второй член). Кроме явной зависимости β(Inx) необходимо иметь в виду, что постоянная накопления τF резко возрастает в области больших токов из-за влияния эффекта Кирка и квазинасыщения. Возрастание τF и уменьшение ik.f == QB0/ τF в области больших токов усиливают спад β.
Зависимость коэффициента передачи тока β от напряжения коллектор—эмиттер Uкэ обусловлена рядом эффектов, связанных с изменением границы ОПЗ коллекторного перехода x1к при изменении Uкэ. При малых плотностях тока основную роль играет расширение ОПЗ коллектора в область базы, за счет чего изменяется толщина квазиэлектронейтральной базы (эффект Эрли). В области повышенных плотностей тока и небольших напряжений Uкэ начинает сказываться эффект Кирка и эффект квазинасыщения. При больших обратных напряжениях UКЭ дополнительное возрастание β связано с явлением лавинного размножения носителей заряда в ОПЗ коллектора.
Похожие работы
... Затвор Сток Область, обеднённая носителями Канал зарядов Канал а б Рис. 2. Зависимость профиля проходного сечения полевого транзистора с p – n переходом от напряжения смещения между затвором и истоком (а) и истоком и стоком (б)Напряжения смещения перехода приводит к ...
... , к которой под действием поля движутся (дрейфуют) основные носители, - стоком, металлическая или полупроводниковая область, используемая для создания модуляции дрейфового тока, - затвором. Подложка является конструктивной основой МДП-транзистора. Рис.1. Конструкция МДП транзистора Области истока и стока одного типа электропроводности формируют на некотором расстоянии /к друг от друга ...
... полярности источников питания на рисунке 3.4 и направления токов для p-n-p транзистора. В случае n-p-n транзистора полярности напряжения и направления токов изменяются на противоположные. Рисунок 3.4 Физические процессы в БТ. Этот режим работы (НАР) является основным и определяет назначение и название элементов транзистора. Эмиттерный переход осуществляет инжекцию носителей в узкую ...
... ). Перспективы развития микроэлектроники Функциональная микроэлектроника. Оптоэлектроника, акустоэлектроника, магнетоэлектроника, биоэлектроника и др. Содержание лекций 1 Цели и задачи курса “Электронные, квантовые приборы и микроэлектроника”. Физика полупроводников. p-n- переходы. Полупроводниковые диоды. Разновидности и характеристики. 2 Транзисторы. Принцип действия, разновидности и ...





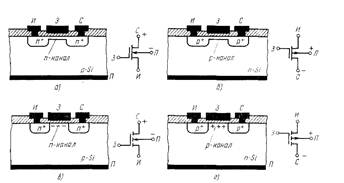
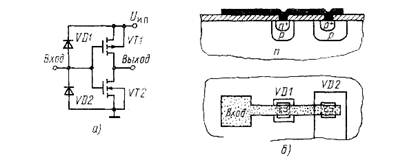
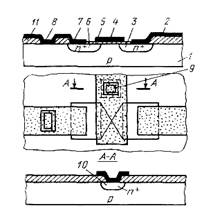




0 комментариев