Навигация
Термическое окисление кремния в парах воды
3. Термическое окисление кремния в парах воды
Для получения защитных диэлектрических пленок на кремнии используют термическое окисление в парах воды высокой чистоты (порядка 10—20 МОм-см). Высокотемпературную реакцию кремния с водяным паром используют в том случае, когда количество пара не ограничивает скорость реакции. Для поддержания необходимого парциального давления водяных паров у поверхности кремниевых пластин воду подогревают.
Структурное формирование пленки оксида происходит за счет диффузионного переноса воды через слой оксида к поверхности кремния. На структурное формирование пленки оксида оказывает влияние водород, образующийся в процессе реакции окисления и диффундирующий вглубь пластины. Так как коэффициент диффузии водорода (2·10-6 см2/с при 1050°С) значительно больше, чем коэффициент диффузии воды (9· 10-10 см2/с при 1050°С), то образование гидроксильных групп у границы раздела кремний — оксид объясняется наличием не только молекул воды, но и водорода.
При температурах процесса окисления образование слоя оксида идет согласно параболическому закону и описывается выражением X2=Bt.
Чем ниже температура процесса окисления, тем ближе к линейному закон образования слоя оксида. Линейный характер роста оксидной пленки наблюдается в парах воды высокого давления (2,5· 105—4,0*107 Па) при температуре 500—800°С.

Рис. 3. Зависимость толщины пленки SiO2, выращенной в атмосфере водяного пара, от времени для температур, °С
Рост пленки оксида по линейному закону имеет место в том случае, когда скорость окисления ограничена скоростью химической реакции на границе кремний — Оксид. На участке линейного роста скорость реакции зависит от количества свободных связей атомов кремния, которые могут реагировать с молекулами воды на границе раздела кремний— оксид.
На рис. 3 приведена зависимость изменения толщины пленки оксида в атмосфере водяного пара от времени проведения процесса для различных температур.
Большое влияние на скорость роста оксидной пленки оказывают ориентация подложки, тип электропроводности и концентрация примеси исходной подложки.
Высокая концентрация примеси в подложке влияет либо на скорость реакции окисления на границе раздела кремний — оксид, либо на коэффициенты диффузии окислителей. Так, наличие в исходной подложке фосфора в первую очередь оказывает влияние на скорость реакции окисления. Поверхность кристалла с высокой концентрацией фосфора окисляется значительно быстрее, чем слаболегированная поверхность. Это справедливо для низкотемпературного диапазона (600—10000C).
При термическом окислении растущий оксид оттесняет фосфор в глубь кристалла кремния и, таким образом, в оксидном слое концентрация фосфора весьма мала. Для бора картина обратная: растущий оксид включает в себя большое количество бора, что приводит к ускорению диффузии окисляющих веществ. Поэтому кремний с высокой концентрацией бора окисляется быстрее как в высокотемпературной, так и в низкотемпературной области.
Скорость окисления в парах воды зависит от ориентации исходной пластины кремния только в низкотемпературной области, где рост оксидной пленки не подчиняется параболическому закону.
4. Термическое окисление кремния в сухом кислороде
Отличием метода окисления в сухом кислороде от окисления в парах воды является то, что в первом случае веществом, диффундирующим сквозь растущую пленку оксида, является не вода, а ионы кислорода. Необходимо отметить, что коэффициент диффузии кислорода в пленке оксида (2,8· 10-14 см2/с при 1050°С) значительно меньше, чем у водорода и воды при тех же условиях. Поэтому скорость роста оксидной пленки в сухом кислороде меньше, чем в парах воды.
Так как в процессе образования оксидных пленок отсутствуют водород и - пары воды, то в структуре выращенного оксида нет гидроксильных групп (ОН). Высокая энергия активации процесса окисления кремния в сухом кислороде и отсутствие гидроксильных групп приводят к образованию прочных связей кислорода с кремнием в структуре получаемого оксидного слоя кремния.
Как и при окислении в парах воды, кинетика окисления в области низких температур определяется в большей мере скоростью реакции на границе раздела кремний — оксид, чем диффузией кислорода. Отклонение закона роста пленки оксида в сторону линейности обычно имеет место при температурах ниже 10000C
На рис. 4 приведены графики зависимости изменения толщины оксида в атмосфере сухого кислорода от времени проведения процесса окисления для различных температур.
Процесс окисления кремния в сухом кислороде проводят на установке, показанной на рис. 5. В качестве осушителя используют вымораживающую ловушку, химический поглотитель или комбинированное устройство, позволяющее снизить содержание влаги в кислороде до точки росы. Фильтр служит для удаления частиц пыли и механических загрязнений.

Рис. 4. Зависимость толщины пленки SiO2, выращенной в атмосфере сухого кислорода, от времени для температур, °С:
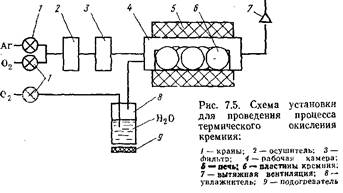
Похожие работы
... Процесс нанесения этих соединительных полосок называют металлизацией, а сам «рисунок» межсоединений — металлической разводкой. В данной курсовой работе рассмотрена технология изготовления плат полупроводниковых интегральных микросхем. Полупроводниковая интегральная микросхема – это микросхема, элементы которой выполнены в приповерхностном слое полупроводниковой подложки. Эти ИС составляют основу ...
... 8729;°C) Коэффициент теплового расширения, 10-6/°C Si 7,0 850 1,9 1,57 2,33 Сталь (высшей прочности) 4,2 1500 2,1 0,97 12 Нержавеющая сталь 2,1 660 2,0 0,329 17.3 Al 0,17 130 0,7 2,36 25 Микроэлектронная технология изготовления кремниевых приборов основана на применении тонких слоев, создаваемых ионной имплантацией или термической диффузией атомов легирующей примеси, что ...
... - внутренняя и наружная шестерни, 4 - сепараторы , 5 - пластины По характеру воздействия абразива на полупроводниковые пластины различают шлифование свободным и связанным абразивом. В зависимости от зернистости используемого абразива, режимов обработки и качества полученной поверхности различают предварительное (черновое) и окончательное (чистовое) шлифование. Шлифование свободным абразивом ...
... от структуры силикатных стёкол, и способно выдерживать умеренные концентрации катионов (например, натрий до 0,1%), не увеличивая электропроводимость. Боратное стекло отвечает требованиям герметизации полупроводниковых приборов: свободно от щелочных металлов, уплотняется (спаивается) при температуре до 800С, относительно инертно и водонепроницаемо, имеет регулируемые коэффициенты температурного ...



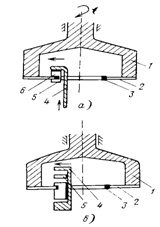


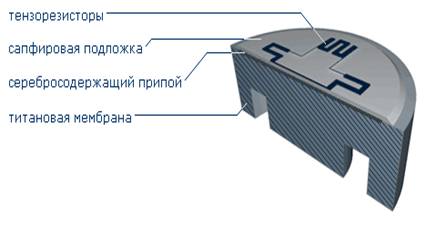
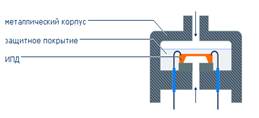
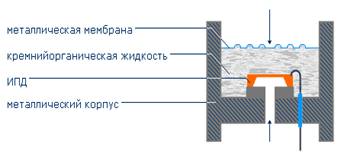
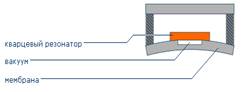


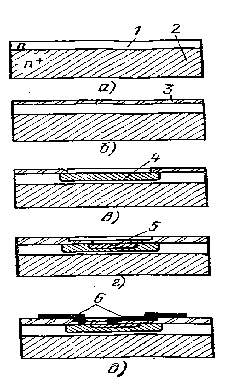
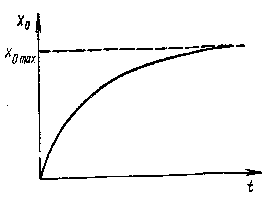




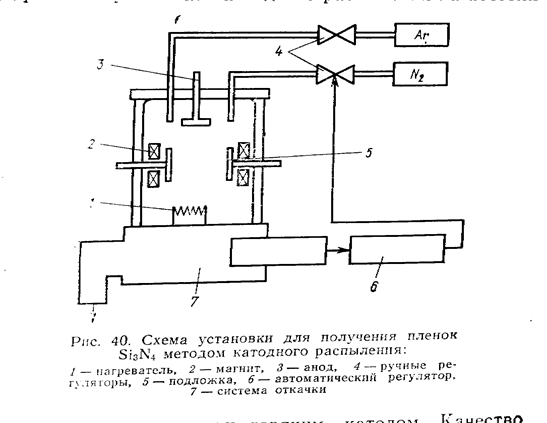

0 комментариев