Навигация
Термическое окисление кремния во влажном кислороде
5. Термическое окисление кремния во влажном кислороде
Процесс окисления кремния во влажном кислороде представляет собой комбинацию двух ранее рассмотренных процессов окисления: в парах воды и в сухом кислороде. Сухой и очищенный от примесей кислород пропускают через водяную баню, где он насыщается горячими водяными парами, и затем подают его в рабочую камеру. Содержание влаги в потоке кислорода определяется температурой водяной бани и скоростью потока кислорода.
Так как скорость образования оксидного слоя в парах воды значительно выше, чем в сухом кислороде, то скорость процесса окисления кремния зависит от содержания влаги в потоке кислорода. Процесс окисления кремния во влажном кислороде проводят на установке, показанной на рис. 5.
Основным достоинством данного метода является то, что он позволяет легко изменять концентрацию паров воды в потоке кислорода и варьировать скорость окисления от значения, соответствующего 100%-ному содержанию кислорода, до значения, соответствующего 100%-ному содержанию паров воды.
В данном методе в качестве окислителя служит смесь кислорода и паров воды, причем соотношение этих компонентов можно изменять в широких пределах.
Если необходимо иметь низкие скорости процесса окисления, то вместо кислорода можно использовать поток аргона или азота «(температура водяной бани должна быть комнатной).
Энергия активации реакции окисления во влажном кислороде уменьшается с увеличением концентрации паров воды. Энергия активации лежит в диапазоне от 1,3 эВ, что соответствует процессу окисления в сухом кислороде, до 0,8 эВ, что соответствует процессу окисления в атмосфере водяного пара.
На рис. 6 приведены графики зависимости толщины оксидной пленки, выращенной в атмосфере влажного кислорода при температуре 1200° С, от времени проведения процесса окисления для различных температур водяного пара.
В производстве полупроводниковых приборов и интегральных микросхем широкое применение нашли двух- и трехступенчатый способы термического окисления кремния. Эти способы основаны на последовательном использовании в качестве окислителей сухого кислорода, влажного кислорода или водяного пара и снова сухого кислорода. Такой технологический процесс образования защитной диэлектрической пленки оксида кремния вызван тем, что оксид, выращенный в атмосфере сухого кислорода, имеет более совершенную структуру пленки, но малую скорость ее роста, а выращенный в атмосфере влажного кислорода и паров воды имеет менее совершенную структуру, но более высокую скорость роста.
Поэтому первая стадия в сухом кислороде многоступенчатого способа окисления направлена на получение тонкой пленки оксида кремния с совершенной структурой, вторая стадия (во влажном кислороде) применяется для убыстрения процесса окисления и наращивания достаточной по толщине пленки оксида, а третья стадия (в сухом кислороде) — вновь для получения совершенной структуры оксида на поверхности кремния.
Предельная толщина термически выращенной пленки не превышает 1 —1,5 мкм. Для практических целей планарной технологии толщина оксидных защитных пленок должна составлять 0,2— 0,8 мкм. Это продиктовано тем, что при использовании пленок толщиной более 0,8 мкм клин травления при проведении процесса фотолитографии возрастает и ограничивает возможность получения микроизображения требуемого размера. При использовании пленок толщиной менее 0,2 мкм увеличивается вероятность появления в ней сквозных отверстий и пор, которые при диффузии приводят к локальному проникновению диффузанта в подложку.
6. Пиролитическое осаждение оксидных пленок кремния
Наиболее простым и технологичным способом образования оксидов кремния без участия материалов подложки является пиролитическое разложение различных кремнийорганических соединений. Следовательно, этот способ дает возможность осаждать оксидные пленки кремния на подложку практически из любого материала. Другим важным преимуществом данного способа является то, что он позволяет свести к минимуму перераспределение примесей, которое имело место в исходной подложке, т. е. сохранить геометрические размеры и электрические параметры активных и пассивных областей подложки. Третьим достоинством способа является более низкая температура процесса.

Рис. 6. Зависимость толщины пленки SiO2, выращенной в атмосфере влажного кислорода при температуре 1200°С, от времени для различных температур водяного пара, °С

Рассмотрим два варианта данного способа, которые нашли широкое применение при изготовлении полупроводниковых приборов я интегральных микросхем.
Термическое разложение тетраэтоксилана Si(OCHs) 4. Этот процесс может проводиться непосредственно над поверхностью подложки либо в отдельной камере, из которой продукты реакции транспортируются к подложке. Реакция разложения тетраэтоксилана происходит при температуре 700—750°С. В результате реакции выделяются диоксид кремния, оксид кремния, оксид углерода и органические радикалы в газообразной форме. Источником кислорода в этой реакции служит сам тетраэтоксилан, а не внешний источник. На рис. 7 приведены графики зависимости толщины пленки от времени проведения процесса.
Если реакция разложения тетраэтоксилана проводится в одной камере с подложкой, то температура подложки соответствует температуре пиролиза. Если реакция разложения проходит в одной камере, а подложки находятся в другой камере, то температура подложек может быть значительно снижена по сравнению с температурой пиролиза.
Окисление силана кислородом. Преимущество этой реакции перед предыдущей заключается в том, что в этом случае не происходит образования газообразных органических радикалов и углерода, а сама реакция идет при более низкой температуре.
Окисление моносилана кислородом является перспективным методом в полупроводниковой технологии, так как он дает возможность осаждать оксидные пленки кремния на интерметаллические соединения типа AhiBv и A11Bvi без нарушения их стехиометрического состава. Для протекания реакции образования диоксида кремния внешний нагрев не требуется, однако для получения оксидных пленок кремния более высокого качества процесс проводят при температуре 150—300°С:
![]()
Исходными веществами для проведения этого процесса являются газовые смеси, которые включают в себя высокочистый моносилан SiH4, аргон или азот (газы-носители) и кислород. Контролируемое окисление сильно разбавленного инертным газом силана (3—10%) й позволяет реализовать осаждение диоксида кремния в широком диапазоне температур со скоростью 10—50 нм/мин.
Температурный интервал осаждения оксидных пленок кремния определяется концентрациями моносилана и окислителя. При изменении концентрации моносилана от 0,8 до 0,015 об. % для постоянного отношения силан: окислитель= 1: 3 температура процесса осаждения должна быть увеличена с 140 до 450° С.
Особое внимание следует обращать на минимальную температуру процесса осаждения. Нижний температурный предел лимитируется двумя факторами: монотонным увеличением пористости пленки диоксида кремния и гомогенным окислением моносилана в газовой фазе. Монотонное увеличение пористости пленки связано с тем, что по мере снижения температуры процесса уменьшается энергия поверхностной миграции адсорбированных подложкой молекул. Кристаллизация осаждаемых частиц при этом происходит в положениях, все более далеких от минимума свободной энергии системы. Это вызывает образование рыхлых, пористых пленок с низкой электрической прочностью и невысокой адгезией к подложке. При температурах проведения процесса осаждения ниже 150° С происходит отложение частиц диоксида кремния в виде мелкодисперсного белого порошка.
Гомогенное окисление моносилана в газовой фазе связано с тем, что чем ниже температура осаждения оксидной пленки, тем большие концентрации моносилана необходимы для реализации механизма окисления и, следовательно, все большая часть моносилана окисляется в газовой фазе, засоряя реакционную камеру и ухудшая качество образующейся пленки.
В качестве окислителя кроме кислорода могут быть использованы кислородсодержащие соединения, такие, как N2O, CO2, H2O. Использование в качестве окислителей закиси азота и углекислого газа позволяет практически исключить гомогенное окисление, однако при этом невозможно реализовать осаждение пленок диоксида кремния в диапазоне температур 200—350° С.
Контролируемое окисление моносилана (кислородом), достаточно сильно разбавленного инертными газами, позволяет получать пленки SiO2 в широком диапазоне температур (200—500°С), при этом скорости осаждения пленок достигают значений порядка 50— 100 нм/мин.
Следует отметить, что пленки SiO2, полученные данным методом, равномерны по толщине по всей поверхности пластины, обладают достаточной сплошностью, стабильностью химического состава и хорошей маскирующей способностью при проведении процессов диффузии. Отличительным признаком пленок SiO2, полученных этим методом, является более высокая скорость их травления.
Анодное окисление кремния
Анодное окисление кремния является одной из основных электродных реакций, происходящих на поверхности исходной пластины при воздействии на нее электролита и электрического тока. Метод анодного окисления включает две модификации: окисление поверхности кремния в жидком электролите и окисление в газовой плазме. В первом случае процесс называют электролитическим анодированием, во втором — газовым анодированием.
Электролитическое анодирование. При обычных условиях поверхность кремниевых пластин покрыта тонкой пленкой оксида толщиной около ЗОА. Эта оксидная пленка разделяет вещества, которые участвуют в реакции анодного окисления. Поэтому дальнейший рост оксидной пленки возможен только при переносе за счет диффузии или миграции ионов реагирующих веществ через эту пленку. Скорость роста пленок SiO2 на кремнии в жидком электролите, не растворяющем эти пленки, зависит от электростатического поля в слое оксида, стимулирующего миграцию ионов. Считают, что подвижным компонентом в рассматриваемом случае является ион кремния. Поэтому процесс выращивания анодных оксидных пленок может быть описан как процесс переноса ионов кремния через границу раздела оксид — кремний и через оксид к границе раздела оксид — электролит, где происходит реакция окисления.
Присутствие ионов в электролите у границы с оксидом заметно влияет на скорость окисления, а также на предельную толщину оксидной пленки. Толщина пленки при анодном окислении определяется значениями напряжения пробоя и ионного тока. Регулирование значения общего тока в процессе анодного окисления может осуществляться при постоянном токе, при постоянном напряжении и при комбинации этих величин.
Рассмотрим окисление при постоянном токе. Для поддержания постоянного ионного тока через оксид необходимо, чтобы с увеличением толщины оксидной пленки возрастало падение напряжения в этой пленке. Поэтому анодирование при постоянном токе можно характеризовать как скорость роста напряжения в оксиде. Скорость изменения напряжения приблизительно пропорциональна току. Следовательно, чем выше плотность ионного тока, тем быстрее повышается напряжение и быстрее растет оксид. При этом типичное значение коэффициента полезного выхода ионного тока составляет около 1% от выхода электролитических реакций. Анодное окисление при постоянном токе может продолжаться до тех пор, пока напряжение не достигнет определенного значения, зависящего от типа электролита и конструкции установки, после чего происходит пробой оксидной пленки.
В случае окисления при постоянном напряжении между анодом и катодом первоначальный ток, возникающий вследствие ионной проводимости оксида, определяется сопротивлением электролита, толщиной первоначального слоя оксида на кремниевой пластине и поляризацией, связанной с образованием «двойного слоя» в электролите. По мере роста оксида электрическое поле в нем уменьшается, что приводит к уменьшению тока, проходящего через оксид. В результате рост оксида замедляется.
Большую роль в получении воспроизводимых результатов анодного окисления играет выбор электролита и процент содержания в нем влаги. Могут быть использованы самые различные электролиты на основе азотной, борной или фосфорной кислот с добавками нитрата натрия, нитрата калия, бихромата аммония и др.
Газовое анодирование кремния аналогично электролитическому с той лишь разницей, что вместо электролита используется газ. Этот метод применяется при выращивании толстых оксидных пленок. Кислородная плазма, возбуждаемая полем высокой частоты, служит источником отрицательно заряженных кислородных ионов. Ионы кислорода из плазмы взаимодействуют с поверхностью кремниевой пластины. Рост оксида зависит от режима проведения анодного окисления: от давления внутри рабочей камеры, температуры и плотности плазмы.
Похожие работы
... Процесс нанесения этих соединительных полосок называют металлизацией, а сам «рисунок» межсоединений — металлической разводкой. В данной курсовой работе рассмотрена технология изготовления плат полупроводниковых интегральных микросхем. Полупроводниковая интегральная микросхема – это микросхема, элементы которой выполнены в приповерхностном слое полупроводниковой подложки. Эти ИС составляют основу ...
... 8729;°C) Коэффициент теплового расширения, 10-6/°C Si 7,0 850 1,9 1,57 2,33 Сталь (высшей прочности) 4,2 1500 2,1 0,97 12 Нержавеющая сталь 2,1 660 2,0 0,329 17.3 Al 0,17 130 0,7 2,36 25 Микроэлектронная технология изготовления кремниевых приборов основана на применении тонких слоев, создаваемых ионной имплантацией или термической диффузией атомов легирующей примеси, что ...
... - внутренняя и наружная шестерни, 4 - сепараторы , 5 - пластины По характеру воздействия абразива на полупроводниковые пластины различают шлифование свободным и связанным абразивом. В зависимости от зернистости используемого абразива, режимов обработки и качества полученной поверхности различают предварительное (черновое) и окончательное (чистовое) шлифование. Шлифование свободным абразивом ...
... от структуры силикатных стёкол, и способно выдерживать умеренные концентрации катионов (например, натрий до 0,1%), не увеличивая электропроводимость. Боратное стекло отвечает требованиям герметизации полупроводниковых приборов: свободно от щелочных металлов, уплотняется (спаивается) при температуре до 800С, относительно инертно и водонепроницаемо, имеет регулируемые коэффициенты температурного ...



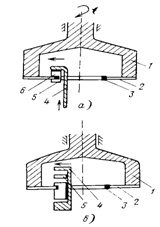


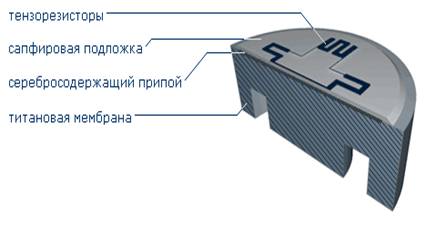
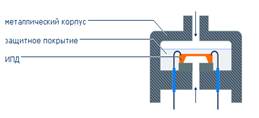
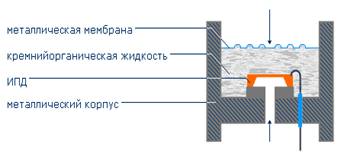
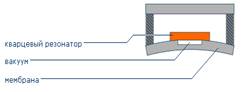


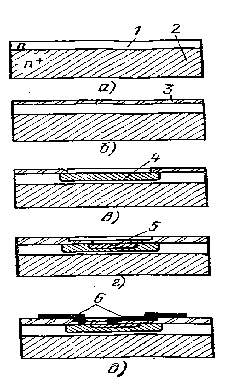
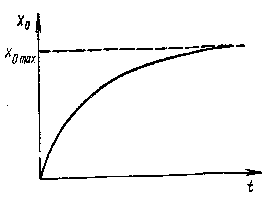




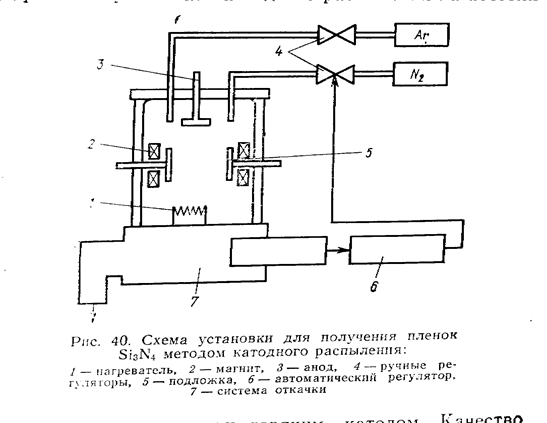

0 комментариев