Навигация
Осаждение пленок оксида кремния термическим испарением
8. Осаждение пленок оксида кремния термическим испарением
Для нанесения защитных пленок оксида кремния используют два метода, основанные на испарении монооксида кремния. В первом методе используется технический порошкообразный монооксид кремния. Второй метод заключается в том, что кремниевый электрод нагревается в атмосфере кислорода. При этом его поверхность покрывается монооксидом, который легко испаряется, так как обладает более высоким, чем у кремния, давлением паров.
Оксиды, получаемые путем напыления на полупроводниковую подложку, представляют собой комплексы вида Si—SiO—SiO2-. При использовании в качестве источника испарения порошка монооксида кремния одним из наиболее важных моментов для получения однородной защитной оксидной пленки является конструкция лодочки для порошка монооксида кремния. Скорость испарения зависит от геометрии лодочки, температуры, давления, а также от однородности порошка монооксида. При использовании какого-либо определенного источника скорость испарения регулируют изменением электрической мощности, служащей для нагрева лодочки. Кремниевые пластины при этом методе осаждения защитной пленки нагревают до 300° С и выше, чтобы получить хорошую адгезию защитной пленки к исходной пластине. Если осаждение производится с малой скоростью, но при высоком парциальном давлении кислорода, то пленка обладает такими же характеристиками, как и пленка SiO2. При больших скоростях осаждения или при более низком парциальном давлении кислорода оптические характеристики осажденной пленки сходны с характеристиками, присущим» пленкам SiO.
Защитные пленки, обладающие свойствами пленок SiOa, получают обычно при температуре источника 1300—HOO0C и суммарном давлении менее 6,5· IO-4 Па. >
Для получения оксидных пленок методом напыления в вакууме в качестве источника можно использовать кремний. При этом определяющую роль играет реакция у поверхности кремния. Температура и парциальное давление кислорода у этой поверхности определяют скорость адсорбции кислорода на поверхности кремния и испарения S1O2. Кремний нагревается до температуры 700— IOOO0C Парциальное давление кислорода должно быть таким, чтобы на поверхности кремниевого источника обеспечивалась реакция Si-f-O—*-SiO. Указанным методом на исходной полупроводниковой пластине можно получить оксидную пленку толщиной 0,1 мкм при температуре 900°С и давлении 1,3· IO-4 Па в течение 30 мин. При подогреве подложки, на которой располагаются пластины, улучшаются адсорбция паров оксида и адгезия их к полупроводниковым пластинам. Во избежание испарения осажденной пленки оксида температура пластин должна быть на 100—200° С ниже температуры источника.
9. Реактивное катодное распыление оксида кремния
Метод реактивно-катодного распыления оксида кремния основан на использовании электрического разряда между электродами при низком давлении окисляющего газа. Под действием бомбардировки ионизированными молекулами газа материал катода испаряется в виде свободных атомов или в виде соединений, образующихся при реакции катода с остаточными молекулами газа. Перенос распыленных частиц происходит либо за счет их кинетической энергии, либо за счет диффузии, если столкновения с остаточными молекулами газа заметно снижают их кинетическую энергию.
Методом реактивно-катодного распыления можно получать пленки оксида кремния, подвергая распылению в присутствии кислорода кремниевую мишень. Обычно этот процесс проходит при давлении 0,4 Па и напряжении 1500—2000 В. Скорость роста: пленки оксида кремния увеличивается при введении в кислородную атмосферу небольших количеств аргона.
Разновидностью реактивно-катодного распыления является метод, при котором плазма получается с помощью высокочастотного разряда. По данному методу защитные оксидные пленки получают при давлении 26,5—133 Па и напряжении 3—5 кВ.
Хорошая контролируемость процесса реактивно-катодного распыления позволяет автоматизировать процесс осаждения защитных пленок оксида кремния на подложки из полупроводникового материала.
10. Химическое осаждение пленок нитрида кремния
Наряду с защитными диэлектрическими пленками диоксида кремния в производстве полупроводниковых приборов и интегральных микросхем все более широкое применение находят пленки нитрида кремния.
Пленки нитрида кремния обладают меньшей проницаемостью для диффузантов, используемых в обычной планарной технологии, чем пленки диоксида кремния. Поэтому пленки нитрида кремния получают более тонкими. Это является важным фактором для фотолитографии, способствующим увеличению ее разрешающей способности.
Пленки нитрида кремния можно выращивать во много раз быстрее, чем пленки диоксида кремния, и при более низких температурах.
Рассмотрим несколько способов химического осаждения пленок нитрида кремния.
Реакция взаимодействия кремния с азотом. Для осуществления химической реакции нитрирования необходима температура J100— 1300°С:
3Si + 2N2 - Si3N4
Обычно этим способом пользуются для получения нитрида кремния как тугоплавкого материала. В данной реакции чистый азот может быть заменен аммиаком, который диссоциирует при высокой температуре и взаимодействует с кремнием легче, чем молекулярный азот.
Пленки нитрида кремния могут быть получены методом открытой трубы. В рабочей камере располагают пластины кремния и пропускают через нее поток азота. При температуре 1200°С и скорости потока азота 300 см3/мин на поверхности пластин кремния образуется пленка нитрида кремния.
Реакция взаимодействия силана с аммиаком. Для протекания химической реакции азотирования силана аммиаком необходима температура 700—11000 C Таким образом, по сравнению с предыдущей реакцией рабочие температуры процесса осаждения пленок нитрида кремния значительно ниже. В рабочую камеру с кремниевыми пластинами в потоке водорода со скоростью (Зч-5) подаются силан и аммиак в соотношении 1:20. Избыток водорода препятствует преждевременному разложению силана. В рабочей камере при температуре выше 500°С происходит разложение силана и взаимодействие его с аммиаком:
3SiH4 + 4NH3 — Si3N4 + 12Н2
Образовавшийся в результате реакции нитрид кремния осаждается на поверхности кремниевых пластин.
Скорость роста пленки нитрида кремния зависит от концентрации силана в рабочей камере и температуры проведения процесса (рис. 8). Из графика видно, что при температуре 1250°С скорость осаждения замедляется, а при температуре выше 1250°С
значительно уменьшается. Это объясняется недостатком силана в рабочей камере вследствие его интенсивного разложения при повышенных температурах.
Обычно пленки нитрида кремния осаждают на подложки при температуре 800—900°С с использованием рабочей смеси, состоящей из водорода или аргона, используемых в качестве газов-носителей и реагентов: силана (до 1%) и аммиака (до 3%). Расход рабочей смеси устанавливают равным 1000 см3/мин. Время процесса выбирают из условия требуемой толщины пленки. В качестве газа-носителя наряду с водородом и аргоном могут быть использованы азот или оксид азота.

Рис. 8. Зависимость скорости осаждения пленок Si3N4:
Реакция взаимодействия тетрахлорида кремния с аммиаком. Образование пленки нитрида кремния при взаимодействии тетрахлорида кремния с аммиаком протекает в несколько стадий. На начальной стадии образуется диимид кремния:
![]()
При комнатной температуре эта реакция дальше не идет. Происходит полимеризация диимида кремния.
Если температуру повысить до 400°С, то пойдет реакция
![]()
Если температуру повысить до 650°С, реакция идет дальше:
![]()
Завершающая стадия образования нитрида кремния проходит при температуре 1100—1250°С:
![]()
В результате образуются кристаллиты нитрида кремния б-модификации. Если завершающую стадию реакции проводить при температуре 4000C, то образуется полностью аморфная пленка нитрида кремния на поверхности подложки.
Следует отметить, что с увеличением толщины пленки нитрида кремния (свыше 1 мкм) в них возникают трещины. Наличие трещин — результат высокого значения модуля упругости нитрида кремния, различия в коэффициентах термического расширения кремния и нитрида кремния, а также следствие неоднородности структуры подложки и нитридной пленки.
Процесс осаждения пленок нитрида кремния проводят в кварцевой трубе, в которую подают смесь тетрахлорида с аммиаком. В качестве газа-носителя используют водород, аргон или азот. Скорость подачи смеси газа-носителя с реагентами выбирают равной (5н-4-10) 103 см3/мин.
Скорость осаждения пленки нитрида кремния зависит от температуры проведения процесса и соотношения между тетрахлоридом и аммиаком.
На рис. 9 приведена зависимость скорости осаждения пленки нитрида кремния от температуры для двух соотношений между тетрахлоридом и аммиаком.
Кроме тетрахлорида кремния для осаждения пленок нитрида кремния можно использовать галогенированные силаны типа "Hi-nSiXn, где X — галоген; п=1, 2, 3, 4. Реакция образования пленки нитрида кремния имеет вид
![]()
В качестве газов-носителей используют, как и в предыдущем случае, водород, аргон или азот. Температура проведения процесса осаждения для этих реагентов может быть снижена до 750— Э80°С. Скорость роста пленок нитрида кремния для этого процесса в большой степени зависит от технологических режимов.
Реакция взаимодействия силана с гидразином. Для осаждения яленок нитрида кремния вместо аммиака используют гидразин N2H4. Реакция в этом случае идет по следующей схеме:
SiH4 + N2H4 Si (NH)2 + ЗНг
2Si (NH)2 — (SiN)2 NH + NH3
3 (SiN)2 NH — 2Si3N4 + NH3
При использовании реакции взаимодействия аммиака с силаном температура осаждения пленок нитрида кремния не может быть ниже 750°С. Применение гидразина вместо аммиака позволяет снизить рабочую температуру процесса до 550°С,.так как гидразин разлагается при более низких температурах. Осаждение пленок проводят в кварцевой трубе, через которую пропускают газ-носитель и смесь силана с гидразином.

Рис. 9. Зависимость скорости осаждения пленок Si3N4 от температуры
На рис. 10 показана зависимость скорости осаждения пленок нитрида кремния от температуры для двух различных соотношений концентраций силана и гидразина.
Реакция взаимодействия тетрабромида кремния с азотом. Реакция осаждения нитрида кремния идет при температуре 950°С и имеет вид

Рис. 10. Зависимость скорости осаждения пленок S13N4 от температуры
На рис. 11 показана схема установки для проведения процесса нанесения пленок нитрида кремния на подложки с использованием рассмотренных реакций:
SiH4-T-NH3; SiCl4 + NHs; SiH4 + + N2H4; SiBr4 + N2.
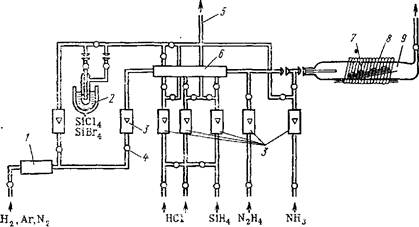
Рис. 11. Схема установки для осаждения пленок SіNi:
1 — блок очистки водорода; 2 — источник SiCI4 или SiBr4; 3 — ротаметры; 4 — краны: 5 — выпуск избыточных газов; S — смесительная камера; 7 — пластины; 4 — нагреватель: 9 — рабочая камера
Похожие работы
... Процесс нанесения этих соединительных полосок называют металлизацией, а сам «рисунок» межсоединений — металлической разводкой. В данной курсовой работе рассмотрена технология изготовления плат полупроводниковых интегральных микросхем. Полупроводниковая интегральная микросхема – это микросхема, элементы которой выполнены в приповерхностном слое полупроводниковой подложки. Эти ИС составляют основу ...
... 8729;°C) Коэффициент теплового расширения, 10-6/°C Si 7,0 850 1,9 1,57 2,33 Сталь (высшей прочности) 4,2 1500 2,1 0,97 12 Нержавеющая сталь 2,1 660 2,0 0,329 17.3 Al 0,17 130 0,7 2,36 25 Микроэлектронная технология изготовления кремниевых приборов основана на применении тонких слоев, создаваемых ионной имплантацией или термической диффузией атомов легирующей примеси, что ...
... - внутренняя и наружная шестерни, 4 - сепараторы , 5 - пластины По характеру воздействия абразива на полупроводниковые пластины различают шлифование свободным и связанным абразивом. В зависимости от зернистости используемого абразива, режимов обработки и качества полученной поверхности различают предварительное (черновое) и окончательное (чистовое) шлифование. Шлифование свободным абразивом ...
... от структуры силикатных стёкол, и способно выдерживать умеренные концентрации катионов (например, натрий до 0,1%), не увеличивая электропроводимость. Боратное стекло отвечает требованиям герметизации полупроводниковых приборов: свободно от щелочных металлов, уплотняется (спаивается) при температуре до 800С, относительно инертно и водонепроницаемо, имеет регулируемые коэффициенты температурного ...



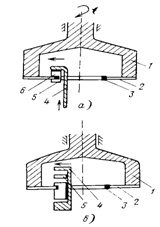


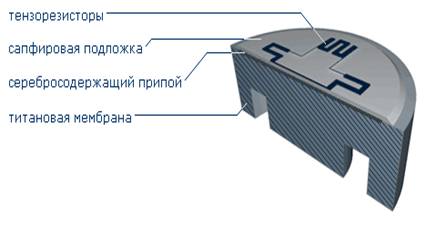
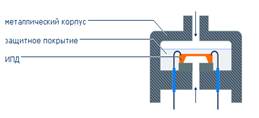
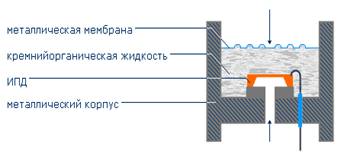
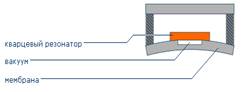


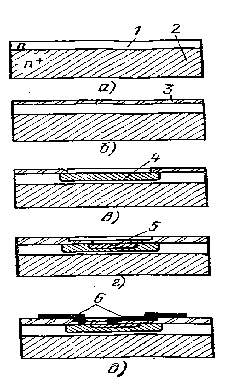
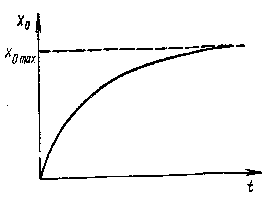




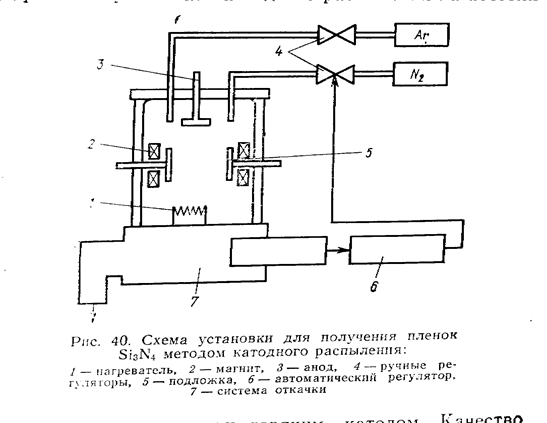

0 комментариев