Навигация
Теоретическая вольтамперная характеристика p-n перехода
1.3.4 Теоретическая вольтамперная характеристика p-n перехода
Вольтамперная характеристика представляет собой график зависимости тока во внешней цепи p-n перехода от значения и полярности напряжения, прикладываемого к нему. Эта зависимость может быть получена экспериментально или рассчитана на основании уравнения вольтамперной характеристики.
При включении p-n перехода в прямом направлении в результате инжекции возникает прямой диффузионный ток.
Уравнения для плотности электронной и дырочной составляющих прямого тока получаются подстановкой соотношений (1.29) и (1.30) в (1.13) и (1.14) и, записываются в следующем виде:
; .
Плотность прямого тока, проходящего через p-n переход, можно определить как сумму jпр = jn диф + jp диф, не изменяющуюся при изменении координаты х. Если считать, что в запирающем слое отсутствуют генерация и рекомбинация носителей зарядов, то плотность прямого тока, определяемая на границах p-n перехода (при x = 0),
. (1.34)
Включение p-n перехода в обратном направлении приводит к обеднению приконтактной области неосновными носителями и появлению градиента их концентрации. Градиент концентрации является причиной возникновения диффузионного тока неосновных носителей.
На основании соотношений (1.13), (1.14) и (1.32), (1.33) выражение для расчета плотности обратного тока может быть записано в виде
. (1.35)
Объединяя выражения (1.34) и (1.35), можно записать уравнение для плотности тока в общем виде:
, (1.36) где .
Величину js называют плотностью тока насыщения. Умножив правую и левую части выражения (1.36) на площадь П p-n перехода, получим уравнение теоретической вольтамперной характеристики:
, (1.37)
где IS- ток насыщения. В это уравнение напряжение U подставляется со знаком "плюс" при включении p-n перехода в прямом направлении и со знаком "минус" при обратном включении.
Уравнение (1.37) позволяет рассчитать теоретическую вольтамперную характеристику тонкого электронно-дырочного перехода, в котором отсутствуют генерация и рекомбинация носителей зарядов.
Теоретическая вольтамперная характеристика p-n перехода, построенная на основании уравнения (1.37), приведена на рис. 1.10. При увеличении
Рисунок 1.10 Теоретическая вольтамперная характеристика p-n перехода.
обратного напряжения ток через p-n переход стремится к предельному значению js, которого достигает при обратном напряжении примерно 0,1...0,2 В.
На основании соотношений (1.2), (1.5), (1.8) и (1.10), считая, что все атомы примесей ионизированы, т. е. = Na, для области рабочих температур можно записать: . (1.38)
Из соотношения (1.38) видно, что чем больше ширина запрещенной зоны полупроводника и концентрация примесей доноров и акцепторов, тем меньше ток насыщения, а с увеличением температуры ток насыщения растет по экспоненциальному закону.
Процессы генерации и рекомбинации носителей в запирающем слое оказывают существенное влияние на вид вольтамперной характеристики. В отсутствие внешнего напряжения между процессами генерации и рекомбинации устанавливается равновесие. При приложении к p-n переходу обратного напряжения дырки и электроны, образующиеся в результате генерации, выводятся полем запирающего слоя. Это приводит к возникновению дополнительного тока генерации Iген, совпадающего с обратным током p-n перехода. Можно показать, что при = , tn = tр = t0 и Ln = Lp = L0 справедливо соотношение
, (1.39)
где d0 - толщина запирающего слоя.
Из выражения (1.39) видно, что генерационная составляющая обратного тока растет при увеличении ширины запрещенной зоны полупроводника, так как при этом уменьшается значение ni, а также при увеличении концентрации примесей, при которой возрастает . Например, при одинаковых значениях d0 и L0 для германия ni = 2,5×1013 см-3 (DW = 0,67 эВ) и Iген= 0,1×Is, а для кремния ni = 6,8×1010 см-3 (DW = 1,12 эВ) и Iген = 3000×IS,.
Таким образом, если в германиевых p-n переходах током генерации можно пренебречь, то в кремниевых p-n переходах он является основной составляющей обратного тока. Поэтому на вольтамперных характеристиках кремниевых p-n переходов нет выраженного участка насыщения.
1.3.5 Реальная вольтамперная характеристика p-n перехода
При выводе уравнения (1.37) не учитывались такие явления, как термогенерация носителей в запирающем слое перехода, поверхностные утечки тока, падение напряжения на сопротивлении нейтральных областей полупроводника, а также явления пробоя при определенных обратных напряжениях. Поэтому экспериментальная вольтамперная характеристика p-n перехода (кривая 2 на рис. 1.11) отличается от теоретической (кривая 1).
При обратном включении p-n перехода отличия обусловлены генерацией носителей зарядов и пробоем p-n перехода. Количество генерируемых носителей пропорционально объему запирающего слоя, который зависит от ширины p-n перехода. Поскольку ширина запирающего слоя пропорциональна , ток генерации будет расти при увеличении обратного напряжения. Поэтому на реальной характеристике при увеличении обратного напряжения до определенного значения наблюдается небольшой рост обратного тока. Возрастанию обратного тока способствуют также токи утечки.
При некотором обратном напряжении наблюдается резкое возрастание обратного тока. Это явление называют пробоем p-n перехода. Существуют три вида пробоя: туннельный, лавинный и тепловой. Туннельный и лавинный пробои представляют собой разновидности электрического пробоя
Рисунок 1.11 Отличие реальной вольтамперной характеристики p-n перехода
от теоретической.
и связаны с увеличением напряженности электрического поля в переходе. Тепловой пробой определяется перегревом перехода.
Туннельный пробой обусловлен прямым переходом электронов из валентной зоны одного полупроводника в зону проводимости другого, что становится возможным, если напряженность электрического поля в p-n переходе из кремния достигает значения 4×105 В/см, а из германия -2×105 В/см. Такая большая напряженность электрического поля возможна при высокой концентрации примесей в p- и n-областях, когда толщина p-n перехода становится весьма малой (см. формулу (1.31)). Под действием сильного электрического поля валентные электроны вырываются из связей. При этом образуются парные заряды электрон-дырка, увеличивающие обратный ток через переход. На рис. 1.10 кривая 5 представляет собой обратную ветвь вольт-амперной характеристики перехода, соответствующую туннельному пробою.
В широких p-n переходах, образованных полупроводниками с меньшей концентрацией примесей, вероятность туннельного просачивания электронов уменьшается и более вероятным становится лавинный пробой. Он возникает тогда, когда длина свободного пробега электрона в полупроводнике значительно меньше толщины p-n перехода. Если за время свободного пробега электроны приобретают кинетическую энергию, достаточную для ионизации атомов в p-n переходе, наступает ударная ионизация, сопровождающаяся лавинным размножением носителей зарядов. Образовавшиеся в результате ударной ионизации свободные носители зарядов увеличивают обратный ток перехода. Увеличение обратного тока характеризуется коэффициентом лавинного умножения М:
, (1.40)
где UПРОБ- напряжение начала пробоя; m зависит от материала полупроводника. На рис 1.11 лавинному пробою соответствует кривая 4.
Тепловой пробой обусловлен значительным ростом количества носителей зарядов в p-n переходе за счет нарушения теплового режима. Подводимая к p-n переходу мощность Рподв = IобрUобр расходуется на его нагрев.
Выделяющаяся в запирающем слое теплота отводится преимущественно за счет теплопроводности. Отводимая от p-n перехода мощность Ротв пропорциональна разности температур перехода Tпер и окружающей среды Токр:
,
где Rт - тепловое сопротивление, 0К/Вт, определяющее перепад температур, необходимый для отвода 1 Вт мощности от p-n перехода в окружающую среду.
При плохих условиях отвода теплоты от перехода возможен его разогрев до температуры, при которой происходит тепловая ионизация атомов. Образующиеся при этом носители заряда увеличивают обратный ток, что приводит к дальнейшему разогреву перехода. В результате такого нарастающего процесса p-n переход недопустимо разогревается и возникает тепловой пробой, характеризующийся разрушением кристалла (кривая 3).
Увеличение числа носителей зарядов при нагреве p-n перехода приводит к уменьшению его сопротивления и выделяемого на нем напряжения. Вследствие этого на обратной ветви вольтамперной характеристики при тепловом пробое появляется участок с отрицательным дифференциальным сопротивлением (участок АВ на рис. 1.11).
Отличия реальной характеристики от теоретической на прямой ветви, в основном, обусловлены распределенным (объёмным) сопротивлением электронной и дырочной областей r1 за пределами запирающего слоя (рисунок 1.12).
Если сопротивление запирающего слоя обозначить rд, то кристалл полупроводника с запирающим слоем можно представить в виде последовательного соединения резисторов rд и r1.
При прохождении тока IПР на сопротивлении r1 падает часть напряжения внешнего источника и на запирающем слое действует напряжение UПЕР = UПР – IПР×r1. Уравнение вольтамперной характеристики в этом случае может быть записано в следующем неявном виде:
.
Рисунок 1.12 Упрощенная эквивалентная схема p-n перехода с распределенным сопротивлением полупроводника.
Поскольку UПЕР< UПР реальная характеристика идет ниже теоретической. Когда напряжение на запирающем слое становится равным контактной разности потенциалов, запирающий слой исчезает, и дальнейшее увеличение тока ограничивается распределенным сопротивлением полупроводников p- и n-типа. Таким образом, в точке С при UПР = UК вольтамперная характеристика переходит в прямую линию.
Похожие работы
... условиям эксплуатации и конструктивным показателям, могут образовывать семейства серий интегральных схем. 2. ЛОГИЧЕСКИЕ ЭЛЕМЕНТЫ Логические и запоминающие элементы составляют основу устройств цифровой обработки информации – вычислительных машин, цифровых измерительных приборов и устройств автоматики. Логические элементы выполняют простейшие логические ...
... соединение “точка-точка” со скоростью до 3 Гб/с. 6. Как работают программы восстановления данных Каждый только что удаленный файл все еще находится на жестком диске, но Windows его больше не видит. Если программе восстановления данных необходимо восстановить этот файл, она просматривает загрузочный сектор раздела (Partition Boot Sector). В нем содержится вся информация о строении раздела, ...
... электротехнических и электронных устройств, в которых используется явление резонанса напряжения. Литература 1. Иванов И.И., Равдоник В.С. Электротехника. - М.: Высшая школа, 1984, с.53 - 58. 2. Касаткин А.С., Немцов М.В. Электротехника. - М.: Энергоатомиздат, 1983, с.73 - 77. Лабораторная работа №5 КОМПЕНСАЦИЯ РЕАКТИВНОЙ МОЩНОСТИ Цель работы. Ознакомление с методом повышения ...
... корпускулярные свойства его света, а волновые себя практически не проявляли. Впрочем, это и следует из таблицы.Полупроводниковые устройства. Для начала рассмотрим принцип действия полупроводниковых приборов. Поскольку для компьютера наиболее важными является транзисторы, именно ими мы рассмотрение полупроводниковых устройств и ограничим. Полупроводниками называют группу элементов и их соединений, ...
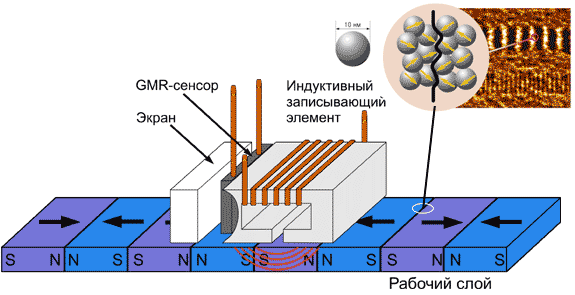
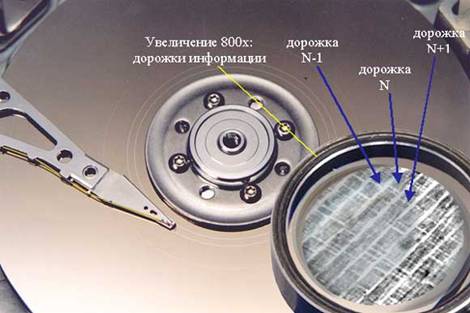






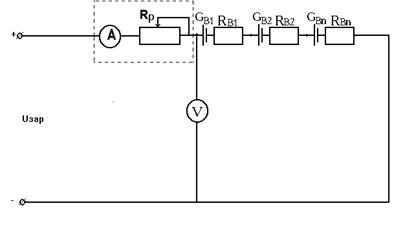
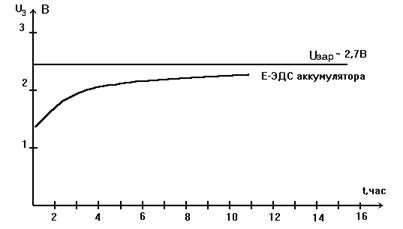
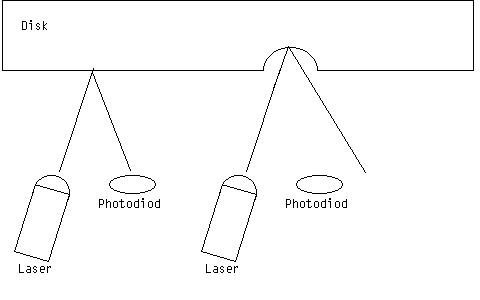




0 комментариев