Навигация
Ознайомитися з приладами, які використовуються в лабораторній роботі. При необхідності провести юстування оптичної системи установки
1. Ознайомитися з приладами, які використовуються в лабораторній роботі. При необхідності провести юстування оптичної системи установки.
2. Виміряти спектральну залежність величини фотоструму, проводячи вимірювання через 50–100 Ǻ. Результати вимірювань занести в таблицю.
Послідуючий аналіз результатів зручно проводити представивши спектральну залежність фотопровідності у відносних одиницях. Для цього потрібно провести нормування фотоструму до одиниці
 ,
,
де ІФ(λ) – фотострум при заданій довжині хвилі, ІТ – темновий струм (при відсутності освітлення), ІФ max – максимальне значення фотоструму в умовах досліду.
Провести перерахунок одержаних результатів на одиницю падаючої енергії і на однакову кількість падаючих фотонів, тобто обчислити величини
 та
та  ,
,
де δE(λ) знаходиться з виразу (3.9). Результати обчислень занести в таблицю.
3. Побудувати всі три криві у довільному масштабі на одному графіку.
4. Визначити ширину забороненої зони Eg досліджуваного напівпро-відникового матеріалу, скориставшись для цього спектральним положенням максимуму фотопровідності.
5. Провести вимірювання люксамперних характеристик зразка в області максимуму фотопровідності, змінюючи інтенсивність освітлення з допомогою світлофільтрів.
6. Побудувати люксамперну характеристику у відносних одиницях.
7. Проаналізувати одержані результати та зробити висновки.
Література
[1]. c. 211-236. [2]. c. 221-245. [4]. с. 221–266, 383–395.
ЛАБОРАТОРНА РОБОТА №4 Дослідження впливу електричного поля на електропровідність напівпровідників
Мета роботи: експериментальна перевірка впливу електричного поля на електропровідність напівпровідників та встановлення механізму впливу.
Необхідні прилади і матеріали: регульоване джерело постійної напруги; мікроамперметр; вольтметр; термостат з системою регулювання та контролю температури.
Теоретичні питання знання, яких необхідне для виконання лабораторної роботи:
1. Генерація нерівноважних носіїв заряду під дією сильного електричного поля.
2. Вплив електричного поля на рухливість носіїв заряду. “Розігрів” електронного газу.
3. Міждолинне розсіювання. Ефект Ганна.
Основні теоретичні відомості та методика експерименту
Якщо концентрації електронів n та дірок р і, відповідно їх рухливості ![]() ,
, ![]() не залежать від напруженості електричного поля
не залежать від напруженості електричного поля ![]() , то залежність густини струму
, то залежність густини струму ![]() описується законом Ома у диференціальній формі:
описується законом Ома у диференціальній формі:
![]() , де
, де ![]() . (4.1)
. (4.1)
У випадку, коли ![]() , залежність (4.1) не виконується. Це може бути пов’язано з тим, що при великих напруженостях електричного поля може відбуватись зміна концентрації носіїв заряду (польова генерація) та рухливості носіїв заряду.
, залежність (4.1) не виконується. Це може бути пов’язано з тим, що при великих напруженостях електричного поля може відбуватись зміна концентрації носіїв заряду (польова генерація) та рухливості носіїв заряду.
При збільшенні напруженості електричного поля дрейфова швидкість носіїв заряду ![]() зростає і може виявитись, що вона стає порівняною з середньою тепловою швидкістю
зростає і може виявитись, що вона стає порівняною з середньою тепловою швидкістю ![]() . У цьому випадку рухливість носіїв заряду починає залежати від Е і закон Ома порушується. Поля, при яких проявляється така залежність, називаються сильними. Гранична напруженість ЕК, з якої проявляється помітне відхилення від закону Ома, називається критичною.
. У цьому випадку рухливість носіїв заряду починає залежати від Е і закон Ома порушується. Поля, при яких проявляється така залежність, називаються сильними. Гранична напруженість ЕК, з якої проявляється помітне відхилення від закону Ома, називається критичною.
Збільшення швидкості електронів під дією зовнішнього поля можна трактувати як ефект “збільшення” температури у порівнянні з температурою кристалічної гратки – ефект розігріву електронів. Такі електрони мають енергію, більшу рівноважної теплової енергії, яка відповідає температурі гратки. Їх називають “гарячими” електронами.
Характер розігріву електронів може мати різний характер. В полях з відносно невеликою напруженістю електрони набувають незначну енергію. Але якщо ця енергія виявляється більшою за ту, яку вони втрачають при зіткненнях, то їх швидкість буде поступово зростати і електронний газ буде поступово розігріватись. Так як приріст швидкості направленого руху на довжині вільного пробігу електронами швидко втрачається в наступних зіткненнях, то розігрів електронного газу в цьому випадку зумовлений в основному ростом швидкості хаотичного руху.
В полях високої напруженості, навпаки, розігрів електронного газу відбувається в основному внаслідок направленої складової швидкості руху електронів. З збільшенням ![]() ця складова швидкості руху, а разом з нею і температура електронного газу можуть зростати, очевидно, до тих пір, поки енергія накопичена електронами на довжині вільного пробігу, не виявиться достатньою для збудження оптичних фононів. Зіткнення електронів з граткою стають у цьому випадку непружними і супроводжуються втратою накопиченої ними енергії і появою оптичних фононів.
ця складова швидкості руху, а разом з нею і температура електронного газу можуть зростати, очевидно, до тих пір, поки енергія накопичена електронами на довжині вільного пробігу, не виявиться достатньою для збудження оптичних фононів. Зіткнення електронів з граткою стають у цьому випадку непружними і супроводжуються втратою накопиченої ними енергії і появою оптичних фононів.
Як показує розрахунок при розсіюванні на акустичних фононах в сильних електричних полях рухливість обернено пропорційна кореню квадратному з напруженості електричного поля:
![]() ~
~![]() . (4.2)
. (4.2)
Але для випадку розсіювання на оптичних коливаннях іонної гратки при температурі нижче дебаївської одержують
![]() ~
~![]() . (4.3)
. (4.3)
У більшості випадків мають справу з залежністю (4.2), де з ростом напруженості електричного поля рухливість зменшується.
Зміна концентрації носіїв заряду в сильних електричних полях може відбуватись в результаті дії ряду механізмів. Одним з таких механізмів є термоелектронна іонізація Френкеля.
Електричне поле ![]() , створене в напівпровіднику, змінює енергетичний стан електронів в атомі. На рис. 4.1 пунктиром показана потенціальна яма донорного атома в напівпровіднику при відсутності електричного поля. Яма симетрична відносно осі енергій. Під дією зовнішнього поля
, створене в напівпровіднику, змінює енергетичний стан електронів в атомі. На рис. 4.1 пунктиром показана потенціальна яма донорного атома в напівпровіднику при відсутності електричного поля. Яма симетрична відносно осі енергій. Під дією зовнішнього поля ![]() яма деформується так як показано на рис. 4.1 суцільною лінією. Енергія активації, необхідна, для теплового викиду електрона з домішкового рівня
яма деформується так як показано на рис. 4.1 суцільною лінією. Енергія активації, необхідна, для теплового викиду електрона з домішкового рівня ![]() в зону провідності, зменшується на
в зону провідності, зменшується на ![]() .
.
Як показує розрахунок, це зменшення пропорційне ![]() , внаслідок чого ймовірність теплового збудження електронів у провідний стан зростає в
, внаслідок чого ймовірність теплового збудження електронів у провідний стан зростає в ![]() (
(![]() – коефіцієнт пропорціональності), що викликає збільшення в
– коефіцієнт пропорціональності), що викликає збільшення в ![]() концентрації носіїв заряду і електропровідності напівпровідників:
концентрації носіїв заряду і електропровідності напівпровідників:
![]() . (4.4)
. (4.4)
Співвідношення (4.4) називається законом Френкеля.
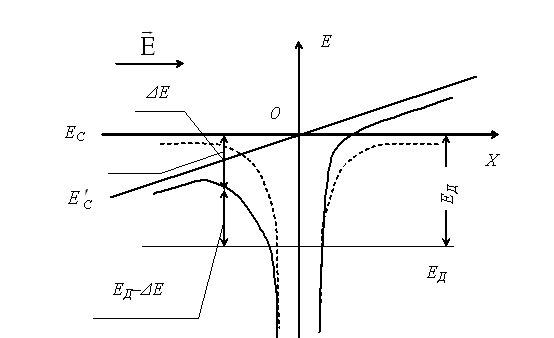
Рис. 4.1 Деформація потенціальної ями домішкового атома під дією зовнішнього електричного поля, яка приводить до зменшення енергії активації домішкової електропровідності (ефект Френкеля)
Для більш слабких полів теорія приводить до закону Пуля:
![]() , (4.5)
, (4.5)
де ![]() – залежний від температури коефіцієнт.
– залежний від температури коефіцієнт.
Під впливом зовнішнього електричного поля енергетичні зони напівпровідника нахиляються так, як показано на рис. 4.2,а. Це створює умови для двоякого переходу в зону провідності: по вертикалі 1 і по горизонталі 2.
Перехід 1 потребує затрати енергії і здійснюється шляхом теплового збудження або ударної іонізації.
Ударна іонізація відбувається в полях, здатних вільному електрону зону провідності надати енергію, достатню для того, щоб при зіткненні з атомами він був в стані достатньому для їх іонізації. Якщо при цьому іонізуючий електрон залишається в зоні провідності, то число вільних електронів буде неперервно збільшуватись.
Залежно від величини напруженості електричного поля ударна іонізація протікає по різному. В полях низької напруженості електрон на довжині вільного пробігу набуває тільки незначну частку енергії, необхідної для іонізації атома. Але якщо при зіткненнях з атомами електрон втрачає частку енергії меншу, чим набуває на довжині вільного пробігу, то швидкість його буде неперервно зростати і в кінцевому результаті стає достатньою для іонізації атома. Цей випадок показано на рис. 4.2,б. Таку ударну іонізацію називають низьковольтною.

Рис. 4.2 Іонізація напівпровідника під дією сильного електричного поля:
а – способи переходу електрона в зону провідності під дією сильного електричного поля: 1 – шляхом ударної іонізації; 2 – шляхом тунельного просочування; б – розігрів електронів зони провідності в полях відносно невисокої напруженості, який приводить до ударної іонізації; в – ударна іонізація в сильних електричних полях
В полях високої напруженості електрон може набувати енергію, необхідну для іонізації атома, вже на одній довжині вільного пробігу (рис. 4.2в). таку ударну іонізацію називають високовольтною.
Горизонтальні переходи 2 відбуваються без затрати енергії шляхом тунельного просочування електронів через заборонену зону. Цей механізм називають електростатичною іонізацією або ефектом Зінера. Ймовірність його w сильно залежить від ширини забороненої зони і напруженості електричного поля. Фактично цей перехід відбувається через трикутний потенціальний бар’єр висотою Eg та шириною X0. Для переходів типу 2 розрахунок приводить до наступного виразу для w:
![]() ~
~ . (4.6)
. (4.6)
Оцінка по цій формулі показує, що при ![]() еВ ймовірність w стає помітною при
еВ ймовірність w стає помітною при ![]() В/м. У домішкових напівпровідниках помітна електростатична іонізація спостерігається уже в полях з напруженістю
В/м. У домішкових напівпровідниках помітна електростатична іонізація спостерігається уже в полях з напруженістю ![]() В/м. З (4.6) слідує, що w, відповідно і концентрація носіїв заряду, генерованих в напівпровіднику під дією електричного поля
В/м. З (4.6) слідує, що w, відповідно і концентрація носіїв заряду, генерованих в напівпровіднику під дією електричного поля ![]() , не залежить від температури.
, не залежить від температури.
(для випадку коли ширина забороненої зони не залежить від температури). Для більшості напівпровідників Eg з збільшенням температури зменшується і, відповідно, це приводить до зростання ймовірності тунельних переходів і зростання струму. Тобто при електростатичній іонізації температурний коефіцієнт спаду напруги є від’ємним на відміну від термоелектронної і ударної іонізації.
Збільшення концентрації носіїв заряду в результаті ударної і електростатичної іонізації не носить на перших порах лавинного характеру, так як вріноважується процесом рекомбінації, який протікає з тим більшою швидкістю, чим більше утворюється електронів в зоні провідності і дірок у валентній зоні. Але в дуже сильних електричних полях (порядку 107–109 В/м) починається лавинний характер наростання числа носіїв, який супроводжується пробоєм напівпровідника.
На рис. 4.3 приведена якісна крива зміни питомої електропровідності напівпровідника з підвищенням напруженості електричного поля ![]() і вказані (орієнтовно) критичні значення напруженостей переходу від одного механізму зміни σ до іншого.
і вказані (орієнтовно) критичні значення напруженостей переходу від одного механізму зміни σ до іншого.
Експериментально встановити вплив електричного поля на електропровідність напівпровідників можна шляхом дослідження вольт-амперних характеристик (ВАХ). Температурні дослідження дають можливість встановити механізм польової генерації. Принципова електрична схема для дослідження ВАХ представлена на рис. 4.4.

Рис. 4.3 Якісна залежність зміни питомої електропровідності напівпровідника від напруженості електричного поля: 1 – ділянка Ома; 2 – ділянка Френкеля або Пуля; 3 – ділянка електростатичної іонізації; 4 – пробій

Рис. 4.4 Принципова електрична схема для дослідження ВАХ
При температурних дослідженнях зразок поміщають у термостат. За експериментально виміряними характеристиками будують графіки I=f(U). З цих залежностей визначають:
– статичний опір
![]() (4.7)
(4.7)
– динамічний опір
![]() (4.8)
(4.8)
– коефіцієнт нелінійності k, який показує, у скільки разів ![]() при заданій напрузі більший
при заданій напрузі більший ![]() ,
,
![]() ; (4.9)
; (4.9)
– температурний коефіцієнт зміни струму
 ; (4.10)
; (4.10)
– температурний коефіцієнт зміни спаду напруги
 . (4.11)
. (4.11)
Завдання до лабораторної роботи
1. Зібрати електричну схему, зображену на рис. 4.4. виміряти статичну ВАХ при температурах 300, 330, 360 К.
2. Обчислити електропровідність σ матеріалу при різних напругах для T=const.
3. Побудувати графіки залежності lnσ=f(E) або lnσ=f(U) для вимірюваних температур.
4. За формулами (4.7) – (4.11) основні параметри досліджуваного зразка. Проаналізувати механізм впливу температури на ВАХ та визначити механізм польової генерації.
5. Обчислити похибки вимірювань та зробити висновки.
Література
[1]. c. 320-331. [2]. c. 348-363. [4]. с. 288-301. [5]. с. 191-210.
ЛАБОРАТОРНА РОБОТА №5
Експериментальне вивчення ємнісних властивостей електронно-діркових переходівМета роботи: дослідження вольт-фарадних характеристик (ВФХ) p-n переходів та визначення параметрів напівпровідникового матеріалу.
Необхідні прилади і матеріали: регульоване джерело постійної напруги; вольтметр; прилад для вимірювання електричної ємності; досліджувані зразки.
Теоретичні питання знання, яких необхідне для виконання лабораторної роботи:
1. Глибина екранування зовнішнього електричного поля.
2. Товщина p-n переходу та її залежність від напруги, концентрації та характеру розподілу легуючих домішок.
3. Дифузійна та бар’єрна ємності p-n переходу.
Основні теоретичні відомості та методика експерименту
Інжекція неосновних носіїв заряду (при прикладанні до p-n переходу прямої напруги) і екстракція неосновних носії (у випадку зворотної напруги), приводять до зміни, порівняно з рівноважними концентраціями, сумарного об’ємного заряду у електронейтральних областях p-n переходу.
Зміну сумарного заряду об’ємного Q, для прямо зміщеного p-n переходу, можна розглядати як дію деякої ємності С. Ця ємність одержала назву дифузійної (СДИФ). СДИФ можна знайти, виходячи з відомої залежності ![]() і, у випадку емітера р-типу, її залежність від струму p-n переходу задається виразом:
і, у випадку емітера р-типу, її залежність від струму p-n переходу задається виразом:
![]() , (5.1)
, (5.1)
де IF і IR – значення прямого і зворотного струмів відповідно, τр – час життя дірок, q – заряд електрона.
Це рівняння показує, що дифузійна ємність проявляється при прямих напругах і збільшується з ростом прямого струму. При зворотних напругах вклад цієї ємності є незначним в силу значно меншої величини зворотного струму і при досягненні цим струмом постійного значення є сталою величиною.
Таким чином, СДИФ при великих зворотних напругах не проявляється. Але у цьому випадку суттєвим є прояв так званої зарядової або бар’єрної ємності. Формування і зміна цієї ємності полягає у наступному.
При прикладанні до p-n переходу зворотної напруги основні і неосновні носії вільні заряду виштовхуються (екстрагуються з прилягаючих до границь розділу шарів різного типу електропровідності). В результаті залишаються некомпенсовані об’ємні заряди нерухомих донорів і акцепторів. Очевидно, що чим з більшого об’єму будуть виштовхнуті полем рухомі носії заряду, тобто чим більші товщини dn і dp шарів об’ємного заряду, тим більша величина об’ємних некомпенсованих зарядів. Ця зміна об’ємних зарядів у p-n переході при зміні зворотної напруги і визначає роботу p-n переходу як електрично керованої ємності. Її вплив в електричних схемах проявляється в тому випадку, коли напруга на p-n переході змінюється з часом. Тоді окрім струму, який визначається статичною ВАХ, протікає додатковий ємнісний струм, рівний C(dU/dt). Він зв’язаний з зміною об’ємних зарядів з часом: I(t)=dQ/dt=(dQ/dU)* *(dU/dt). Тому бар’єрна ємність C=Cбар=dQ/dU. На відміну від звичайного конденсатора відношення заряду до повної напруги на p-n переході ![]() не рівне його ємності, так як
не рівне його ємності, так як ![]() не дає ємнісного струму. Це пояснюється нелінійністю залежності Q(U); по цій же причині бар’єрна ємність залежить від напруги.
не дає ємнісного струму. Це пояснюється нелінійністю залежності Q(U); по цій же причині бар’єрна ємність залежить від напруги.
У випадку несиметричного p+-n переходу (Na>>Nd) з ступінчатим розподілом домішки об’ємний заряд
![]() , (5.2)
, (5.2)
де ![]() – концентрація донорів в базі,
– концентрація донорів в базі,  – товщина збідненого шару несиметричного p-n переходу, UJ – контактна різниця потенціалів.
– товщина збідненого шару несиметричного p-n переходу, UJ – контактна різниця потенціалів.
Тоді, враховуючи вище викладене одержуємо вираз для бар’єрної (зарядової) ємності
 . (5.3)
. (5.3)
Останній запис формули (5.3) справедливий для p-n переходу з будь-яким розподілом концентрацій домішок. З неї видно, що зарядова ємність співпадає з ємністю плоского конденсатора з віддалю між обкладками, рівній товщині збідненого шару. Аналогія з плоским конденсатором дозволяє наглядно пояснити властивості бар’єрної ємності. Наприклад, з ростом модуля зворотної напруги зарядова ємність зменшується, що зумовлено зростанням товщини p-n переходу, тобто віддалі між обкладками конденсатора. Збільшення концентрації легуючих домішок збільшує ємність, так як віддаль між обкладками зменшується.
Для плавного p-n переходу з лінійним розподілом домішок бар’єрна ємність визначається наступним виразом:
 , (5.4)
, (5.4)
де а – градієнт концентрації.
Залежність ємності від напруги називається вольт-фарадною характеристикою. По ВФХ можна визначити тип переходу.
Схема, яка використовується для вимірювання ВФХ у цій лабораторній роботі, приведена на рис. 5.1. Конденсатор С1 запобігає попаданню постійної складової напруги на вхід приладу для вимірювання ємності. Якщо С1>>Cбар то його ємність не враховується. Резистор R2 зменшує шунтуючу дію вхідного вольтметра V (R2=100 кОм).

Рис. 5.1 Схема для дослідження вольт-фарадних характеристик p-n переходу
Завдання до лабораторної роботи
1. Дослідити залежність бар’єрної (зарядової) ємності Cбар від величини зворотної напруги U прикладеної до діода [вольт-фарадну характеристику C=f(U)].
2. Побудувати графіки залежностей (1/С)2=f(U) і (1/С)3=f(U). По одержаних графіках визначити:
а) тип переходу (різкий або плавний);
б) для різкого p-n переходу екстраполюючи графік залежності (1/С)2=f(U) до значення (1/С)2=0 визначити контактну різницю потенціалів UJ;
в) концентрацію донорів Nd. Для цього використати формулу (5.3) і залежність (1/С)2=f(U). При розрахунках прийняти, що S=0,5 мм2, ε=11,6 (Si).
3. По виміряних значеннях С за формулою для ємності плоского конденсатора розрахувати і побудувати графік залежності товщини p-n переходу d від зовнішньої напруги U.
4. Знайти положення рівня Фермі, допустивши, що донорна домішка при температурі досліду є повністю іонізована, тобто рівноважна концентрація вільних носіїв ![]() . Для визначення використайте формулу, яка встановлює зв’язок між положенням рівня Фермі і концентрацією рівноважних носіїв заряду
. Для визначення використайте формулу, яка встановлює зв’язок між положенням рівня Фермі і концентрацією рівноважних носіїв заряду
 . (5.5)
. (5.5)
Згідно закону діючих мас ![]() , визначити концентрацію неосновних носіїв заряду – дірок. Матеріал – кремній.
, визначити концентрацію неосновних носіїв заряду – дірок. Матеріал – кремній.
5. На основі одержаних результатів побудувати енергетичну діаграму p-n переходу в рівноважному стані. Прийняти Eg=1,1 еВ.
6. Обчислити похибки вимірювань. Проаналізувати одержані результати та зробити висновки.
Література
[1]. c. 320-331. [2]. c. 348-363. [4]. с. 221-266, 288-301. [5]. с. 135-170, 191-210.
ЛАБОРАТОРНА РОБОТА №6
Дослідження впливу температури на вольт-амперну характеристику p-n переходуМета роботи: експериментально встановити залежність властивостей p-n переходу від температури та визначити контактну різницю потенціалів, опір бази та складові зворотного струму.
Необхідні прилади і матеріали: регульоване джерело постійної напруги; вольтметр (0-300 В); мілівольтметр (0-1000 мВ); мілі- та мікроамперметр; термостат з системою стабілізації та контролю температури; германієві та кремнієві площинні діоди.
Теоретичні питання знання, яких необхідне для виконання лабораторної роботи:
1. Фізичні процеси, які відбуваються в результаті контакту напівпровідників з різним типом провідності.
2. Електронно-дірковий перехід у рівноважному стані. Енергетична діаграма.
3. Інжекція та екстракція носіїв заряду.
4. Вольт амперна характеристика (ВАХ) p-n переходу. Генерація та рекомбінація в області просторового заряду (ОПЗ). Вплив температури на ВАХ.
5. Випрямлення на p-n переході.
6. Гетеропереходи.
Основні теоретичні відомості та методика експерименту
Рівняння залежності густини струму через ідеальний p-n перехід від прикладеної напруги має вигляд:
 , (6.1)
, (6.1)
де U – спад напруги на p-n переході (знак “+” відповідає прямому зміщенню переходу , “–“ – зворотному), JS – густина струму термічної генерації (тепловий струм або струм насичення), ![]() – температурний потенціал (при Т=300 К φТ=0,026 еВ). Для симетричного тонкого p-n переходу густина теплового струму
– температурний потенціал (при Т=300 К φТ=0,026 еВ). Для симетричного тонкого p-n переходу густина теплового струму


 , (6.2)
, (6.2)
де Dn(p) – коефіцієнт дифузії електронів (дірок); Ln(p) – дифузійна довжина електронів (дірок); τn(p) – час життя електронів (дірок); ni – концентрація носіїв заряду у власному напівпровіднику.
Для несиметричного p+-n переходу у якому Na>>Nd і, відповідно, pp0>>nn0 густина теплового струму  . Якщо густину струму помножити на площу переходу S, то одержимо значення теплового струму
. Якщо густину струму помножити на площу переходу S, то одержимо значення теплового струму
 (6.3)
(6.3)
З останнього слідує фізичний зміст теплового струму – IS можна представити як струм, що виникає в результаті теплової генерації дірок в квазінейтральній n-базі в об’ємі SLp з швидкістю pn0/τp (дірок в см3 за секунду), тобто в шарі бази товщиною Lp, яка прилягає до границі ОПЗ.
Як слідує з (6.1) при зворотній напрузі UR>3φT, експоненціальна складова стає значно меншою за одиницю і її можна не враховувати. Зворотний струм через перехід визначають значенням теплового струму, який, відповідно до (6.2) та (6.3), є постійною величиною не залежною від напруги:
IR=–IS=const. (6.4)
Експериментально встановлено, що вираз (6.1) задовільно описує ВАХ p-n переходів виготовлених на основі напівпровідників з малою шириною забороненої зони, включаючи германій (Eg=0,66 еВ). Зворотні ділянки ВАХ кремнієвих, арсенідогалієвих, фосфідогалієвих p-n переходів не мають ділянки насичення. Для пояснення цього необхідно врахувати теплову генерацію в ОПЗ p-n переходу.
При зворотній напрузі на p-n переході область ОПЗ збіднена носіями заряду і рівновага між процесами генерації і рекомбінації порушена в бік генерації носіїв заряду. Це в основному обумовлено наявністю локальних рівнів поблизу середини Eg.
У результаті генерації пар електрон-дірка виникає зворотний струм IRG, який пропорційний об’єму ОПЗ S·d(U) і швидкості генерації у збідненому шарі G=ni/(2τ0), де – τ0=τn=τp час життя носіїв заряду в ОПЗ. По аналогії з (6.3) можемо записати:
 , (6.5)
, (6.5)
де –  ; n=1/2 для різкого і n=1/3 для плавного p-n переходів; UJ
; n=1/2 для різкого і n=1/3 для плавного p-n переходів; UJ
– контактна різниця потенціалів.
Струм генерації зростає при збільшенні зворотної напруги, що пов’язано з розширенням збідненого шару. З (6.3) і (6.5) слідує
![]() ~
~![]() ~
~![]() ,
,
тобто вклад струму генерації в повний зворотний струм тим більший, чим більша ширина забороненої зони і нижча температура. Наприклад, для кремнієвого p-n переходу при Т=25°С і U=–1 B одержуємо IG=10-9 A, a I0=10–14 A.
Реальні p-n переходи мають ділянки, які виходять на поверхню ділянки напівпровідникового кристалу. На поверхні внаслідок забруднень і впливу поверхневого заряду між р– і n–областями можуть утворюватись провідні плівки і канали, по яких протікає струм утрат. Він зростає пропорційно напрузі і при достатньо великій напрузі може перевищити тепловий струм і струм генерації. Для струму втрат характерна незначна залежність від температури. В кремнієвих приладах поверхня кристала покрита захисним шаром оксиду і цей струм, як правило, є, нехтуючи малим.
Враховуючи останнє можна записати, що зворотний струм реального p-n переходу визначається, в основному, як сума теплового струму та струму генерації:
IR=–IS–ІG. (6.6)
З всіх електрофізичних параметрів, які входять у вирази для ![]() та
та![]() , найбільшу залежність від температури має власна концентрація носіїв заряду ni:
, найбільшу залежність від температури має власна концентрація носіїв заряду ni:
 . (6.7)
. (6.7)
Нехтуючи степеневими залежностями від температури порівняно з експоненціальною, одержуємо:
![]() ; (6.8)
; (6.8)
![]() , (6.9)
, (6.9)
де ![]() ;
; ![]() ;
; ![]() ;
; ![]() ;
; ![]() ;
; ![]() ,
, ![]() – температури подвоєння відповідного струму.
– температури подвоєння відповідного струму.
Для кремнію температура подвоєння струму ![]() складає
складає ![]() 9°С, а для
9°С, а для ![]() значення
значення ![]() 4 К, поблизу 300 К. Для германієвих p-n переходів за звичай
4 К, поблизу 300 К. Для германієвих p-n переходів за звичай ![]() , а для кремнієвих
, а для кремнієвих ![]() при Т=300 К, але при максимально допустимих температурах кремнієвих p-n переходів, що досягають 150–170°С, струм насичення може перевищувати струм генерації за рахунок більш сильного зростання струму насичення з температурою.
при Т=300 К, але при максимально допустимих температурах кремнієвих p-n переходів, що досягають 150–170°С, струм насичення може перевищувати струм генерації за рахунок більш сильного зростання струму насичення з температурою.
При прямій напрузі на p-n переході в результаті зниження висоти потенціального бар’єру концентрація носіїв заряду в ОПЗ переходу зростає і стає більшою за рівноважну. Тому в ОПЗ може відбуватись рекомбінація електронів і дірок. Струм рекомбінації в ОПЗ p-n переходу
 , (6.10)
, (6.10)
де ![]() – час життя носіїв заряду в ОПЗ переходу.
– час життя носіїв заряду в ОПЗ переходу.
Передекспоненціальний множник залежить від напруги через залежність товщини ОПЗ від напруги і наявність множника ![]() в знаменнику. Але ця залежність значно слабша за експоненціальну, і в першому наближенні можна вважати, що струм
в знаменнику. Але ця залежність значно слабша за експоненціальну, і в першому наближенні можна вважати, що струм ![]() має постійне значення.
має постійне значення.
В широкозонних напівпровідниках при малих прямих напругах (![]() ) струм рекомбінації в ОПЗ може виявитись більшим за струм інжекції, розрахований по формулі (6.1). але з ростом прямої напруги через наявність в знаменнику показника експоненти множника 2 струм IRG зростає значно повільніше, чим струм інжекції, і в робочому діапазоні струмів переважає струм інжекції.
) струм рекомбінації в ОПЗ може виявитись більшим за струм інжекції, розрахований по формулі (6.1). але з ростом прямої напруги через наявність в знаменнику показника експоненти множника 2 струм IRG зростає значно повільніше, чим струм інжекції, і в робочому діапазоні струмів переважає струм інжекції.
Повний струм через p-n перехід при прямій напрузі рівний сумі струмів інжекції і рекомбінації носіїв заряду в ОПЗ:

 . (6.11)
. (6.11)
Слід зауважити, що з ростом температури співвідношення струмів інжекції і рекомбінації в ОПЗ змінюється: струм IR0 зростає значно слабше, так як він ~ni, а струм інжекції IS ~![]() .
.
Збільшення температури приводить до зменшення контактної різниці потенціалів
 (6.12)
(6.12)
і, відповідно, до зменшення висоти потенціального бар’єру і зменшення прямого спаду напруги при постійному значенні струму. Температурний коефіцієнт прямого спаду напруги (ТКUF) є від’ємним і складає –(1,5÷3,5) мВ/К. При розрахунках приймають ТКUF= –2 мВ/К.
Для дослідження прямої ділянки ВАХ p-n переходу використовується принципова електрична схема приведена на рис. 6.1а). Спад напруги на діоді визначають мілівольтметром mV, який безпосередньо приєднаний до діода VD1, а струм у колі вимірюють міліамперметром mA. У випадку зворотного включення (рис. 6.1б) струм у колі вимірюють мікроамперметром μА, а напруга вимірюється вольтметром V, який ввімкнено на вихід регульованого джерела напруги для усунення шунтування діода вольтметром.

Рис. 6.1 Принципова електрична схема для дослідження ВАХ p-n переходу
Завдання до лабораторної роботи
Похожие работы
... принтера також містить різні мови опису даних (Adobe PostScript, PCL і тощо.). Ці мови знову ж таки призначені для того, щоб забрати частину роботи у комп'ютера і передати її принтеру. Розглянемо фізичний принцип дії окремих компонентів лазерного принтера. 2.5.29 Фотобарабан Як вже писалося вище, найважливішим конструктивним елементом лазерного принтера є фотобарабан, що обертається, за ...
... яка була накопичена до п'ятидесятих років у радіочастотній й оптичній спектроскопії і які згодом отримали своє використання у квантовій електроніці. Розділ 2. Основні поняття квантової електроніки (фізичні основи квантової електроніки) Принцип дії лазера або мазера заснований на трьох «китах» – головних поняттях квантової електроніки, а саме на поняттях вимушеного випромінювання, інверсного ...
... івкові катоди, наприклад сурм'яно-цезієві, що характеризуються виборчою фотоелектронною емісією. Вони мають максимальну чутливість до променів певної частини спектра. Чутливість – основний параметр фотоелектронного приладу. Розрізняють інтегральну (світлову) і спектральну чутливість. Інтегральна чутливість – це чутливість фотокатода до сумарного, не розкладеному в спектр, світловому потоку. Вона ...
... (задаючий) показує, яким чином виконуються помітки суміщення й обов'язкові для складних приладів тестові структури, що дозволяють перевіряти роздільну здатність фотолітографії, технологічні параметри (поверхневий опір, дефекти окисла) і електричні параметри пристрою. До другого виду відносяться вказівки про методику і критерії контролю характеристик виготовлених шаблонів: розмірів, сумісності, ...

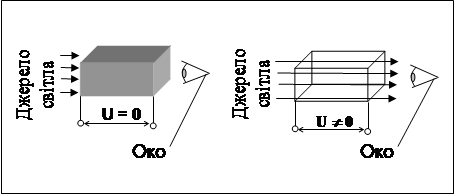

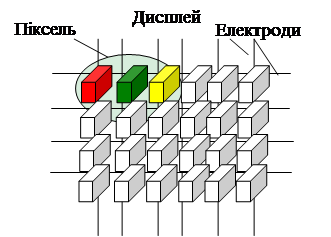
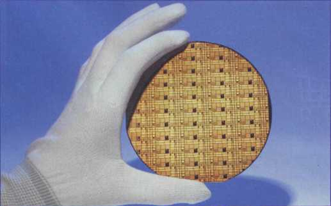

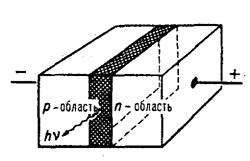
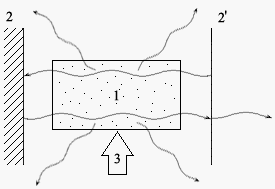
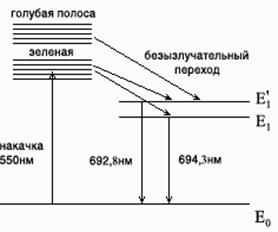

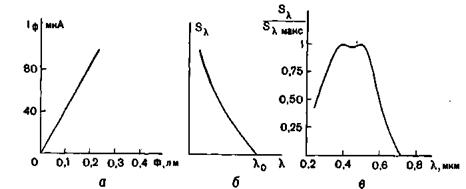



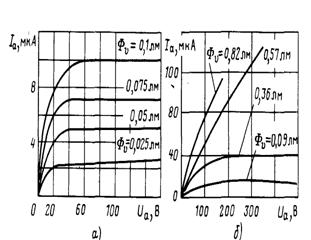



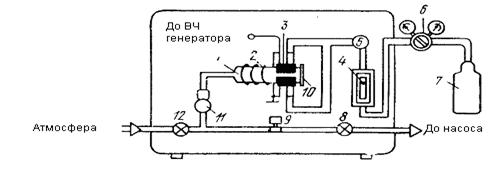
0 комментариев