Навигация
Влияние технологических факторов зарождения новой фазы на структуру пленок
2. Влияние технологических факторов зарождения новой фазы на структуру пленок
Из уравнений (3.6) и (3.23) следует, что размеры критического зародыша rкр, его свободная энергия (энергетический барьер) ДGкр и скорость образования зародыша х3 зависят от значений поверхностной энергии, контактного угла, температуры, степени перенасыщения (скорости конденсации), энергии активации поверхностной диффузии. Эти характеристики могут рассматриваться как технологические параметры ТП и исходных материалов, поэтому проанализируем их влияние на стадии образования зародышей и формирования первых (моноатомных) слоев.
Пленка, образованная при высоком энергетическом барьере, должна состоять из зародышей, имеющих большой критический радиус и низкую скорость зарождения (малое число зародышей), т. е. состоять из нескольких крупных агрегатов. Пленка, образованная при низком энергетическом барьере, должна состоять из зародышей, имеющих малый критический радиус и высокую скорость зарождения (большое число зародышей), т. е. состоять из большого числа мелких агрегатов. Такая пленка становится сплошной при относительно малом значении средней толщины, поскольку зародыши уже на ранних стадиях осаждения соприкасаются и срастаются. Кроме того, структура такой пленки более мелкодисперсная, чем у пленки с большим rкр и малым х3. Это, в свою очередь, будет сказываться на электрических свойствах полученных слоев. Таким образом, анализ влияния технологических параметров на rкр, ДGкр, х3 может в первом приближении дать ответ на характер их взаимной зависимости и связь с электронными свойствами полученных слоев.
Сопоставление приведенных данных указывает на существенную зависимость rкр от природы осаждаемого материала и особенно от такого его свойства, как давление насыщенного пара, связанного с теплотой испарения. Поскольку теплота испарения прямо пропорциональна точке кипения (согласно правилу Трутона), можно заключить, что материалы с высокой температурой кипения обладают большим значением ДGV. Следовательно, размеры критических зародышей должны уменьшаться с повышением температуры кипения вещества пленки. Поэтому у металлов с высокой температурой кипения (W, Мо, Rе, Та, Ni, Cr и др.) даже очень малые зародыши являются стабильными. У металлов с невысокой температурой кипения (Zn, Cd, Ag, Au, Cu и др.) зародыши должны достичь значительной величины, прежде чем стать стабильными. С увеличением размеров их устойчивость повышается.
При срастании агрегатов между ними формируются границы зерен. Таким образом, размер зерен образующейся пленки определяется величиной критических и (сверхкритических) зародышей. В свою очередь, как подчеркивалось ранее, структура пленки влияет на ее электрофизические свойства. Окончательные размеры зерен зависят и от режимов последующей обработки пленки, например ее отжига при определенных температуре, времени, давлении и т. п. Исследования тонких пленок показали, что материалы пластины и испаряемого вещества, а также условия осаждения влияют на структуру пленок.
Из приведенных соотношений следует, что размеры критических зародышей резко снижаются, если материал пластины имеет большое сродство с осаждаемым веществом, т. е. малый угол ц. Например, если в качестве материала пластины служит металл, для которого уS= 1,5 Дж/м2, ц→0, то при осаждении алюминия rкр может иметь значение, близкое к нулю, что указывает на отсутствие энергетического барьера при зарождении пленки даже у металлов с высоким давлением насыщенного пара. Поэтому образование сплошных пленок может происходить при нанесении на металлическую или полупроводниковую пластину даже нескольких моноатомных слоев осаждаемого металла. Такое явление часто используется в технологии РЭА для создания адгезионных подслоев при получении пленок из материалов, имеющих малое сродство с пластиной (плохую адгезию к пластине). При этом сначала на пластину напыляют какой-либо материал с малым рк и хорошей адгезией к пластине (ц→0), например Сr или W, затем на него — основной металл (А1, Сu, Аu и т. п.), который будет осуществлять ту или иную заданную электрическую функцию.
Влияние температуры пластины на размеры критического зародыша определяется зависимостью, полученной в результате дифференцирования выражения (3.6) по температуре:
![]()
![]()
Согласно средним значениям величин, входящих в (3.24) для металлов, уS= 1 Дж/м2, ∂ДGv/∂T≈ДSисп≈8,8∙106 Дж/(м3∙К); дуS /дТ≈5∙10-4 Дж/(м2∙К) при | ДGv | <1,64∙1010 Дж/м3 получим
![]()
![]()
что имеет место практически во всех случаях, когда существует энергетический барьер образования зародышей.


Следовательно, увеличение температуры пластины ведет к росту rкр и сохранению островковой структуры и для более высоких значений средней толщины пленки. На рис. 3.6 приведена зависимость среднего расстояния d между агрегатами (плотности агрегатов) от температуры пластины при термическом испарении и катодном распылении. Угол наклона кривых 1 и 2 позволяет определить ДGп.д.
Продифференцировав ДGкр по температуре, найдем
![]()
![]()
Поскольку скорость образования зародышей х3 экспоненциально связана с ДGкр [см. уравнение (3.23)], скорость возникновения агрегатов критических и сверхкритических размеров быстро убывает с ростом температуры. В этом случае для создания сплошной пленки потребуется более продолжительное время.
Влияние скорости осаждения пленки (степени перенасыщения) на размеры критических зародышей (rкр) и ДGкр обусловлено зависимостью этой скорости от значения ДGv [см. (3.3) и (3.4)]. При увеличении N↓ или рпер (ри—pк) возрастает ДGv. Поскольку поверхностные энергии пластины и границы раздела не зависят от N↓,
![]()
![]()
Следовательно, рост скорости осаждения пленки приводит к уменьшению размеров зародышей и увеличению скорости их возникновения. Поскольку зависимость ДGv = f (N↓) является логарифмической, влияние скорости осаждения пленки на значения rкр и ДGкр сказывается очень сильно.
Повышение скорости осаждения при реальных условиях может привести и к увеличению размеров критических зародышей, т. е. зависимость rкр = f(N↓) является более сложной, чем описываемая теорией Гиббса — Фольмера.
Влияние поверхностной диффузии на размеры критического зародыша аналитически определить нельзя. Однако скорость образования критических зародышей должна зависеть от способности адсорбированных атомов диффундировать и сталкиваться друг с другом. Согласно уравнению (3.23) эта скорость уменьшается экспоненциально с увеличением энергии активации поверхностной диффузии. Если энергия активации велика, то диффузия протекает медленно и зародыши растут только за счет столкновения их с атомами паровой фазы. Энергию активации диффузии часто принимают равной 1/4 энергии активации десорбции в газовую фазу, т. е.
![]()
Энергия связи осаждаемых атомов с пластиной ДGадс, как показано ранее, влияет на значения rкр и ДGкр. Поэтому для неоднородных поверхностей пластин, где ДGадс заметно изменяется от участка к участку, на различных участках пластины значения rкр и ДGкр различны, что сказывается на однородности осаждаемой пленки. Вот почему в технологии РЭА необходимо иметь подложки с однородной и чистой поверхностью.
Энергия адсорбции для некоторых металлов имеет следующие значения:
![]()
Похожие работы
... равномерной по глубине, поверхностная концентрация носителей уменьшается и ФМЭ убывает согласно формуле: (10) 3. Оценка перспектив использования фотоэлектромагнитного эффекта в устройствах функциональной электроники Современная твердотельная электроника, являясь основным средством обработки информации, развивается по двум главным направлениям: интегральной электроники, ...
... ]/[В]. 5. Температурный коэффициент сопротивления – показатель температурной стабильности. Показывает относительное изменение сопротивления при изменении температуры на один градус. aR= DR/ Dt *1/R0 6. Функциональная характеристика (кривая регулирования) – зависимость сопротивления от угла поворота. А – линейная зависимость; Б – логарифмическая; В – показательная; Схема ...
. Когерентная ОЭ базируется на использовании лазерного излучения. К некогерентной ОЭ относят дискретные и матричные некогерентные излучатели и построенные на их основе цифровые индикаторные устройства визуального представления информации, шкалы, табло, экраны, а также фото приемные устройства, оптопары, оптронные интегральные микросхемы (ИМС) и др. 2. НЕКОГЕРЕНТНЫЕ ИЗЛУЧАТЕЛИ 2.1. ...
... . Резисторы с такими зависимостями применяются для регулировки громкости и тембра звука, яркости свечения индикаторов и др. Резисторы с характеристиками Е и И используют в регулировке стереобаланса, а резисторы с косинусными и синусными зависимостями применяют в устройствах автоматики и вычислительной техники. Отклонения от заданной кривой определяются допусками. Для резисторов общего применения ...
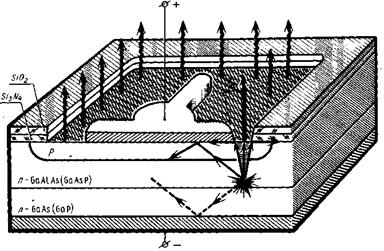

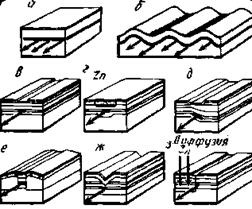

0 комментариев