Навигация
Изготовление биполярных ИМС с диэлектрической изоляцией
6.3 Изготовление биполярных ИМС с диэлектрической изоляцией
Диэлектрическая изоляция обеспечивает лучшие параметры ИМС.
![]() а) Изоляция пленкой диэлектрика с использованием поликристаллического кремния реализуется в эпик-процессе. Исходной заготовкой является однослойная nn+-структура (рис 18). После локального травления на глубину около 15 мкм и удаления SiO2-маски термически выращивают или осаждают из паро-газовой фазы пленку диоксида кремния толщиной 1 ¸ 2 мкм. Поверх нее осаждают слой высокоомного поликремния толщиной 175 ¸ 200 мкм. Для получения изолированных n+n-карманов лишнюю часть кремния сошлифовывают. Полученная при этом подложка структуры ИМС, как и при изоляции p-n-переходом, проводящая, хотя и имеет более высокое удельное сопротивление. Для улучшения изоляции слой SiO2 иногда заменяют слоем Si3N4, двойными слоями SiO2–Si3N4 или SiO2–SiC.
а) Изоляция пленкой диэлектрика с использованием поликристаллического кремния реализуется в эпик-процессе. Исходной заготовкой является однослойная nn+-структура (рис 18). После локального травления на глубину около 15 мкм и удаления SiO2-маски термически выращивают или осаждают из паро-газовой фазы пленку диоксида кремния толщиной 1 ¸ 2 мкм. Поверх нее осаждают слой высокоомного поликремния толщиной 175 ¸ 200 мкм. Для получения изолированных n+n-карманов лишнюю часть кремния сошлифовывают. Полученная при этом подложка структуры ИМС, как и при изоляции p-n-переходом, проводящая, хотя и имеет более высокое удельное сопротивление. Для улучшения изоляции слой SiO2 иногда заменяют слоем Si3N4, двойными слоями SiO2–Si3N4 или SiO2–SiC.
Таким образом, получение кремниевых карманов в поликристаллическом кремнии выполняется по меза-эпитаксиальной технологии. Элементы ИМС в этих карманах далее формируются по планарной технологии. В целом процесс можно охарактеризовать как меза-эпитаксиально-планарный. Наряду с приведенным маршрутом имеются его модификации. Например получение комплементарных биполярных ИМС, в составе которых имеются p-n-p и n-p-n транзисторы (рис 19).
Эпик-процессы относительно сложны и трудоемки. Основная сложность заключается в необходимости прецизионной механической обработки. К недостатку метода также относится относительно небольшая степень интеграции. ИМС.
Эпик-процессы относительно сложны и трудоемки. Основная сложность заключается в необходимости прецизионной механической обработки. К недостатку метода также относится относительно небольшая степень интеграции. ИМС.
б) Необходимо отметить, что эпик-технология требует прецезионной механической обработки, которая затруднена из-за наличия прогиба подложки в результате различия коэффициентов температурного линейного расширения монокристаллического и поликристаллического кремния и оксида кремния. Различие микротвердости этих материалов приводит к наличию ступенек на поверхности, что затрудняет получение качественной металлизации. С целью устранения отмеченных недостатков разработаны технологические процессы, в которых вместо поликристаллического кремния для изолирующих областей и основания кристаллов используют стекло, ситалл или керамику, т.е. проводят изоляцию диэлектрическим материалом. Такие процессы имеют общее название «кремний в диэлектрике» (КВД). У них много общего с обычным эпик процессом. Отличие состоит в том, что сначала формируют элементы ИМС (рис 20,а), а затем пластину с элементами со стороны выводов подвергают локальному травлению – создают мезаобласти (рис 20,б). После этого пластину со стороны мезаобластей прикрепляют к вспомогательной пластине (рис 20,в), а ее обратную сторону подвергают шлифованию (рис 20,г) с последующим нанесением изолирующего диэлектрика (рис 20,д). Завершают процесс удалением вспомогательной пластины (рис 20,е) и металлизацией.
Диэлектрическая изоляция по сравнению с p-n изоляцией технологически сложнее; площадь, занимаемая элементами, больше. Но, благодаря лучшим электрическим свойствам, она постоянно совершенствуется и широко применяется в производстве биполярных ИМС.

6.4 Изготовление биполярных ИМС с комбинированной изоляцией
В основу изготовления полупроводниковых биполярных ИМС с комбинированной изоляцией положены процессы, обеспечивающие формирование элементов с изоляцией p-n переходами их горизонтальных участков и диэлектриком – вертикальных боковых областей.
 |
а) Изопланарные процессы основаны на использовании кремниевых пластин с тонким (2 ¸ 3 мкм) эпитаксиальным слоем, селективного термического окисления кремния на всю глубину эпитаксиального слоя вместо разделительной диффузии, проводимой в обычном планарно-эпитаксиальном процессе. Реализация такого процесса достигается использованием при маскировании на первых стадиях формирования структуры ИМС специфический свойств нитрида кремния Si3N4. Нитрид кремния препятствует превращению кремния в SiO2 в местах, где Si3N4 служит в качестве защитного слоя. Кроме того, нитрид кремния легко удаляется травителем на основе фосфорной кислоты, который не воздействует на оксид. Изопланарная технология позволяет создавать тонкие базовые области и небольшие коллекторные области с оксидными боковыми стенками и тем самым обеспечивает получение транзисторных структур малых размеров и высокого быстродействия. Имеются две разновидности изопланарной технологии: «Изопланар I» и «Изопланар II».
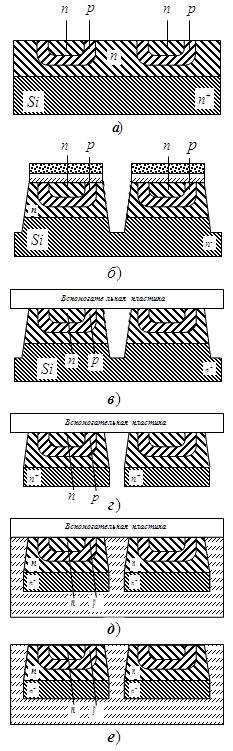 При изготовлении ИМС по процессу «Изопланар I» в качестве исходной используют кремниевую пластину p-типа с эпитаксиальным n-слоем и скрытым n+-слоем. Начинают процесс с наращивания на поверхности пластины слоя нитрида кремния., в котором с помощью фотолитографии формируют окна под изолирующие области. Затем производят травление кремния на глубину, превышающую половину толщины эпитаксиального слоя, после чего окислением вытравленные канавки заполняют оксидом кремния. После удаления слоя нитрида при маскировании оксидом кремния в локализованных островках кремния («карманах») формируют транзисторные структуры и осуществляют металлизацию.
При изготовлении ИМС по процессу «Изопланар I» в качестве исходной используют кремниевую пластину p-типа с эпитаксиальным n-слоем и скрытым n+-слоем. Начинают процесс с наращивания на поверхности пластины слоя нитрида кремния., в котором с помощью фотолитографии формируют окна под изолирующие области. Затем производят травление кремния на глубину, превышающую половину толщины эпитаксиального слоя, после чего окислением вытравленные канавки заполняют оксидом кремния. После удаления слоя нитрида при маскировании оксидом кремния в локализованных островках кремния («карманах») формируют транзисторные структуры и осуществляют металлизацию.
Процесс «Изопланар II» позволяет получать структуры с эмиттерными областями, выходящими боковой стороной на слой изоляции. Приконтактные n+-области коллекторов расположены в самостоятельных карманах, соединенных с эмиттер-базовыми карманами, скрытыми n+-областями. Этот процесс предъявляет менее жесткие требования к точности совмещения слоев, так как окно смещается в диоксид, диффузия эмиттерной примеси в который не происходит. Базовую диффузию можно проводить по всей площади карманов, что также упрощает процесс.

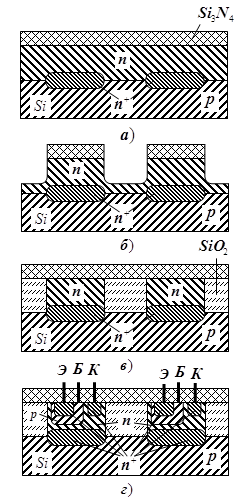 | |||||
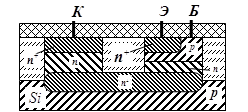 | |||||

![]()
Изопланарная технология совмещает преимущества планарной и меза-технологии, она позволяет избежать неоднородности электрического поля на периферии планарного p-n перехода, снизить паразитные емкости между активными областями структуры, повысить качество изоляции и степень интеграции ИМС.
Процессы «Изопланар I» и «Изопланар II» иллюстрируют рис 21 и рис 22 соответственно.
6.5 Изготовление толстооксидных p-МОП-ИМС и n-МОП-ИМС
Рассмотрим наиболее простые типовые процессы изготовления ИМС с металлическими затворами и толстой пленкой оксида между металлизацией и пластиной кремния. Это уменьшает паразитные емкости, а также дает некоторые другие преимущества перед ранее применяемой тонкооксидной технологией.
Похожие работы
... образом наносят шесть слоев. Это покрытие обладает малой усадкой и плотной структурой. Исходя из вышеперечисленных сравнений выбран для защитного покрытия от действия влаги лак УР-231.6. Описание технологического процесса изготовления печатной платы комбинированным позитивным способом. Технологический процесс изготовления печатной платы комбинированным позитивным методом состоит из следующих ...
... частота лежит вне диапазона в рабочих частотах проектируемого устройства, следовательно, влияние на работу устройства она не оказывает. 5 Выбор и обоснование технологического процесса сборки и монтажа печатных плат Методы сборки и монтажа печатных плат можно классифицировать по степени автоматизации сборочного – монтажных работ. При этом можно выделить следующие методы сборки: Ручная: Ручная ...
... , в тех случах усложняется, но, тем не менее, это оказывается оправданным, когда другие способы уплотнения монтажа приводят к еще большим технологическим трудностям. Схема технологического процесса изготовления многослойных печатных плат методом металлизации сквозных отверстий показана на рис. 1.23. Метод металлизации сквозных отверстий, по-существу единственный метод создания конструкций с ...
... мкм по подслою никеля. 3.5 Топология токопроводящего рисунка Характер проводящего рисунка во многом определяет технологичность конструкции, надежность производства печатных плат. Анализ практики производства позволяет сформулировать ряд правил для конструирования печатного рисунка. При трассировке проводников следует избегать острых углов. Во внутреннем пространстве такого угла образуется ...
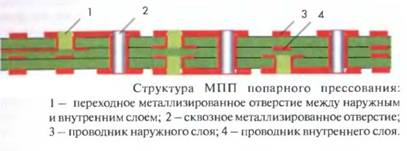
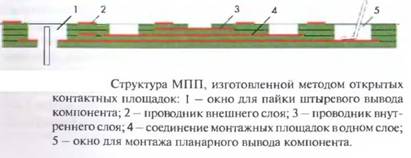
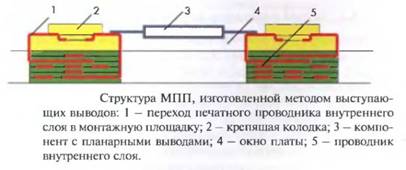
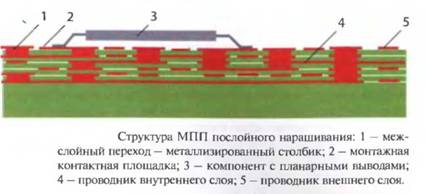
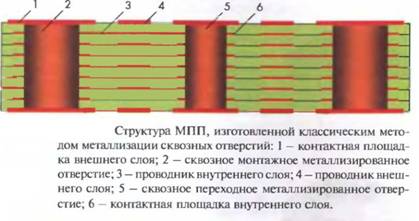





0 комментариев